УЗБЕКСКОЕ АГЕНСТВО СВЯЗИ И
ИНФОРМАТИЗАЦИИ
ТАШКЕНТСКИЙ УНИВЕРСИТЕТ ИНФОРМАЦИОННЫХ ТЕХНОЛОГИЙ
════════════════════════════════════════════
Х.К. АРИПОВ, А.М. АБДУЛЛАЕВ, Н.Б.
АЛИМОВА
ЭЛЕКТРОНИКА
Учебное пособие для бакалавров
по направлениям
5522200 «Телекоммуникации»
5522100 «Телевидение, радиосвязь и
радиовещание»
5522200 «Радиотехника»
Ташкент – 2008
Х.К.
Арипов, А.М. Абдуллаев, Н.Б. Алимова Электроника.
Учебное пособие - Ташкент: ТУИТ, 2008,
136 с. План 2008-2009 уч. г.
Рецензенты:
Ш.З. Таджибаев - кандидат технических наук, доцент
Р.К. Каримов - кандидат
технических наук, доцент
В учебном пособии рассматривается элементная база
устройств полупроводниковой электроники. Приведены классификация, вольт–
амперные и другие характеристики диодов, транзисторов, основные схемы включения
и особенности их применения в конкретных приборах в различных режимах работы.
Значительное место уделено принципам построения типовых аналоговых и цифровых
устройств. Приведены способы математического описания их работы, а также
основам анализа и синтеза устройств с заданными техническими характеристиками.
Дается описание лабораторных работ, позволяющих
получить основные характеристики и параметры электронных приборов и некоторых
устройств аналоговой и цифровой схемотехники.
Учебное пособие предназначается для бакалавров, чье
образование связано с областью информационных и телекоммуникационных
технологий.
© Издание Ташкентского
университета информационных технологий, 2008
════════════════════════════════════════════
ВВЕДЕНИЕ
Электроника – наука, занимающаяся изучением взаимодействия
электронов с электромагнитными полями, разработкой методов создания электронных
приборов и устройств, используемых для передачи, обработки и хранения
информации.
Электроника, прежде всего, обеспечивает информационные
потребности человеческого общества. Развитие производительных сил и
производственных отношений основано на создании новых видов техники и
технологии, тесно связано с развитием средств информатики. История развития
средств информационного общения между людьми состоит из нескольких этапов: жест
и мимика, звуковая речь, письменность, книгопечатание, электроника. В настоящее
время все эти средства передачи, обработки и хранения информации используются
человеческим обществом. Переход к каждому новому способу передачи информации
приводил к резкому увеличению производительных сил общества. Электроника резко
увеличила скорость, объемы передачи информации на громадные расстояния.
Электроника в своем развитии прошла четыре периода.
Первый период развития электроники начался с изобретения беспроводного телеграфа –
радио А.С. Поповым в
Второй период начался с изобретения Л.де Форестом в
Третий период развития электроники начался с изобретения в 1948 году Дж. Бардином,
В. Браттейном и В. Шокли биполярного транзистора – основного активного
(усилительного) элемента твердотельной (полупроводниковой) электроники.
Транзистор способен выполнять все функции электронной лампы.
С появлением транзистора, благодаря его способности
выполнять функции переключателя, малым габаритом и высокой надежности,
появилась реальная возможность создания сложных электронных устройств и систем,
содержащих тысячи электрорадиоэлементов (ЭРЭ). Но оказалось, что такие
устройства легко спроектировать, но почти невозможно безошибочно собрать и
обеспечить их работоспособность. Дело в том, что каждый ЭРЭ создавался отдельно
(дискретные элементы) и требовал индивидуального соединения (монтажа) с другими
элементами. Даже при самом тщательном монтаже не удавалось избежать таких
ошибок, как обрывы, короткие замыкания, и обеспечить работоспособность системы
сразу после сборки. К примеру, разрабатываемые в конце 50–х годов ЭВМ должны
были содержать около 100 тысяч диодов и 25 тысяч транзисторов, не считая
десятков резисторов и конденсаторов.
Дискретные элементы характеризуются средней мощностью
15 мВт, средним размером (с учетом соединений) 1 см3, средней массой
Четвертый период развития электроники начался с создания электронных устройств и систем
на базе интегральных микросхем (ИМС) и носит название периода микроэлектроники.
Первые изделия микроэлектроники – интегральные микросхемы,
появились в конце 60–х годов. В настоящее время ИМС изготавливаются в трех
конструктивно–технологических вариантах: толстопленочные и тонкопленочные
гибридные интегральные микросхемы (ГИС) и полупроводниковые интегральные
микросхемы.
Помимо решения проблемы межсоединений элементов в РЭА
интегральные микросхемы обеспечивают малые габариты, электропотребление, массу
и низкую материалоемкость аппаратуры. Отсутствие многочисленных выводов и
корпусов у электрорадиоэлементов намного сокращает объем и массу РЭА.
ГЛАВА I. ПОЛУПРОВОДНИКОВЫЕ ПРИБОРЫ
════════════════════════════════════════════
1.1. Энергетические зоны
Устройства современной электроники изготавливаются из
полупроводниковых материалов. Полупроводники бывают кристаллические, аморфные и
жидкие. В полупроводниковой технике в основном используют кристаллические
полупроводники (монокристаллы с примесями не более одного атома примеси на 1010
атомов основного вещества). Обычно к полупроводникам относят вещества, по
удельной электрической проводимости ![]() занимающие промежуточное положение между металлами и
диэлектриками (отсюда происходит их название). При комнатной температуре
удельная электрическая проводимость их составляет от 10-8 до 105
См/м (Сименс на метр). У металлов
занимающие промежуточное положение между металлами и
диэлектриками (отсюда происходит их название). При комнатной температуре
удельная электрическая проводимость их составляет от 10-8 до 105
См/м (Сименс на метр). У металлов ![]() =106-108 См/м, у диэлектриков
=106-108 См/м, у диэлектриков ![]() =10-8-10-13 См/м. Основная особенность
полупроводников заключается в возрастании удельной электрической проводимости
при повышении температуры, а у металлов она падает. Электропроводность
полупроводников зависит от облучения светом и от содержания даже
незначительного количества примесей. Свойства полупроводников описываются с
помощью зонной теории твердого тела.
=10-8-10-13 См/м. Основная особенность
полупроводников заключается в возрастании удельной электрической проводимости
при повышении температуры, а у металлов она падает. Электропроводность
полупроводников зависит от облучения светом и от содержания даже
незначительного количества примесей. Свойства полупроводников описываются с
помощью зонной теории твердого тела.
Любое твердое тело представляет собой множество сильно
взаимодействующих друг с другом атомов. Поэтому всю совокупность атомов в куске твердого тела рассматривают как
единую структуру. Связь атомов в твердом теле устанавливается вследствие попарного
объединения электронов внешней оболочки атомов (валентными электронами). Такая
связь называется ковалентной.
Энергия валентного электрона W как и любого электрона в атоме дискретна, или
квантована, т.е. электрон может иметь некоторое разрешенное значение энергии,
называемое энергетическим уровнем. Энергетические
уровни разделены зонами запрещенной энергии для электронов. Их называют запрещенными
зонами. Так как в твердом теле соседние атомы находятся очень близко
друг от друга, это вызывает смещение и расщепление энергетических уровней, в
результате чего образуются энергетические зоны, называемые разрешёнными.
В энергети-ческой зоне число разрешённых уровней равно числу атомов в
кристалле. Ширина разрешённых зон обычно равна нескольким электрон – вольтам
(электрон–вольт – это энергия, которую приобретает электрон, пройдя разность
потенциалов 1В). Минимальный уровень энергии в разрешенной зоне называют дном (Wс), а
максимальный потолком (Wv).
На рис. 1.1 приведена зонная энергетическая диаграмма
полупроводника. Ширина запрещенной зоны DWз является
важнейшим параметром полупроводника.

Рис. 1.1
Для полупроводников, которые наиболее часто
используются в электронике, DWз (эВ)
равна: для германия – 0,67, для кремния – 1,12 и для арсенида галлия – 1,38.
У диэлектриков ширина запрещенной зоны DWз ![]() 2 эВ, а у металлов разрешенные зоны сливаются, так что у них
ее нет.
2 эВ, а у металлов разрешенные зоны сливаются, так что у них
ее нет.
Верхняя разрешенная зона называется зоной
проводимости, то есть электроны, обладающие соответствующей энергией,
под действием внешнего электрического поля могут перемещаться в объеме
полупроводника, создавая электропроводность. Электроны с энергией,
соответствующей одной из энергий зоны проводимости, называются электронами
проводимости или свободными носителями заряда. Нижняя
разрешенная зона называется валентной зоной.
При температуре абсолютного нуля (0 К) все
энергетические уровни в валентной зоне полупроводника заняты электронами, а все
энергетические уровни в зоне проводимости свободны.
1.2. Собственная
электропроводность
Приблизительно 97 % всех изделий полупроводниковой электроники выполняются на
основе кремния. На рис. 1.2. приведена упрощенная модель решетки (а) и зонная энергетическая диаграмма (б) для беспримесного кремния. Если в
кристалле полупроводника практически не содержится примесей и нет структурных
дефектов кристаллической решетки (пустых узлов, сдвигов решетки и др.), то
полупроводник называется собственным, который принято
обозначать буквой i.


Рис. 1.2
Из рис. 1.2 а
видно, что в собственном кристалле кремния четыре валентных электрона его атома
связаны с четырьмя валентными электронами соседних атомом кремния, образуя
устойчивую восьмиэлектронную оболочку (прямые линии). При температуре 0 К в
таком полупроводнике свободных носителей заряда нет. Однако с повышением
температуры или при освещении часть ковалентных связей может быть разорвана и
валентные электроны получают необходимую энергию для перехода в зону
проводимости (рис. 1.2 б).
В результате валентный электрон становится свободным
носителем заряда, и при приложении напряжения он будет принимать участие в
образовании тока. Потеря электрона превращает атом в положительный ион.
Одновременно в валентной зоне появляется свободный
уровень и у валентных электронов появляется возможность изменять свою энергию,
то есть переходить с одного разрешенного уровня валентной зоны на другой. Таким
образом, он может участвовать в процессе протекания тока через полупроводник. С
повышением температуры всё большее число валентных электронов переходит в зону
проводимости, и электропроводность возрастает.
Свободный энергетический уровень в валентной зоне или
свободную валентную связь называют дыркой, которая является свободным носителем
положительного заряда, равного по абсолютной величине заряду электрона.
Перемещение дырки соответствует встречному перемещению валентного электрона.
Таким образом, разрыв ковалентной связи между атомами
приводит к одновременному образованию свободного электрона и дырки вблизи того
атома, от которого оторвался электрон. Процесс образования электронно –
дырочных пар называется генерацией носителей заряда. Если
этот процесс происходит под воздействием теплоты, то его называют теплогенерацией.
Появление электрона в зоне проводимости и дырки в валентной зоне представлено в
виде кружков с соответствующими знаками зарядов на рис. 1.2 б, стрелкой обозначен переход электрона
из валентной зоны в зону проводимости.
Электроны и дырки, образовавшиеся в результате
генерации, совершают хаотическое движение в полупроводниковом кристалле в
течение некоторого времени, называемого временем жизни, после чего свободный
электрон заполняет незаполненную связь, становится связанным. При этом
одновременно исчезает электронно – дырочная пара. Этот процесс называют рекомбинацией.
При постоянной температуре (в отсутствии других
внешних воздействий) кристалл находится в состоянии равновесия. Это означает,
что число генерированных пар носителей заряда равно числу рекомбинированных
пар. Число носителей заряда в единицу объема, то есть их концентрация,
определяет значение удельной электронной проводимости. В собственном
полупроводнике концентрация электронов равна концентрации дырок (ni= pi). Буквы n (от negative)
и p (от positive)
связаны соответственно с электронами и дырками. Электроны и дырки, возникшие в
беспримесном полупроводнике, называются собственными свободными носителями
зарядов, а обусловленная ими электропроводность – собственной электропроводностью.
1.3.
Примесная электропроводность
Подавляющее большинство полупроводниковых приборов
создаются на основе примесных полупроводников. Примесными полупроводниками
называются такие полупроводники, в которых электропроводность в основном
обусловлена носителями заряда, образующимися при ионизации атомов примеси.
При введении в
кремний атома V группы периодической системы
элементов Д.И. Менделеева (например, мышьяка As) четыре из пяти его валентных электронов вступают в
связь с четырьмя валентными электронами соседних атомов кремния и образуют
устойчивую оболочку из восьми электронов. Пятый же электрон будет избыточным и
оказывается слабо связанным со своим атомом. Поэтому при воздействии малой
тепловой энергии он легко отрывается и превращается в свободный электрон (рис.
1.3 а), дырки при этом не образуется.
На энергетической диаграмме этот процесс соответствует переходу электрона с
уровня доноров Wd в зону проводимости (рис. 1.3 б). Примесный атом превращается в неподвижный ион с единичным
положительным зарядом. Примесь этого типа называется донорной.
При изготовлении полупроводниковых приборов вводится
много атомов примеси (порядка 1014-1018 атомов на 1 см3).
При комнатной температуре каждый атом примеси образует по одному свободному
электрону. Дырки образуются за счет термогенерации при переходе электронов
атомов кремния в зону проводимости, как в собственном полупроводнике.




Рис. 1.3
Введение в полупроводник донорной примеси на много
порядков увеличивает концентрацию свободных электронов, а концентрация дырок
существенно уменьшается по сравнению с концентрацией в собственном
полупроводнике. Примечательно, что произведение концентраций свободных носителей
заряда n×p есть
величина постоянная при неизменной температуре и определяется только шириной
запрещенной зоны полупроводника. Полезно запомнить, что при Т=300 К (комнатная
температура) в кремнии np![]() 0,64∙1020 см-3, а в германии np
0,64∙1020 см-3, а в германии np![]() 4∙1026 см-3. Таким образом, если,
к примеру в кристалл кремния ввести донорную
примесь в концентрации
4∙1026 см-3. Таким образом, если,
к примеру в кристалл кремния ввести донорную
примесь в концентрации
Nd= 1016 см-3, то при Т=300 К
концентрация электронов проводимости будет составлять n=1016
см-3, а дырок – всего 104 см-3, следовательно,
в таком примесном полупроводнике электропроводность будет осуществляться в
основном электронами, а сам полупроводник называется электронным или n-типа
электропроводности. Электроны в полупроводниках n–типа называют основными носителями заряда, а дырки – неосновными.
Если в кремний
введен атом трехвалентного элемента III
группы периодической системы элементов Д.И. Менделеева (например, бора В), то
его валентные электроны образуют три заполненные связи с валентными электронами
соседних атомов кремния. Четвертая связь оказывается незаполненной. При
воздействии даже небольшой тепловой энергии один из валентных электронов
соседнего атома кремния заполняет эту связь. В результате на внешней оболочке
атома бора появляется лишний электрон, то есть он превращается в неподвижный
ион с единичным отрицательным зарядом. Незаполненная связь атома кремния и есть дырка (рис. 1.3 в). На энергетической диаграмме этот
процесс соответствует переходу электрона из валентной зоны на уровень Wa
и образованию в валентной зоне дырки (рис.
Уровень Ферми. Концентрация как подвижных, так и неподвижных носителей зарядов при
заданной температуре определяется положением уровня Ферми WF.
Этот уровень представляет собой среднюю тепловую энергию тела на один электрон.
Вероятность заполнения этого уровня при температуре, отличной от абсолютного
нуля, равна 0,5.
Средняя тепловая энергия электронов и дырок
определяется температурой полупроводника и равна kТ, где k – постоянная Больцмана, Т - абсолютная температура. Но каждая частица имеет энергию,
отличную от средней. Согласно закону Больцмана, описывающего поведение частиц в
твердом теле, концентрация электронов в n – полупроводнике, энергия которых не меньше Wi,
равна
 (1.1)
(1.1)
где nn – полная концентрация свободных электронов.
Аналогичное выражение определяет распределение дырок по энергиям. Из (1.1) видно,
что с ростом энергии частицы, число частиц резко уменьшается.
Для собственных полупроводников, где концентрация
свободных носителей зарядов обоих знаков равны друг другу, уровень Ферми проходит посередине запрещенной зоны. В
электронном полупроводнике средняя энергия электронов (и всего полупроводника)
будет выше, следовательно, уровень Ферми смещается от середины в сторону дна
зоны проводимости и находится тем ближе
к дну зону проводимости, чем выше концентрация донорной примеси. В
полупроводнике р–типа уровень Ферми
смещается от середины запрещенной зоны в сторону валентной зоны и находится тем
ближе к валентной зоне, чем выше концентрация акцепторной примеси.
В некоторых полупроводниковых приборах (туннельные
диоды, стабилитроны с туннельным пробоем) используются так называемые вырожденные
полупроводники. У таких полупроводников уровень Ферми располагается в
разрешенных зонах: проводимости - для электронного и в валентной для дырочного
полупроводника. Вырожденные полупроводники получают за счет очень большой
концентрации примесей (1019 – 1021 см-3).
Подвижность
носителей заряда. Подвижность
носителей ![]() - это их средняя направленная скорость в полупроводнике при
напряженности электрического поля
- это их средняя направленная скорость в полупроводнике при
напряженности электрического поля ![]() =1 В/см. подвижность электронов
=1 В/см. подвижность электронов ![]() всегда больше подвижности дырок
всегда больше подвижности дырок ![]() . Кроме того, подвижности зарядов зависят от типа
полупроводника. Так, подвижность электронов в кремнии
. Кроме того, подвижности зарядов зависят от типа
полупроводника. Так, подвижность электронов в кремнии ![]() =1500 см2/(В×с), в германии
=1500 см2/(В×с), в германии ![]() =3900 см2/(В×с), в арсениде галлия
=3900 см2/(В×с), в арсениде галлия ![]() =8500 см2/(В×с).
=8500 см2/(В×с).
Если в полупроводнике создано электрическое поле, то
появляется перемещение свободных носителей заряда. Такое перемещение называется
дрейфовым
движением. Скорость дрейфа ![]() пропорциональна напряженности электрического поля
пропорциональна напряженности электрического поля ![]()
![]() (1.2)
(1.2)
Суммарная плотность дрейфового тока электронов и дырок
![]() (1.3)
(1.3)
Коэффициент
диффузии. Причиной, вызывающей
электрический ток в полупроводнике, может быть не только электрическое поле, но
и градиент концентрации подвижных носителей заряда. Направление движения
свободных носителей, вызванное их неравномерным распределением в объеме
полупроводника, называют диффузионным движением.
Плотность диффузионного тока электронов и дырок равна

 (1.4)
(1.4)
Здесь q – заряд электрона (дырки), Dn и Dp
– коэффициенты диффузии электронов и дырок соответственно, dn/dx и dp/dx –
градиенты концентрации электронов и дырок соответственно.
Параметры дрейфового и диффузионного движения связаны
между собой соотношениями Эйнштейна.

 (1.5)
(1.5)
В соотношениях (1.4) коэффициенты
пропорциональности ![]() имеет размерность потенциала (вольт) и называется тепловым
потенциалом. При комнатной температуре (Т=300 К)
имеет размерность потенциала (вольт) и называется тепловым
потенциалом. При комнатной температуре (Т=300 К) ![]() = 0,026 В = 26мВ.
= 0,026 В = 26мВ.
Время жизни ![]() . Временем жизни
носителя заряда называется время от его генерации до его рекомбинации. Этот
параметр полупроводника имеет важное значение при конструировании
полупроводниковых приборов (ширина базы в биполярных транзисторах, длина канала
в полевых транзисторах). За время жизни, в результате диффузионного движения,
носители заряда будут проходить некоторое среднее расстояние L,
называемое диффузионной длиной.
. Временем жизни
носителя заряда называется время от его генерации до его рекомбинации. Этот
параметр полупроводника имеет важное значение при конструировании
полупроводниковых приборов (ширина базы в биполярных транзисторах, длина канала
в полевых транзисторах). За время жизни, в результате диффузионного движения,
носители заряда будут проходить некоторое среднее расстояние L,
называемое диффузионной длиной.
Контрольные вопросы
1. Назовите основные специфические особенности полупроводников.
2. Опишите зонную диаграмму полупроводника.
3. Что из себя представляет свободный носитель заряда (СНЗ) ?
4. Как описывается коллективное поведение электронов в валентной зоне?
Дайте определение электрону и
дырке проводимости.
5. Что такое собственная электропроводность ? Чему равна концентрация
СНЗ в собственном
полупроводнике ?
6. Какие примеси влияют на характеристики полупроводника ?
7. Что такое донорные и акцепторные примеси ?
8. Дайте определение электронному и дырочному полупроводнику.
9. Какие СНЗ называются основными, а какие – неосновными ? Как связаны
между собой их равновесные
концентрации ?
10. Объясните, почему и как изменяется при изменении температуры
концентрация СНЗ в
полупроводниках.
ГЛАВА II. ЭЛЕКТРОННО – ДЫРОЧНЫЙ ПЕРЕХОД
(р-n переход)
════════════════════════════════════════════
2.1. Образование р-n- перехода
Большинство полупроводниковых приборов изготавливаются
с использованием так называемых неоднородных полупроводников. В частном случае
неоднородный полупроводник представляет собой монокристалл, одна из областей
которого - р-типа, а другая - n–типа.
В таком неоднородном полупроводнике на границе раздела
р- и n– областей возникает слой пространственного заряда и
внутреннее электрическое поле в границах этого слоя, этот слой носит название электронно–дырочного
перехода или р-n-перехода.
Свойства р-n- перехода
положены в основу принципа действия подавляющего числа полупроводниковых
приборов и интегральных микросхем.
Рассмотрим механизм образования р-n-перехода. Для простоты будем считать, что концентрация
электронов в n–области и дырок в р–
области равны. Кроме того, в каждой области имеется небольшее количество
неосновных носителей. При комнатной температуре в полупроводнике р–типа концентрация отрицательных ионов
акцепторов Nа равна концентрации дырок рр, а в полупроводнике n–типа концентрация положительных ионов доноров Ng равна
концентрации свободных электронов nn. Так как между р–
и n– областями имеется значительная разница в концентрации
дырок и электронов, то при соприкосновении этих областей начнется диффузия
электронов в р-область и дырок в n–область.
В результате диффузии концентрация электронов в
пограничной n– области станет меньше концентрации положительных
ионов доноров, и этот слой приобретет положительный заряд. Одновременно
уменьшится концентрация дырок в пограничной
р-области и она приобретет
отрицательный заряд, обусловленный некомпенсированными зарядами ионов
акцепторной примеси (рис. 2.1). Кружки с плюсом и минусом изображают ионы донорной и акцепторной примеси соответственно.
Образовавшийся двойной объемный слой пространственных
зарядов называют р–n- переходом.
Этот слой обеднён подвижными носителями зарядов. Поэтому его удельное
сопротивление велико по сравнению с областями р- и n– типов. Часто в литературе этот слой называют также обедненным,
истощенным слоем, или i – областью.
Объемные заряды
имеют разные знаки и создают электрическое поле р–n- перехода напряженностью ![]() . Оно является тормозящим для основных носителей заряда и
препятствуют их свободному перемещению через р–n переход. На рис. 2.1 б показано изменение потенциала поля вдоль оси Х, перпендикулярной
плоскости перехода, причем за нулевой потенциал принят потенциал граничного
слоя.
. Оно является тормозящим для основных носителей заряда и
препятствуют их свободному перемещению через р–n переход. На рис. 2.1 б показано изменение потенциала поля вдоль оси Х, перпендикулярной
плоскости перехода, причем за нулевой потенциал принят потенциал граничного
слоя.

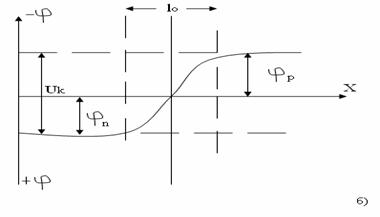
Рис. 2.1
Из рисунка видно, что в р–n- переходе возникает потенциальный барьер, равный контактной
разнице потенциалов ![]() , которую называют высотой потенциального барьера и
выражают в вольтах. Величина Uк зависит от ширины запрещенной зоны исходного
полупроводника и концентрации примесей. Контактная разность потенциалов большинства
р–n- переходов из германия
, которую называют высотой потенциального барьера и
выражают в вольтах. Величина Uк зависит от ширины запрещенной зоны исходного
полупроводника и концентрации примесей. Контактная разность потенциалов большинства
р–n- переходов из германия ![]() 0,35 В, а из кремния -
0,7 В.
0,35 В, а из кремния -
0,7 В.
Ширина р–n- перехода l0 пропорциональна ![]() и составляет десятые доли или единицы мкм. Для создания
узкого р–n- перехода вводятся большие концентрации примесей, а
для увеличения l0 следует
использовать малые концентрации.
и составляет десятые доли или единицы мкм. Для создания
узкого р–n- перехода вводятся большие концентрации примесей, а
для увеличения l0 следует
использовать малые концентрации.
Токи в р–n- переходе.
Основные носители заряда, имеющие энергию ![]() (см. 1.1), перемещаются через р–n- переход в смежные области за счет диффузии против
поля р-n- перехода. Они образуют диффузионный ток.
Одновременно с перемещением основных носителей заряда через р–n- переход начинается перемещение неосновных носителей (дырок в области n и
электронов области р) в направлении
поля р–n- перехода, которое для них является ускоряющим. Поток
неосновных носителей является дрейфовым током. В отсутствии
внешнего поля устанавливается динамическое равновесие, то есть диффузионный и
дрейфовый ток оказываются равными по абсолютному значению. Но так как
диффузионный и дрейфовый токи направлены в противоположные стороны, то
результирующий ток через р–n переход
будет равен нулю.
(см. 1.1), перемещаются через р–n- переход в смежные области за счет диффузии против
поля р-n- перехода. Они образуют диффузионный ток.
Одновременно с перемещением основных носителей заряда через р–n- переход начинается перемещение неосновных носителей (дырок в области n и
электронов области р) в направлении
поля р–n- перехода, которое для них является ускоряющим. Поток
неосновных носителей является дрейфовым током. В отсутствии
внешнего поля устанавливается динамическое равновесие, то есть диффузионный и
дрейфовый ток оказываются равными по абсолютному значению. Но так как
диффузионный и дрейфовый токи направлены в противоположные стороны, то
результирующий ток через р–n переход
будет равен нулю.
2.2. Прямое
включение р – n перехода
Если к р – n переходу подключить внешний источник напряжения U, то нарушится условие равновесия и начнет протекать ток.
Если источник напряжения подключить знаком плюс к области р – типа, а знаком
минус к области n – типа, то получим включение,
которое называется прямым (рис. 2.2).

Рис. 2.2
Электрическое поле источника напряжения направлено
навстречу контактному полю, поэтому напряженность результирующего поля в р–n- переходе уменьшится. Уменьшение напряженности поля
вызывает снижение высоты потенциального барьера на значение напряжения
источника питания: Uк -U0. Нетрудно
убедиться, что при этом уменьшается и ширина р–n- перехода.
Уменьшение высоты потенциального барьера приводит к
тому, что увеличивается число переходов основных носителей заряда через р–n- переход, то есть усиливается диффузионный ток. В
каждой области появляются избыточные концентрации неосновных носителей заряда –
дырок в n–области, электронов в
р–области. Процесс нагнетания
неосновных носителей заряда в какую либо область полупроводника называется инжекцией.
Изменение диффузионного тока с изменением напряжения
происходит по экспоненциальному закону:
![]() (2.1)
(2.1)
где I0 – дрейфовый ток, или как его называют обратный
ток р–n- перехода.
При прямом включении на обратный ток изменение высоты
потенциального барьера не влияет, так как этот ток определяется только
количеством неосновных носителей заряда, переносимых через р–n- переход в единицу времени в результате их
хаотического теплового движения. Диффузионный и дрейфовый токи направлены в
противоположные стороны, поэтому результирующий (прямой) ток через р–n- переход с учётом (2.1)
![]() . (2.2)
. (2.2)
Ток I0 составляет десятки мкА в германиевых или нанометры в кремниевых р–n- переходах, но сильно возрастает при увеличении
температуры. Однако большая разница в величине I0 определяется шириной запрещенной зоны.
2.3.
Обратное включение р – n перехода
В этом случае внешнее напряжение U0
приложено знаком плюс к n– области (рис. 2.3).
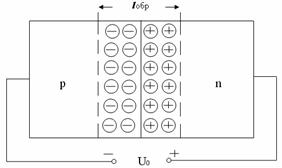
Рис. 2.3
Электрическое поле источника напряжения направлено в
ту же сторону, что и контактное поле перехода. Поэтому высота потенциального
барьера увеличивается и становится равной UK+U0. Увеличение
обратного смещения приводит к расширению р–n- перехода (![]() <
<![]() ). Для практических расчетов
удобно использовать следующую формулу:
). Для практических расчетов
удобно использовать следующую формулу:

![]() , (2.3)
, (2.3)
где  - ширина р–n- перехода в
отсутствии внешнего поля. Здесь
- ширина р–n- перехода в
отсутствии внешнего поля. Здесь ![]() - относительная диэлектрическая постоянная полупроводника,
- относительная диэлектрическая постоянная полупроводника, ![]() - электрическая постоянная.
- электрическая постоянная.
Увеличение потенциального барьера приводит к снижению
диффузионного тока. Изменение диффузионного тока происходит по
экспоненциальному закону
![]() . (2.4)
. (2.4)
Поскольку дрейфовый ток не зависит от высоты
потенциального барьера и равен I0 , то результирующий ток через р–n- переход
![]() . (2.5)
. (2.5)
При обратном включении происходит извлечение
(экстракция) неосновных носителей из контактирующих полупроводников. Поэтому
обратный ток называется током экстракции.
2.4. Вольт –
амперная характеристика (ВАХ)
р – n перехода
ВАХ называют зависимость тока через р–n- переход от приложенного к нему напряжения I=f(U). На
основании (2.2) и (2.5) в самом общем виде она представляется экспоненциальной
зависимостью (рис. 2.4 а)
![]() . (2.6)
. (2.6)
Если р–n- переход
включен в прямом направлении, напряжение U0 будет со знаком плюс, если в обратном – со знаком
минус. При Uпр![]() 0,1 В можно пренебречь единицей по сравнению с
экспоненциальным членом и прямой ток растет с повышением напряжения
экспоненциально. При обратном включении обратный ток достигает значения – I0 уже
при напряжениях порядка -0,2 В и далее, с ростом напряжения не изменяется.
Величина I0 носит поэтому, название тока насыщения обратно включенного
р–n- перехода.
0,1 В можно пренебречь единицей по сравнению с
экспоненциальным членом и прямой ток растет с повышением напряжения
экспоненциально. При обратном включении обратный ток достигает значения – I0 уже
при напряжениях порядка -0,2 В и далее, с ростом напряжения не изменяется.
Величина I0 носит поэтому, название тока насыщения обратно включенного
р–n- перехода.

а) б)
Рис. 2.4
Обратный ток на несколько порядков меньше прямого, то
есть р–n- переход хорошо проводит ток в прямом направлении и
плохо – в обратном. Следовательно, р–n- переход
характеризуется выпрямляющим действием, что позволяет использовать его в
качестве выпрямителя переменного тока.
Наклон прямой ветви ВАХ возрастает с ростом
температуры (рис. 2.4. б), несмотря
на то, что экспоненциальный член ![]() с ростом температуры
уменьшается. Это обусловлено более
сильной положительной температурной зависимостью I0. В
результате при прямых напряжениях с
повышением температуры ток возрастает. На практике влияние температуры на ВАХ р–n- перехода оценивается параметром, который называется температурным
коэффициентом напряжения (ТКН). Для определения ТКН, изменяя
температуру, измеряют изменение напряжения на р–n- переходе при постоянном токе. Обычно ТКН имеет
отрицательный знак, то есть с ростом температуры напряжение на переходе
уменьшается. Для р–n- переходов
из кремния ТКН составляет порядка 3 мВ/град.
с ростом температуры
уменьшается. Это обусловлено более
сильной положительной температурной зависимостью I0. В
результате при прямых напряжениях с
повышением температуры ток возрастает. На практике влияние температуры на ВАХ р–n- перехода оценивается параметром, который называется температурным
коэффициентом напряжения (ТКН). Для определения ТКН, изменяя
температуру, измеряют изменение напряжения на р–n- переходе при постоянном токе. Обычно ТКН имеет
отрицательный знак, то есть с ростом температуры напряжение на переходе
уменьшается. Для р–n- переходов
из кремния ТКН составляет порядка 3 мВ/град.
Уравнение (2.6) описывает ВАХ идеализированного р–n- перехода. Считается, что в таком переходе объемное
сопротивление р- и n- областей
равно нулю, а при протекании тока в самом р–n- переходе
не имеют место процессы рекомбинация. В реальном переходе сопротивление баз
обычно составляет десятки Ом. Поэтому в формулу (2.6) вносится поправка,
учитывающая различие напряжения на самом р–n- переходе и
внешним напряжением U0. С учетом этой поправки получим
![]() (2.7)
(2.7)
Емкости р–n- перехода.
При низких частотах ток р–n- перехода
определяется только активными сопротивлениями электронно–дырочного перехода, а
также р- и n- областей
полупроводника (rБ). При работе р–n- перехода
на высоких частотах его инерционность во многом определяется его емкостью.
Обычно учитываются две основные емкости р–n- перехода:
диффузионная и барьерная.
При прямом включении р–n- перехода в смежные области инжектируются неосновные
носители. Вследствие этого в тонких слоях около границы р–n- перехода появляются равные по значению и
противоположного знака избыточные заряды неравновесных неосновных носителей QДФ.
При изменении напряжения изменяется число инжектированных носителей, а
следовательно, и заряд. Это изменение, вызванное приложенным напряжением,
подобно изменению зарядов на обкладках конденсатора. Поскольку неосновные
носители заряда попадают в базу за счет диффузии, то эту емкость называют диффузионной
и рассчитывают по формуле
![]() . (2.8)
. (2.8)
Из (2.8) следует, что диффузионная емкость будет тем
больше, чем больше ток I через
р–n- переход и чем больше время жизни носителей в базах ![]() .
.
Электронно–дырочный переход, представляющий собой
двойной электрический слой, подобен заряженному конденсатору. Емкость перехода
определяется площадью перехода S, его шириной и диэлектрической постоянной
полупроводника. Емкость перехода называется барьерной и определяется
следующим выражением
 . (2.9)
. (2.9)
Если к переходу приложено напряжение, то его емкость
изменяется, поскольку при этом изменяется ширина перехода. Зависимость емкости
от значения приложенного напряжения U имеет вид
 . (2.10)
. (2.10)
Знак минус берется в случае прямого включения
перехода, знак плюс – в случае обратного включения. Поскольку СБ зависит от приложенного
напряжения, то р–n- переход
можно использовать в качестве конденсатора переменной емкости.
При прямом напряжении диффузионная емкость значительно
больше барьерной, а при обратном напряжении – наоборот. Поэтому при прямом
напряжении инерционность р–n- перехода
определяется диффузионной емкостью, а при обратном – барьерной емкостью.
2.5.
Разновидности пробоя р – n перехода
Как отмечалось выше, при не очень больших обратных
напряжениях ток I0 невелик. Когда обратное напряжение достигает
некоторого порогового значения UПОР, обратный ток резко возрастает. Наступает так
называемый электрический пробой перехода.
Все разновидности пробоя перехода разделяются на две
группы: электрические и тепловой. Различают два механизма электрического пробоя
– лавинный и туннельный пробои.
Лавинный пробой возникает в относительно широких р–n- переходах.
В таком переходе при обратном напряжении электроны и дырки приобретают энергию,
достаточную для ударной ионизации, в результате которой рождаются
дополнительные электронно–дырочные пары. Каждый компонент этой пары, в свою
очередь, ускоряясь в электрическом поле, может родить новую пару и т.д.
Ток перехода, вследствие такого
лавинного размножения носителей резко возрастает.
В полупроводниках с узким р–n- переходом возникает туннельный пробой,
связанный с туннельным эффектом. При UОБР ![]() UПОР появляется возможность перехода носителей заряда из
одной области в другую без затраты энергии (туннельный эффект). С дальнейшим
ростом UОБР все большее число зарядов совершает туннельные
переходы и обратный ток резко возрастает.
UПОР появляется возможность перехода носителей заряда из
одной области в другую без затраты энергии (туннельный эффект). С дальнейшим
ростом UОБР все большее число зарядов совершает туннельные
переходы и обратный ток резко возрастает.
Тепловой пробой р–n- перехода
возникает вследствие перегрева перехода проходящим через него обратным током
при недостаточном теплоотводе. Обратный ток, являясь тепловым, резко
возрастает, а перегрев увеличивается. Это приводит к лавинообразному увеличению
тока, в результате чего возникает тепловой пробой р–n- перехода и выход его из строя.
Контрольные
вопросы
1. Что такое р-n- переход и
как он определяется ?
2. Что происходит с р-n- переходом при его прямом и обратном включении ?
3. Что такое инжекция и экстракция
неосновных носителей ?
4. Как зависят токи инжекции и экстракции
при изменении напряжения
на переходе
?
5. Почему р-n- переход
имеет емкость, которую называют барьерной ?
6. Как изменяется барьерная ёмкость р-n- перехода, если увеличить обратное
напряжение
?
7. Что такое диффузионная емкость диода ?
8. В чем отличие реальной диодной структуры
от идеализированного
р-n- перехода ?
9. Поясните, как зависит ток диода от
температуры.
10. Какие виды пробоя р-n- перехода существуют и в чем их отличие ?
ГЛАВА III. ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ
════════════════════════════════════════════
Диодом называют электропреобразовательный прибор,
который, как правило, содержит один или несколько электрических переходов и два
вывода для подключения к внешней цепи. В справочниках по полупроводниковым
приборам диоды классифицируются по применению в радиоэлектронной аппаратуре или
по назначению.
3.1. Выпрямительные
диоды
Выпрямительные диоды предназначены для преобразования
переменного напряжения источников питания в постоянное. Основное свойство
выпрямительных диодов – односторонняя проводимость, наличие которой определяет
эффект выпрямления.
Частотный диапазон использования выпрямительных диодов
очень широк. Поэтому диоды классифицируют по диапазону рабочих частот.
Выпрямительные низкочастотные диоды (НЧ диоды) предназначены для преобразования переменного тока
промышленной частоты (50 Гц) в постоянный. Главное требование, предъявляемое к
НЧ диодам, – это получение больших величин выпрямленных токов. Выпрямительные
диоды обычно подразделяются на диоды малой, средней и большой мощности,
рассчитанные на выпрямленный ток до 0,3 А, от 0,3 до 10 А и свыше 10 А
соответственно. НЧ диоды характеризуются большой площадью р–n переходов.
Выпрямительные высокочастотные диоды (ВЧ диоды) предназначены для нелинейного электрического
преобразования сигналов на частотах до десятков и сотен мегагерц. ВЧ диоды
используются в детекторах высокочастотных сигналов, смесителях, схемах преобразователей
частоты и т.п. Высокочастотные диоды малоинерционны, т.к. содержат точечный р–n- переход малой площади и потому их барьерная емкость
составляет доли пикофарады.
Диоды с барьером Шоттки распространены в переключательных источниках питания,
так как позволяют увеличить рабочую частоту переключения до 100 кГц и более,
уменьшить массогабаритные характеристики РЭА и повысить КПД источников питания.
Потенциальный барьер Шоттки создается при контакте металла с полупроводником. В
качестве материала полупроводника чаще всего используют кремний n–типа, а в
качестве металла – Al, Au, Mo и др. При этом исходят из того, что работа выхода
металла должна быть больше работы выхода кремния. В таких диодах диффузионная емкость
равна нулю, а барьерная емкость не превышает 1 пФ.
3.2. Стабилитроны
Стабилитроны - это полупроводниковые диоды, принцип
работы которых основан на том, что при обратном напряжении на р–n- переходе в области электрического пробоя напряжение
на нем изменяется незначительно при значительном изменении тока. Условное обозначение
стабилитрона приведено на рис. 3.1 б.
Стабилитрон предназначен для стабилизации напряжения в схемах.
Основным электрическим параметром стабилитрона
является напряжение стабилизации UСТ, которое остается практически постоянным при
изменение тока в широких пределах от IСТ.min до IСТ.max (рис. 3.1 а).
Рабочий участок ВАХ стабилитрона находится в области
электрического пробоя. Напряжение стабилизации зависит от ширины р–n- перехода, которая определяется концентрацией примесей
в базах диода. Если используется исходный полупроводник с высокой концентрацией
примеси, то р–n- переход
будет узким и наблюдается туннельный пробой. Рабочее напряжение не превышает 3-4 В.
Высоковольтные стабилитроны
должны иметь большую
ширину
р–n- перехода, поэтому их делают на основе
слаболегированного кремния. В них происходит лавинный пробой, а напряжение
стабилизации более 7 В. При UСТ от 3 до 7 В работают оба механизма пробоя.
Промышленность выпускает стабилитроны с напряжением стабилизации от 3 до 400 В.
Динамическое (дифференциальное) сопротивление
стабилитрона в области электрического пробоя rД характеризует степень стабилизации. Значение этого
сопротивления определяется отношением малого изменения напряжения на диоде к
соответствующему изменению тока диода при заданном начальном значении этого
тока (рис. 3.1. а). Чем меньше rД, тем
лучше стабилизация.

Важным параметром стабилитронов является температурный
коэффициент напряжения стабилизации (ТКН). ТКН – это относительное изменение
напряжения стабилизации при изменении температуры на один градус.

Рис. 3.1.
Низковольтные стабилитроны, где наблюдается туннельный
пробой, имеют отрицательный, а высоковолтьные диоды, где наблюдается лавинный
пробой, - положительный ТКН. Типовые значения ТКН обычно составляют не более
0,2 -0,4 %/град.
3.3. Варикапы
Варикап предназначен для использования в качестве
электрически управляемой емкости. Принцип работы варикапа основан на
использовании зависимости барьерной емкости электрического перехода от
обратного напряжения.
Основное применение варикапов – электронная
перестройка частоты колебательных контуров. Существует несколько разновидностей
варикапов. Так, параметрические диоды используются для усиления и генерации СВЧ
– сигналов, а умножительное применяются в умножителях частоты с широким
диапазоном частот.
3.4. Туннельные
диоды
Туннельным диодом называют полупроводниковый прибор,
сконструированный на основе вырожденного полупроводника, в котором при обратном
и небольшом прямом напряжении возникает туннельный эффект и вольт–амперная
характеристика имеет участок с отрицательным дифференциальном сопротивлением.
Устройство туннельных диодов в принципе не отличается
от устройства других диодов, но для их изготовления применяют полупроводниковые
материалы с содержанием примеси до 1020 см-3.
В случае нелинейной ВАХ каждый малый ее участок
рассматривается как отрезок прямой линии и вводится дифференциальное
сопротивление в данной точке характеристики  . Если характеристика имеет падающий участок, то на этом
участке Ri отрицательно.
. Если характеристика имеет падающий участок, то на этом
участке Ri отрицательно.
ВАХ туннельного диода приведена на рис. 3.2. Участок
АВ характеризуется отрицательным дифференциальным сопротивлением. Если включить
туннельный диод в контур электрической цепи, то при определенных соотношениях
между параметрами контура и величиной отрицательного сопротивления в этой цепи
возможны усиление или генерация колебаний. Туннельные диоды используют в
основном для построения СВЧ генераторов в диапазоне 3-30 ГГц, а также
специализированных вычислительных устройств и логических сверхбыстродействующих
схем.

Рис. 3.2.
3.5.
Генераторные диоды
Одной из разновидностей генераторных диодов является лавиннопролетный
диод (ЛПД). На его ВАХ при лавинном пробое р-n- перехода на высоких частотах возникает участок с
отрицательным сопротивлением. Если ЛПД поместить в резонатор, то в нем возникают
незатухающие колебания с частотой до 100 ГГц. Выходная мощность колебаний может
достигать 10 Вт (при f=1 ГГц).
Коэффициент полезного действия ЛПД достигает 30-50 %.
Другой разновидностью генераторных диодов является диод
Ганна, который представляет собой пластинку однородного полупроводника (без
р-n- перехода) длиной 10-2-10-
3.6. Диоды
оптоэлектроники
Оптоэлектроника – раздел электроники, изучающий теорию и практическое применение
устройств, в которых прием, передача и обработка информации происходит путем
преобразования световых сигналов в электрические и наоборот. Элементами
оптоэлектроники являются фотодиод и светодиод.
Фотодиодом
называется фотоэлектрический прибор с одним р-n- переходом.
Фотодиод может включаться в схему как с внешним источником питания (фотодиодный
режим), так и без него. Внешний источник питания подключается таким образом,
что р-n- переход оказался при обратном смещении. В отсутствии
освещения через диод протекает «темновой» ток экстракции I0
очень малой величины, не зависящий от приложенного напряжения. При освещении n–базы диода
светом, содержащем фотоны с энергией, превышающей ширину запрещенной зоны,
происходит генерация электронно–дырочных пар. Если пары образуются на
расстоянии от перехода не превышающем диффузионной длины, то генерированные
светом дырки будут экстрагироваться электрическим полем перехода, и обратный ток возрастает по сравнению с его
«темновым» значением. Чем интенсивнее световой поток Ф, тем выше значение
обратного тока диода IФ. На рис. 3.3 приведена ВАХ фотодиода

Рис. 3.3.
для
различных значений светового потока. В широких пределах уровней освещенности
фототок зависит от светового потока практически линейно.
Коэффициент пропорциональности![]() составляет несколько мА/лм и называется чувствительностью фотодиода.
Фотодиоды используются в качестве приемников светового потока в различных
измерительных устройствах, а также в волоконно – оптических линиях связи.
составляет несколько мА/лм и называется чувствительностью фотодиода.
Фотодиоды используются в качестве приемников светового потока в различных
измерительных устройствах, а также в волоконно – оптических линиях связи.
Кроме фотодиодного режима, широко используется
вентильный (фотовольтаический) режим работы фотодиода. В этом режиме фотодиод
работает без подключения внешнего источника питания и служит для
непосредственного преобразования солнечной энергии в электрическую. При
освещении диода в вентильном режиме на его выводах возникает вентильное
напряжение. Фотодиод в этом случае называют солнечным преобразователем.
Электрически соединенные между собой преобразователи - батареи применяются в
качестве источников электрической энергии для питания РЭА в космических
аппаратах и наземных установках.
Светодиоды –
это излучающие полупроводниковые приборы с одним р-n- переходом, преобразующие электрическую энергию в
некогерентное световое излучение. Излучение появляется в результате
рекомбинации пар: электрон – дырка. Рекомбинация наблюдается, если р-n- переход включен в прямом направлении. Рекомбинация
будет излучательной не всегда, и происходит она в так называемых прямозонных
полупроводниках, типичным представителем которых является арсенид галлия.
Такие полупроводники имеют специфическую
зонную диаграмму.
Длина волны![]() излучаемого света однозначно определяется энергией кванта,
которая при излучательной рекомбинации приблизительно равна ширине запрещенной
зоны полупроводника. Для светодиодов, изготовленных из арсенида галлия,
излучаемого света однозначно определяется энергией кванта,
которая при излучательной рекомбинации приблизительно равна ширине запрещенной
зоны полупроводника. Для светодиодов, изготовленных из арсенида галлия, ![]() = 0,9-1,4 мкм. Диоды красного, желтого и зеленого свечения
изготовляют на основе фосфида галлия, с фиолетовым свечением – на основе
карбида кремния и т.д.
= 0,9-1,4 мкм. Диоды красного, желтого и зеленого свечения
изготовляют на основе фосфида галлия, с фиолетовым свечением – на основе
карбида кремния и т.д.
Энергетической характеристикой светодиодов является квантовый
выход (эффективность), который показывает, сколько квантов излучения на выходе светодиода
возникает на каждый электрон, проходящий по цепи управления. Квантовый выход
для современных светодиодов обычно составляет 0,01-0,04, у светодиодов с
гетеропереходом, для создания которого использованы двойные и тройные
полупроводниковые соединения, он значительно больше (до 0,3), но всегда меньше
единицы. Вольт – амперная характеристика, как и в обычных диодах, описывается
экспоненциальной зависимостью. Светодиод переключается за 10-7-10-9
с., то
есть является быстродействующим источником света.
Светодиоды используют в оптических линиях связи,
индикаторных устройствах, оптопарах и т.д.
Оптоэлектронная пара, или оптопара, содержит
светоизлучатель и фотоприемник
конструктивно связанные через оптическую среду. Прямая оптическая связь от
излучателя к фотоприёмнику исключает все виды электрической связи между этими
элементами.
3.7. Оптроны
Под действием входного электрического сигнала
светодиод генерирует световое излучение, а фотоприемник (фотодиод, фоторезистор и т.п.) генерирует ток
под действием освещения.

а) б) в) г)
Рис. 3.4.
На рис. 3.4. приведено схемное изображение оптопары, состоящей из светодиода
и фотодиода (а), фототранзистора (б), фототиристора (в), фоторезистора (г). Оптопара используется как элемент электрической
развязки в цифровых и импульсных устройствах, устройствах передачи аналоговых
сигналов, системах автоматики для бесконтактного управления высоковольтными
источниками питания и др.
Контрольные вопросы
1. Какие виды электрического пробоя
используются в стабилитронах ?
2. Какие типы диодов Вы знаете ? Приведите
их условные обозначения.
3. Каков принцип маркировки
полупроводниковых диодов и транзисторов ?
4. В чем состоит эффект выпрямления диодов ?
5. Что такое варикап и где он применяется ?
6. Каким образом применение стабилитрона в
электрической цепи
стабилизирует выходное
напряжение цепи ?
7. Каковы отличительные особенности в
механизме действия выпрямительного
и туннельного диода ?
8. Поясните, что такое оптоэлектронный
прибор и где он применяется ?
9. Опишите принцип действия и основные
характеристики фотодиодов.
10. Опишите принцип действия и основные
характеристики светодиодов.
ГЛАВА IV. БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ
════════════════════════════════════════════
4.1. Общие сведения
Биполярным
транзистором называют активный
полупроводни-ковый прибор с двумя
взаимодействующими р-n- переходами и тремя электродами (внешними выводами).
Прохождение тока в транзисторе обусловлено движением зарядов обоих знаков –
электронов и дырок.
Биполярный транзистор содержит три полупроводниковые
области с чередующимися типами проводимости (рис. 4.1) р-n-р (а) или n-р-n (б). В
дальнейшем будем рассматривать наиболее распространенную n-р-n структуру биполярного транзистора.
Наиболее сильно легированную крайнюю область
транзистора (n+ - типа) называют эмиттером, назначение ее – инжекция носителей в среднюю область (р –типа), называемую базой.
Другую крайнюю область (n – типа) называют коллектором. Он менее легирован, чем
эмиттер, и предназначен для экстракции носителей из базовой области (рис. 4.2).
Переход между эмиттером и базой называют
эмиттерным переходом - ЭП, а р – n- переход между коллектором и базой –
коллекторным переходом - ЭП.
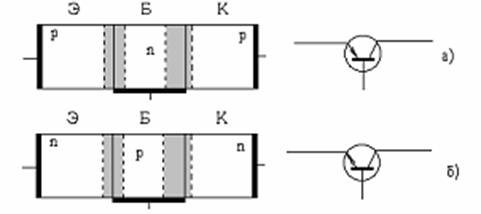
Рис. 4.1.
С помощью внешних источников напряжения (UЭБ , UКБ) эмиттерный переход смещается в прямом направлении, а
коллекторный – в обратном. В этом случае говорят, что транзистор функционирует
в активном, или нормальном режиме, когда проявляются его
усилительные свойства.
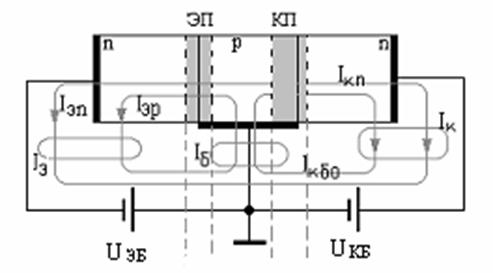
Рис. 4.2.
Если эмиттерный переход смещен в обратном направлении,
а коллекторный в прямом, то такое включение биполярного транзистора называется инверсным, или обратным. При работе транзистора в цифровых
схемах транзистор может работать в режиме насыщения (оба перехода включаются в
прямом направлении), либо в режиме отсечки (оба перехода включены в
обратном направлении).
4.2. Схемы
включения биполярного транзистора
При включении транзистора в схему один из его выводов
делают общим для входной и выходной цепей, поэтому схемы включения бывают: с
общей базой (ОБ) (рис. 4.3 а);
с
общим эмиттером (ОЭ) (рис. 4.3 б);
с
общим коллектором (ОК) (рис. 4.3 в).
При этом считается, что потенциал общего вывода
равен нулю. Полярности источников напряжения и направление токов
транзистора соответствуют активному режиму
работы транзистора. Схема включения с ОБ имеет ряд недостатков и используется
крайне редко.
Работа
биполярного транзистора в активном режиме. Рассмотрим работу на постоянном токе биполярного диффузионного
сплавного транзистора со структурой n-p-n, включенного по схеме с ОБ в активном режиме (рис.
4.3. а). Непременным условием
нормальной работы биполярного транзистора является достаточно малая ширина базы
W; необходимо, чтобы было выполнено условие W < L (L – диффузионная
длина неосновных носителей заряда в базе).
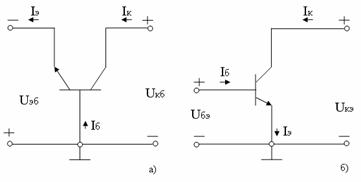

Рис. 4.3.
Действие биполярного транзистора основано на
использовании трех явлений:
- инжекции носителей из эмиттера в базу;
- переноса инжектированных в базу
носителей к коллекторному переходу;
- экстракции инжектированных в базу и дошедших до коллекторного перехода неосновных носителей из базы в коллектор.
При прямом смещении эмиттерного перехода
(обеспечивается источником питания UЭБ) снижается его потенциальный барьер и происходит инжекция электронов
из эмиттера в базу. За счет инжекции электронов в базу, а также инжекции дырок
из базы в эмиттер формируется ток эмиттера IЭ.
Таким образом, ток эмиттера
![]() , (4.1)
, (4.1)
где IЭn, IЭр токи инжекции электронов и дырок соответственно.
Составляющая тока эмиттера IЭр не протекает через коллектор и является вредной,
вызывая дополнительный нагрев транзистора. Для уменьшения IЭр концентрация акцепторной примеси в базе на два
порядка меньше, чем донорной примеси в эмиттере.
Долю IЭn в токе
эмиттера определяют коэффициентом инжекции
 , (4.2)
, (4.2)
характеризующим
эффективность работы эмиттера (![]() =0,990-0,995). Инжектированные электроны диффундируют в базе
в направлении к коллекторному переходу за счет перепада плотности электронов по
длине базы и, дойдя до коллекторного перехода, экстрагируются
(вытягиваются электрическим полем коллекторного перехода) в коллектор,
образуется ток коллектора IКn.
=0,990-0,995). Инжектированные электроны диффундируют в базе
в направлении к коллекторному переходу за счет перепада плотности электронов по
длине базы и, дойдя до коллекторного перехода, экстрагируются
(вытягиваются электрическим полем коллекторного перехода) в коллектор,
образуется ток коллектора IКn.
Перепад плотности называют градиентом концентрации.
Чем больше градиент, тем больше ток. При этом следует учесть, что за время
прохождения базы часть инжектированных электронов рекомбинируют с дырками базы.
Акты рекомбинации создают недостаток дырок, требующихся для восстановления
условия электрической нейтральности базы. Необходимые дырки поступают по цепи
базы, создавая базовый ток транзистора IБрек. Ток IБрек является нежелательным, вследствие чего его стремятся
уменьшить. Достигается это путем
уменьшения толщины базы W ![]() Ln (диффузионная
длина электронов). Потерю электронного тока эмиттера на рекомбинацию в базе
характеризует коэффициент переноса электронов
Ln (диффузионная
длина электронов). Потерю электронного тока эмиттера на рекомбинацию в базе
характеризует коэффициент переноса электронов
 (4.3).
(4.3).
В реальных транзисторах![]() =0,980-0,995.
=0,980-0,995.
В активном режиме коллекторный переход транзистора
включен в обратном направлении
(обеспечивается источником питания UКБ) и в цепи коллектора протекает собственный ток IК0, состоящий из двух дрейфовых токов неосновных
носителей.
Таким образом, ток коллектора будет состоять из двух
компонентов
![]()
Если учесть связь IКn с
полным током эмиттера, то:
![]() , (4.4)
, (4.4)
где ![]() - коэффициент передачи тока
эмиттера.
Он характеризует усилительные свойства транзистора в схеме с ОБ.
- коэффициент передачи тока
эмиттера.
Он характеризует усилительные свойства транзистора в схеме с ОБ.
В соответствии с первым законом Кирхгофа ток базы
связан с другими токами электродов транзистора соотношением
![]() . (4.5)
. (4.5)
Подставив в него (4.4), получим выражение для тока
базы через полный ток эмиттера:
![]() . (4.6)
. (4.6)
Учитывая, что коэффициент ![]() <1, можно сделать вывод: схема с
ОБ не даёт усиления по току (
<1, можно сделать вывод: схема с
ОБ не даёт усиления по току (![]() ).
).
Хорошее усиление по току дает схема (4.3. 6), где транзистор включен по схеме с
общим эмиттером (ОЭ). В этой схеме общим электродом является эмиттер, входным
током – ток базы, а выходным – коллекторный ток.
С учетом выражений (4.4) и (4.5) уравнение для тока
коллектора в схеме с ОЭ выглядит следующим образом:
![]() .
.
Отсюда
 . (4.7)
. (4.7)
Если обозначить ![]() , то выражение (4.7) можно
преобразовать к виду
, то выражение (4.7) можно
преобразовать к виду
![]() . (4.8)
. (4.8)
Коэффициент ![]() называется коэффициентом передачи тока базы.
Значение
называется коэффициентом передачи тока базы.
Значение ![]() находится в пределах от десятков до сотен, а в некоторых
типах транзисторов оно достигает нескольких тысяч. Таким образом, транзистор,
включенный по схеме с ОЭ, является хорошим усилителем тока.
находится в пределах от десятков до сотен, а в некоторых
типах транзисторов оно достигает нескольких тысяч. Таким образом, транзистор,
включенный по схеме с ОЭ, является хорошим усилителем тока.
4.3.
Статические характеристики биполярного транзистора
Статические характеристики транзистора описывают
взаимосвязь между установившимися входными и выходными токами и напряжениями,
когда в цепи коллектора нет нагрузки. Семейства статических характеристик для
каждой схемы включения приводятся в справочниках. Наиболее важными являются входные
и выходные характеристики
транзистора. Остальные характеристики могут быть получены из входных и выходных
характеристик.

Рис. 4.4
Для схемы с ОБ входной статической характеристикой
является зависимость IЭ= f (UЭБ) при UКБ = const, а для схемы с ОЭ IБ= f (UБЭ) при UКЭ = const. Общий
характер входных характеристик определяется p-n- переходом,
который, как правило, включен в прямом направлении. Поэтому по внешнему виду
входные характеристики имеют экспоненциальный характер (рис. 4.4).
Из рисунков видно, что изменение выходного напряжения
приводит к смещению входных характеристик. Сдвиг характеристик определяется эффектом
Эрли (модуляция ширины базы), сущность которого состоит в том, что при
увеличении обратного напряжения на коллекторном переходе он расширяется, причем
расширение в области базы происходит за счет уменьшения ее ширины. Уменьшение
ширины базы приводит к двум эффектам: уменьшению базового тока из-за уменьшения
рекомбинации носителей и увеличению тока эмиттера за счет возрастания градиента
концентрации неосновных носителей в базе. Поэтому с увеличением обратного
напряжения на коллекторном переходе входная характеристика в схеме с ОБ
смещается влево, а в схеме с ОЭ – вправо.
Выходной статической характеристикой в схеме с ОБ
является зависимость IК= f (UКБ) при IЭ = const, а в схеме
с
ОЭ зависимость
IК= f (UКЭ) при IБ = const.
Выходные характеристики по своему виду аналогичны
обратной ветви ВАХ диода, так как коллекторный переход включен в обратном
направлении. При построении характеристик принято обратное напряжение
коллекторного перехода откладывать вправо (рис. 4.5).

а) б)
Рис. 4.5
Из рис. 4.5 а
видно, что выходные ВАХ в схеме с ОБ располагаются в двух квадрантах: ВАХ в
первом квадранте соответствует активному режиму работы, а во втором – режиму
насыщения. В активном режиме выходной ток определяется соотношением (4.4). Участки
характеристики, соответствующие активному режиму, проходят почти параллельно
оси абсцисс, с небольшим наклоном. Наклон определяется вышеупомянутым эффектом
Эрли. Когда IЭ=0 (цепь эмиттера оборвана), выходная характеристика
представляется ВАХ обратно смещенного коллекторного перехода. При включении эмиттерного перехода
в прямом направлении появляется ток инжекции и выходные характеристики
сдвигаются на величину ![]() влево.
влево.
Выходные характеристики транзистора, включенного по
схеме с ОЭ, имеют большой наклон по сравнению с выходными характеристиками
транзистора в схеме с ОБ, так как на них эффект Эрли оказывает большее влияние. Общий характер
зависимостей (рис. 4.5 б)
определяется следующей зависимостью между коллекторным и базовым током:
![]() , (4.9)
, (4.9)
где IКЭ0 – сквозной ток коллектора определяемый при IБ=0
(обрыв базы). Ток IКЭ0 в ![]() раз больше тока IК0, так как при UБЭ=0 часть напряжения UКЭ оказывается приложенным к эмиттерному переходу,
смещая его в прямом направлении. Таким образом, IКЭ0=(
раз больше тока IК0, так как при UБЭ=0 часть напряжения UКЭ оказывается приложенным к эмиттерному переходу,
смещая его в прямом направлении. Таким образом, IКЭ0=(![]() )IК0 – достаточно большой ток, и во избежание нарушения
работы транзистора не следует разрывать цепь базы.
)IК0 – достаточно большой ток, и во избежание нарушения
работы транзистора не следует разрывать цепь базы.
При увеличении тока базы ток коллектора возрастает на
величину ![]() , и характеристики смещаются вверх. Главной особенностью
выходных ВАХ схемы с ОЭ является то, что и в активном режиме, и в режиме насыщения
они расположены в одном квадранте. Это означает, что при заданной полярности
напряжений на электродах возможен как активный режим, так и режим насыщения.
Смена режимов происходит при равенстве нулю напряжения на коллекторном
переходе. Так как UКЭ = UКБ + UБЭ
(без учета сопротивления коллекторной области), искомое значение порогового
напряжения UКЭ = UБЭ.
Значение UБЭ определяется по входной характеристике при заданном
токе базы.
, и характеристики смещаются вверх. Главной особенностью
выходных ВАХ схемы с ОЭ является то, что и в активном режиме, и в режиме насыщения
они расположены в одном квадранте. Это означает, что при заданной полярности
напряжений на электродах возможен как активный режим, так и режим насыщения.
Смена режимов происходит при равенстве нулю напряжения на коллекторном
переходе. Так как UКЭ = UКБ + UБЭ
(без учета сопротивления коллекторной области), искомое значение порогового
напряжения UКЭ = UБЭ.
Значение UБЭ определяется по входной характеристике при заданном
токе базы.
4.4.
Физические параметры биполярного
транзистора
Коэффициенты усиления по току ![]() и
и ![]() являются статическими параметрами, поскольку представляют
собой отношение постоянных токов. Помимо них широко используются
дифференциальные коэффициенты усиления, которые представляют собой отношение
приращений токов. Статический и дифференциальный коэффициенты усиления
являются статическими параметрами, поскольку представляют
собой отношение постоянных токов. Помимо них широко используются
дифференциальные коэффициенты усиления, которые представляют собой отношение
приращений токов. Статический и дифференциальный коэффициенты усиления ![]() несколько отличаются друг от друга и поэтому их различают,
когда это принципиально необходимо. Зависимость коэффициента усиления по току
от напряжения на коллекторе обусловлена эффектом Эрли.
несколько отличаются друг от друга и поэтому их различают,
когда это принципиально необходимо. Зависимость коэффициента усиления по току
от напряжения на коллекторе обусловлена эффектом Эрли.
Дифференциальный коэффициент усиления по току для
схемы с ОЭ  обладает температурной зависимостью, что обусловлено
зависимостью времени жизни неосновных носителей в области базы. Поскольку с
повышением температуры замедляются процессы рекомбинации, обычно наблюдается
рост коэффициента усиления транзистора по току. Температурная нестабильность
характеристик транзистора является его существенным недостатком.
обладает температурной зависимостью, что обусловлено
зависимостью времени жизни неосновных носителей в области базы. Поскольку с
повышением температуры замедляются процессы рекомбинации, обычно наблюдается
рост коэффициента усиления транзистора по току. Температурная нестабильность
характеристик транзистора является его существенным недостатком.
К физическим параметрам помимо рассмотренного выше
коэффициента передачи тока относят дифференциальные сопротивления переходов,
объемные сопротивления областей, коэффициент обратной связи по напряжению,
емкости переходов.
Эмиттерный и коллекторный переходы транзистора
представляются своими дифференциальными сопротивлениями. Поскольку эмиттерный
переход смещен в прямом направлении, его дифференциальное сопротивление rЭ
можно определить, используя (2.6)
 , (4.10).
, (4.10).
где IЭ
–постоянная составляющая тока. Оно имеет малое значение (при токе 1 мА
сопротивление rЭ составляет 20-30 Ом), уменьшается с ростом тока и
увеличивается с повышением температуры.
Поскольку коллекторный переход в транзисторе смещен в
обратном направлении, ток IК слабо зависит от напряжения UКБ.
Поэтому дифференциальное сопротивление коллекторного перехода  =1Мом. Сопротивление rК в основном обусловлено эффектом Эрли, оно обычно
уменьшается с ростом рабочих токов.
=1Мом. Сопротивление rК в основном обусловлено эффектом Эрли, оно обычно
уменьшается с ростом рабочих токов.
Сопротивление базы rБ составляет несколько сотен Ом. При достаточно большом
токе базы падение напряжения на сопротивлении базы снижает напряжение на
эмиттерном переходе по сравнению с внешним напряжением между выводами базы и
эмиттера.
Сопротивление коллектора для маломощных транзисторов
составляет десятки Ом, а для мощных – единицы Ом. Сопротивление эмиттерной
области пренебрежимо мало по сравнению с сопротивлением базы из – за высокой
концентрации примесей.
Коэффициент обратной связи по напряжению в схеме с ОБ
определяется как  (при IЭ = const), а в схеме с ОЭ как
(при IЭ = const), а в схеме с ОЭ как  (при IБ
= const). По абсолютному значению коэффициенты приблизительно
одинаковы и в зависимости от концентрации и технологии изготовления
транзисторов составляют
(при IБ
= const). По абсолютному значению коэффициенты приблизительно
одинаковы и в зависимости от концентрации и технологии изготовления
транзисторов составляют ![]() = 10-2 -10-4.
= 10-2 -10-4.
Частотные свойства биполярного транзистора
определяются временем пролета неосновных носителей заряда через базу и временем
перезарядки барьерных емкостей переходов. Относительная роль этих факторов
зависит от конструкции и режима работы транзистора, а также от сопротивлений во
внешних цепях.
Для очень малых входных сигналов и активного режима
работы биполярный транзистор можно представить в виде линейного
четырехполюсника и описать этот четырехполюсник некоторой системой параметров.
Эти параметры принято называть h –
параметрами. К ним относятся: h11 – входное сопротивление транзистора при коротком
замыкании на выходе; h12 – коэффициент обратной связи по напряжении при
разомкнутом входе; h21 – коэффициент усиления (передачи) по току при
коротком замыкании на выходе; h22 – выходная проводимость при разомкнутом входе. Все h –
параметры легко и непосредственно измеряются.
В ранней литературе по электронике частотным
зависимостям малосигнальных параметров
придавалось очень большое значение. В настоящее время выпускаются транзисторы,
обеспечивающие нормальную работу при частотах до 10 ГГц. В таких случаях для
получения требуемых частотных характеристик схемы достаточно лишь правильно
выбрать по справочнику тип транзистора.
Контрольные вопросы
1. Что такое биполярный транзистор (БТ) ?
2. В чем заключается принцип действия
биполярного транзистора ?
3. Назначение эмиттера, базы и коллектора
биполярного транзистора.
4. Имеются ли различия в принципе действия
БТ со структурой n-p-n и p-n-p ?
5. Какие схемы включения биполярного транзистора
Вы знаете ?
6. Назовите основные режимы работы БТ.
7. Определите на статических вольт –
амперных характеристиках БТ в
различных
схемах его включения области активного режима и режима
насыщения.
8. Что такое коэффициент передачи тока транзистора
? Сравните величину
коэффициента
передачи тока в схеме включения с ОБ и с ОЭ.
9. Поясните, как представив транзисторов в
виде четырехполюсника,
определить
его малосигнальные параметры. Поясните смысл этих
параметров.
ГЛАВА V. ПОЛЕВЫЕ ТРАНЗИСТОРЫ
════════════════════════════════════════════
5.1. Общие сведения
Полевыми транзисторами называются полупроводниковые активные приборы, в
которых управление значением силы тока осуществляется электрическим полем за
счет изменения электропроводности проводящего промежутка, называемого каналом.
Полевые транзисторы предназначены для усиления
мощности и различного рода преобразований электрических сигналов. В полевых
транзисторах в отличие от биполярных транзисторов в образовании тока участвуют
носители только одного типа: или электроны, или дырки. Отсюда другое название
полевых транзисторов – униполярные.
Существуют два типа полевых транзисторов,
различающихся структурой и способом управления проводимости канала: полевой
транзистор с управляющим р–n- переходом
и транзисторы с изолированным затвором, имеющим структуру металл – диэлектрик –
полупроводник (МДП). Поэтому такие транзисторы называют также МДП –
транзисторами.
Транзисторы с управляющим р–n- переходом. На
рис. 5.1 приведена структура разреза полевого транзистора с управляющим р–n- переходом с каналом n – типа (а)
и его условное графическое обозначение (б).

Рис. 5.1
Каналом называется
область n – типа. Контакт, через который носители заряда входят
в канал, называют истоком (И); контакт, через который носители заряда вытекают,
называют стоком (С). Затвор (З) является управляющим электродом.
Электрическое поле, возникающее при приложении напряжения между затвором и
истоком, изменяет проводимость канала и, следовательно, ток через канал. В
качестве затвора используется область противоположного типа проводимости по
отношению к каналу, образующая с ним р–n- переход, который в рабочем режиме имеет
обратное включение.
Проводимость канала определяется его сопротивлением ![]() , где
, где ![]() - удельное сопротивление материала канала, l- длина, S – площадь поперечного сечения канала. В отсутствии
внешних напряжений площадь поперечного сечения канала под затвором одинакова по
всей длине канала. При приложении внешнего напряжения заданной полярности между
затвором и истоком UЗИ р–n- переход
сместится в обратном направлении, расширится в сторону канала, в результате
чего сечение канала равномерно уменьшится по всей его длине. Сопротивление
канала возрастет, но выходной ток IС = 0, поскольку UСИ=0 (рис. 5.2 а).
- удельное сопротивление материала канала, l- длина, S – площадь поперечного сечения канала. В отсутствии
внешних напряжений площадь поперечного сечения канала под затвором одинакова по
всей длине канала. При приложении внешнего напряжения заданной полярности между
затвором и истоком UЗИ р–n- переход
сместится в обратном направлении, расширится в сторону канала, в результате
чего сечение канала равномерно уменьшится по всей его длине. Сопротивление
канала возрастет, но выходной ток IС = 0, поскольку UСИ=0 (рис. 5.2 а).
Если между истоком и стоком включить источник
напряжения, то через канал начнется дрейф электронов от истока к стоку, то есть через канал будет протекать
ток стока IС. Включение источника UСИ влияет и на ширину р–n- перехода, так как напряжение на переходе оказывается
разным по длине канала. Потенциал канала меняется по ее длине: потенциал истока
равен нулю, повышаясь в сторону стока, потенциал стока равен UСИ.
Обратное напряжение на р–n- переходе
вблизи истока равно ![]() , вблизи стока
, вблизи стока ![]() . В результате ширина перехода больше со стороны стока, и
сечение канала уменьшается в сторону стока (рис. 5.2 б).
. В результате ширина перехода больше со стороны стока, и
сечение канала уменьшается в сторону стока (рис. 5.2 б).

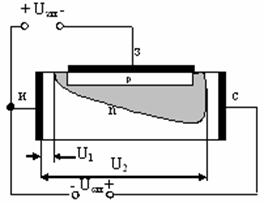
а) б)
Рис. 5.2
Таким образом, током через канал можно управлять путем
изменения напряжений UЗИ (изменяет сечение канала) и UСИ
(изменяет ток и сечение по длине канала). У истокового конца канала ширина
канала определяется заданным значением UЗИ, а у стокового – значением суммы UЗИ+UСИ. Чем больше UСИ, тем больше «клиновидность» канала, тем больше его
сопротивление.
Напряжение на затворе, при котором поперечное сечение
канала становится равным нулю, называют напряжением отсечки UЗИ.ОТС.
Напряжение на стоке, при котором суммарное напряжение ![]() становится равным напряжению отсечки UЗИ.ОТС,
называют напряжением насыщения UСИ.НАС.
становится равным напряжению отсечки UЗИ.ОТС,
называют напряжением насыщения UСИ.НАС.
Отсюда
![]() (5.1)
(5.1)
Режим работы транзистора, когда ![]() , называют режимом плавного канала, а в случае, когда
, называют режимом плавного канала, а в случае, когда ![]() , - режимом насыщения. В режиме
насыщения почти прекращается рост тока IC, несмотря на увеличение напряжения UСИ.
Это объясняется тем, что одновременно увеличивается обратное напряжение на
затворе UЗИ, вследствие чего канал сужается, что уменьшает ток IC.
В результате ток IC почти не изменяется.
, - режимом насыщения. В режиме
насыщения почти прекращается рост тока IC, несмотря на увеличение напряжения UСИ.
Это объясняется тем, что одновременно увеличивается обратное напряжение на
затворе UЗИ, вследствие чего канал сужается, что уменьшает ток IC.
В результате ток IC почти не изменяется.
Как любой трехэлектродный прибор, полевой транзистор
используется в трех схемах включения: с общим истоком, с общим стоком и с общим
затвором. Наиболее распространенной является схема с общим истоком.
5.2.
Статические характеристики ПТ
Управляющее действие напряжения на затворе UЗИ на
ток стока IC определяется по стокозатворной или, как ее еще называют передаточной характеристикой
транзистора. На рис. 5.3 а показано
семейство стокозатворной характеристики IС =f (UЗИ) при UСИ =const.
Из стокозатворной характеристики видно, что при UЗИ=0
через транзистор протекает максимально возможный ток стока. С ростом UЗИ
сечение канала падает и при некотором UЗИ=UЗИ.ОТС оно становится равным нулю и ток IС
становится практически равным нулю. Транзистор
закрывается. С ростом UСИ характеристика становится несколько круче, что
обусловлено незначительным уменьшением длины канала. Уравнение стокозатворной
характеристики имеет вид
 . (5.2)
. (5.2)

а) б)
Рис. 5.3.
На рис. 5.3 б
изображены выходные (стоковые) характеристики полевого транзистора. Стоковые характеристики – это зависимость
IС =f (UСИ) при фиксированных
значениях UЗИ =const. С
повышением UСИ ток IС увеличивается почти прямолинейно (режим плавного
канала) и при достижении UСИ= UСИ.НАС
(точка б) рост IС прекращается.
5.3.
Основные параметры ПТ
Одним из основных параметров любого типа полевого
транзистора является крутизна
 (мА/В),
(мА/В),
которую можно рассчитать по формуле
 , (5.3)
, (5.3)
где Smax –максимальная
крутизна, имеющая место при UЗИ=0. Из (5.2) (5.3) следует, что при увеличении UЗИ ток
стока и крутизна полевого транзистора уменьшается.
По статическим характеристикам можно определить и
другие параметры полевого транзистора.
Дифференциальное (внутреннее) сопротивление транзистора характеризует сопротивление канала между
истоком и стоком.
 при UЗИ =const (5.4)
при UЗИ =const (5.4)
В режиме насыщения (пологая часть ВАХ) Ri
составляет несколько МОм и практически не зависит от UСИ.
Коэффициент усиления по напряжению характеризует усилительные свойства транзистора:
 при IС =const (5.5)
при IС =const (5.5)
Этот коэффициент показывает во сколько раз напряжение
на стоке сильнее влияет на ток стока, чем напряжение на затворе. Знак «минус»
указывает на то, что направления изменений напряжения противоположны. Поскольку не всегда имеется
возможность определить коэффициент усиления по характеристикам, его можно
вычислить, исходя из следующего уравнения
![]() . (5.6)
. (5.6)
5.4. МДП –
транзисторы с индуцированным
каналом
В отличие от полевых транзисторов с управляющим p–n- переходом в МДП–транзисторах металлический затвор
изолирован от полупроводниковой области, образующей канал, слоем диэлектрика.
По этой причине МДП–транзисторы относятся к полевым транзисторам с
изолированным затвором. Слой диэлектрика представляет собой окисел диэлектрика SiO2, отсюда
другое их название - МОП-транзисторы
(структура металл – окись - полупроводник).
Принцип действия МДП – транзисторов основан на эффекте
изменения проводимости приповерхностного слоя полупроводника на границе с
диэлектриком под воздействием поперечного электрического поля. Приповерхностный
слой полупроводника и является токопроводящим каналом этих транзисторов.
Структура МДП–транзистора
с индуцированным р–каналом показана
на рис. 5.4 а, а условные обозначения на рис. 5.4 б.
Транзистор имеет выводы: вывод от истока – И, вывод от
стока – С, вывод от затвора - З и вывод
от кристалла, называемого подложкой – П.
Так как р+-области
стока и истока с полупроводником n–типа образуют два p–n- перехода,
то при любой полярности напряжения UСИ один из этих переходов оказывается включенным в
обратном направлении и ток стока IС практически равен нулю.
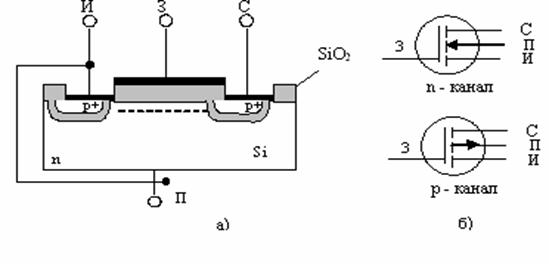
Рис. 5.4.
Для образования в транзисторе токопроводящего канала
на затвор подаётся напряжение отрицательной полярности. Электрическое поле затвора через слой диэлектрика SiO2 проникает в приповерхностный слой полупроводника,
выталкивает из него основные носители заряда (электроны) и притягивает
неосновные носители (дырки). Происходит обеднение приповерхностного слоя
электронами и обогащение его дырками. При некотором напряжении на затворе![]() , называемом пороговым UЗИ.пор,
в слое происходит смена электропроводности с электронной на дырочную и
формируется канал р – типа,
соединяющий исток со стоком. С ростом UЗИ приповерхностный слой обогащается
, называемом пороговым UЗИ.пор,
в слое происходит смена электропроводности с электронной на дырочную и
формируется канал р – типа,
соединяющий исток со стоком. С ростом UЗИ приповерхностный слой обогащается
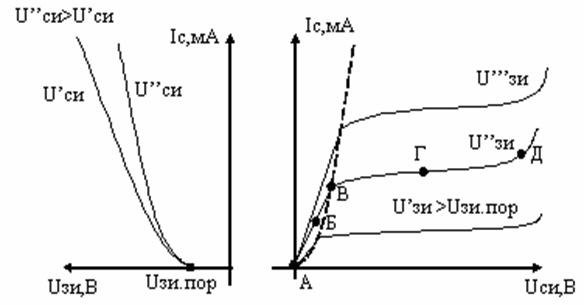
Рис. 5.5 Рис.
5.6
дырками,
что приводит к уменьшению сопротивления канала. Ток стока IС при
этом увеличивается. На рис. 5.5 приведена стоко – затворная ВАХ для МДП –
транзистора с индуцированным р –
каналом.
На рис. 5.6 приведены выходные (стоковые) характеристики
для МДП-транзисторов с индуцированным n-каналом. При заданном напряжении на затворе по мере
увеличения ![]() ток стока от нулевого
значения возрастает сначала почти линейно (область крутой части ВАХ), затем
скорость его возрастания уменьшается и при достаточно больших значениях
ток стока от нулевого
значения возрастает сначала почти линейно (область крутой части ВАХ), затем
скорость его возрастания уменьшается и при достаточно больших значениях ![]() ток стремится к постоянной величине. Прекращение возрастания
тока связано с перекрытием канала вблизи стока.
ток стремится к постоянной величине. Прекращение возрастания
тока связано с перекрытием канала вблизи стока.
5.5. МДП –
транзисторы с встроенным
каналом
На рис. 5.7 показаны структура МДП–транзистора со
встроенным каналом n–типа (а) и
условные графические изображения таких транзисторов (б).
Если при UЗИ = 0 приложить напряжение, то через канал потечет ток
электронов. При подаче на затвор напряжения, отрицательного относительно истока,
в канале создаётся поперечное электрическое поле, под влиянием которого
электроны выталкиваются из канала. Канал обедняется электронами, сопротивление
его увеличивается, и ток стока уменьшается. Чем больше отрицательное напряжение
затвора, тем меньше этот ток. Такой режим транзистора называют режимом обеднения.
Если же на затвор подать положительное напряжение, то
под действием поля, созданного этим напряжением, из областей истока и стока, а
также из кристалла в канал будут приходить электроны, его проводимость будет
увеличиваться, и ток стока возрастает. Этот режим называют режимом обогащения.
Рассмотренные процессы иллюстрируются статической
стоко – затворной характеристикой IС= f (UЗИ) при UСИ = const,
приведенной на рис. 5.8 а.
При ![]() >0 транзистор работает в режиме обогащения, а при
>0 транзистор работает в режиме обогащения, а при ![]() <0 - в режиме обеднения.
<0 - в режиме обеднения.
Стоковые характеристики (рис. 5.8 б) в режиме обогащения проходят выше начальной, снятой при UЗИ =
0, а в режиме обеднения – ниже начальной.
Статические дифференциальные параметры S, Ri и ![]() так же как и для полевых транзисторов с управляющим р–n- переходом рассчитываются по формулам (5.4), (5.5) и
(5.6) соответственно.
так же как и для полевых транзисторов с управляющим р–n- переходом рассчитываются по формулам (5.4), (5.5) и
(5.6) соответственно.

Рис. 5.7.

Рис. 5.8.
Крутизна и внутреннее сопротивление имеют примерно
одинаковый порядок для всех типов полевых транзисторов. Что же касается
входного сопротивления и межэлектродных
емкостей, то МДП–транзисторы имеют лучшие показатели, чем транзисторы с
управляющим р–n- переходом.
Так входное сопротивление RЗИ у них на несколько порядков выше и составляет 1012-1015
Ом. Значения межэлектродных емкостей не превышает: для СЗИ, ССИ -10 пФ, для СЗС -2 пФ. Последние определяют инерционность
транзистора.
Контрольные вопросы
1. Что такое полевой транзистор и почему его
называют также униполярным
транзистором
?
2. Приведите классификацию полевых
транзисторов.
3. Что из себя представляют канал, затвор,
сток, исток и подложка
полевого
транзистора ?
4. В чем заключается принцип действия
полевого транзистора с управляющим
p-n переходом ?
5. Как изменяется геометрия канала при
изменении напряжений на затворе
и
истоке относительно подложки ?
6. Как напряжение на затворе и истоке влияют
на значение тока
канала
полевого транзистора ?
7. Назовите основные схемы включения
полевого транзистора.
8. В каких режимах может работать полевой
транзистор ?
9. Какие характеристики являются основными
параметрами полевого
транзистора
10. В чем заключаются принципы действия МДП
– транзисторов со
встроенным
каналом и с индуцированным каналом ?
ГЛАВА VI. ШИРОКОПОЛОСНЫЕ
УСИЛИТЕЛИ
════════════════════════════════════════════
Аналоговые
ИМС строятся на основе базовых элементарных каскадов. К числу базовых относятся
однокаскадные усилители: на биполярных транзисторах с общим эмиттером и на
полевых транзисторах с общим истоком. Базовые каскады осуществляют усиления
мощности при одновременном усилении напряжения или тока, а также напряжения и
тока.
6.1. Усилительный
каскад на биполярном
транзисторе
Самое широкое применение находит каскад на биполярном
транзисторе, включенном по схеме с общим эмиттером. При анализе усилителя
источник сигнала представляется либо в виде идеального источника питания ЕГ с последовательно
включенным внутренним сопротивлением источника RГ (рис. 6.1 а),
либо идеального источника тока IГ с параллельно включенным сопротивлением RГ
(рис. 6.1 б).
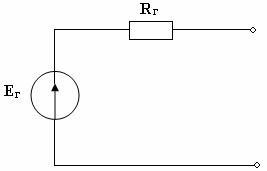

а) б)
Рис. 6.1.
Если RГ и входное сопротивление усилительного каскада имеют
примерно одинаковое значение, то выбор способа представления источника сигнала
не влияет на точность расчетов. Если же RГ намного больше входного сопротивления усилителя, то целесообразно
пользоваться представлением источника в виде, показанном на рис. 6.1 б, в противном случае – в виде,
показанном на рис. 6.1 а.
Схема усилительного каскада на биполярном транзисторе
по схеме с общим эмиттером показана на рис. 6.2.
При анализе схем, когда состояние транзистора
управляется входным напряжением, удобно пользоваться передаточной
характеристикой (рис. 6.3), семейством выходных характеристик (рис. 4.5) и
входных характеристик (рис. 4.4) транзистора.


Рис. 6.2.
Рис. 6.3.
Передаточная характеристика – зависимость тока
коллектора IК от напряжения база - эмиттер UБЭ
аппроксимируется экспоненциальной функцией
 . (6.1)
. (6.1)
где  - термический потенциал, IKS –
коэффициент пропорциональности, его ориентировочное значение для микромощных
кремниевых транзисторов при Т=300 К
имеет порядок 10-9 мА.
- термический потенциал, IKS –
коэффициент пропорциональности, его ориентировочное значение для микромощных
кремниевых транзисторов при Т=300 К
имеет порядок 10-9 мА.
В отсутствии входного сигнала усилительный каскад
находится в режиме покоя. В режиме покоя постоянная составляющая напряжения
коллектор – эмиттер ![]() .
.
При подаче на вход положительной полуволны переменного
входного сигнала будет возрастать ток базы, который вызовет относительно
большое изменение коллекторного тока. Это видно из передаточной характеристики
(6.3). Изменение коллекторного тока IK в зависимости от UБЭ характеризуется крутизной S:
 при UКЭ = const
при UКЭ = const
Эту величину можно рассчитать, используя выражение
(6.1):
 (6.2) .
(6.2) .
Таким образом, крутизна пропорциональна коллекторному
току и не зависит от индивидуальных свойств каждого транзистора. Поэтому для ее
определения не требуется измерений.
В результате действия входного сигнала напряжение на Rк
увеличится, а напряжение UКЭ уменьшится, то есть произойдет формирование
отрицательной полуволны выходного напряжения. Таким образом, такой усилительный
каскад осуществляет сдвиг фазы между UВЫХ и UВХ на 180 0. Коллекторный ток IК возрастет на величину
![]() .
.
Выходное напряжение UВЫХ уменьшится на величину
![]() .
.
Отсюда коэффициент усиления по напряжению (в
отсутствии нагрузки (IН=0)), равен
 (6.3)
(6.3)
Например, если RК=5 кОм; ![]() =25 мВ; IК=1
мА; S= 40 мА/В, то
=25 мВ; IК=1
мА; S= 40 мА/В, то
КU=-200.
Коллекторный ток зависит не только от напряжения UБЭ, но и от напряжения UКЭ. Эта зависимость характеризуется дифференциальным выходным
сопротивлением
 при UБЭ = const ,
при UБЭ = const ,
где
коэффициент пропорциональности UЕ называется напряжением Эрли. Типовые
значения UЕ находится в пределах
80-200 В для кремниевых
n-p-n транзисторов. С учетом rКЭ получим
![]() (6.5) .
(6.5) .
По отношению к источнику сигнала входное сопротивление
усилительного каскада играет роль нагрузки. Поэтому чем оно больше, чем меньше
нагружен источник сигнала, тем лучше передается его напряжение на вход каскада.
Для описания входной цепи источником напряжения как нагрузки, соединенной с
входным источником напряжения, вводят дифференциальное входное сопротивление:
 при UКЭ = const.
при UКЭ = const.
Между входным сопротивлением rБЭ и крутизной S имеется зависимость
 ,
,
где ![]() - дифференциальный коэффициент передачи тока. Для
практических расчетов можно пользоваться соотношением
- дифференциальный коэффициент передачи тока. Для
практических расчетов можно пользоваться соотношением
 (6.6).
(6.6).
Выходное, или внутреннее, сопротивление усилительного
каскада rВЫХ играет существенную роль во взаимодействии этого
каскада с нагрузкой (следующим каскадом). Выходное сопротивление усилителя
вызывает снижение выходного напряжения при протекании через нагрузку тока; это
необходимо учитывать при расчете коэффициента усиления.
Сопротивление нагрузки RН и выходное сопротивление rВЫХ образуют делитель напряжения, который уменьшает
коэффициент усиления усилителя ![]() раз. Выходное внутреннее сопротивление
раз. Выходное внутреннее сопротивление ![]() . В результате коэффициент усиления при нагрузке
. В результате коэффициент усиления при нагрузке
![]() . (6.7)
. (6.7)
Коэффициент усиления зависит от изменения температуры,
т.к.
 .
.
Наконец, дифференциальный коэффициент усиления по току
определяется выражением
 при UКЭ = const .
при UКЭ = const .
Практически он мало отличается от статического
коэффициента в широком диапазоне изменений тока коллектора, который равен ![]() .
.
Для уменьшения нелинейных искажений и температурной
стабилизации коэффициента усиления в усилительный каскад вводится отрицательная
обратная связь.
Обратной связью называют передачу части энергии с выхода или какого – либо
промежуточного звена устройства на его вход. Для этого в схему вводят
специальную цепь, носящую название цепи обратной связи. Эта цепь служит для
передачи части мощности с выхода усилителя обратно на его вход. Обратную связь,
охватывающую один каскад, принято называть местной, а охватывающую весь
многокаскадный усилитель – общей.
Наличие обратной связи может привести к увеличению,
либо к уменьшению сигнала на выходе устройства и соответственно коэффициента
усиления. В первом случае фазы входного сигнала и сигнала обратной связи совпадают
и амплитуды складываются, такую обратную связь называют положительной (ПОС). Во
втором случае фазы- противоположны и амплитуды сигналов вычитаются, такую
обратную связь называют отрицательной (ООС). В усилителях
используется только отрицательная обратная связь. Введение ООС снижает усиление
сигнала, но повышает стабильность параметров и уменьшает нелинейные искажения.
На рис. 6.4 приведена схема однокаскадного усилителя с
отрицательной обратной связью.

Рис. 6.4
Здесь ООС реализована с помощью введенного в
эмиттерную цепь резистора RЭ. С увеличением входного напряжения UВХ увеличивается
эмиттерный ток, поэтому увеличивается падение напряжения на резисторе RЭ: ![]() , так что на переходе база – эмиттер напряжение оказывается
меньше входного
, так что на переходе база – эмиттер напряжение оказывается
меньше входного ![]() .
.
Приближенно можно считать, что приращения напряжений
на входе и на резисторе RЭ равны друг другу, то есть изменением
напряжения база – эмиттер ![]() можно пренебречь.
можно пренебречь.
Через RК протекает практически тот же ток, что и через RЭ,
следовательно, изменение этого тока вызывает приращение напряжения на
коллекторном резисторе больше, чем на эмиттерном резисторе в ![]() раз. Если считать
раз. Если считать ![]() , то
, то
 .
.
В это выражение не входят параметры транзистора,
зависящие от токов. Поэтому, если учесть, что ток коллектора несколько
отличается от тока эмиттера, то с учетом этого обстоятельства коэффициент
усиления по напряжению усилителя с ООС будет также зависеть от значений тока,
хотя и в меньшей мере
 .
.
Входное сопротивление усилителя ![]() увеличивается за счет
ООС. Выходное сопротивление вследствие отрицательной связи растет незначительно и стремится к RК.
увеличивается за счет
ООС. Выходное сопротивление вследствие отрицательной связи растет незначительно и стремится к RК.
6.2. Усилители на полевых транзисторах
При построении усилителей на полевых транзисторах
наиболее широкое применение получил каскад, в котором полевой транзистор
включен по схеме с общим истоком (ОИ). На рис. 6.5 приведена типовая схема
каскада на полевом транзисторе с управляющим р–n- переходом и каналом n–типа. В полевом транзисторе с управляющим переходом
полярности напряжений, приложенные к его стоку и затвору, должны быть
противоположными. Поэтому для задания режима по постоянному току вводится
резистор RИ, который образует последовательную ООС. Кроме того,
параллельно входным выводам усилителя подключается резистор RСМ,
который обеспечивает гальваническую связь затвора с общей шиной и тем самым
стабилизирует входное сопротивление каскада.
Величину RИ для заданного тока покоя IС0 определяют с помощью стокозатворной ВАХ полевого транзистора
(см. рис. 5.3 а). Определив по ВАХ
значение UЗИ0, легко находим значение RИ по формуле
![]()
При подаче положительной полуволны UВХ на
выходе будет сформирована отрицательная полуволна UВЫХ, то есть усилительный каскад ОИ инвертирует входной
сигнал. Коэффициент усиления по напряжению равен:

Рис. 6.5
 .
.
Знак «минус» показывает, что каскад ОИ инвертирует
сигнал. На практике ![]() , поэтому коэффициент усиления можно представить в виде
, поэтому коэффициент усиления можно представить в виде
![]()
В реальных каскадах ОИ обычно КU=3 ÷50, RВХ @ RСМ, а RВЫХ @ RС.
6.3. Многокаскадные
усилители
Отрицательная обратная связь, обеспечивая хорошую
стабильность параметров усилителя, резко снижает коэффициент усиления. Для
получения высокого значения КU
применяются многокаскадные широкополосные усилители. На рис. 6.6 приведена
принципиальная схема трехкаскадного усилителя с последовательно–параллельной
обратной связью. Первый каскад ОЭ выполнен на транзисторе VT1, в нем
присутствует местная последовательная ООС по току, создаваемая резистором RЭ1. Второй
каскад выполнен на транзисторе VT2. Третий каскад выполнен на транзисторе VT3, в котором местную ООС образует резистор RЭ3. Помимо
местных ООС в усилителе используется общая обратная связь, образуемая цепью
резистора RОС, соединяющего выход усилителя с эмиттером транзистора
VT1. По сравнению с местными (внутрикаскадными)
обратными связями обратная связь, охватывающая весь усилитель, обеспечивает
более высокую стабильность и меньшую чувствительность к отклонениям
коэффициента усиления отдельных каскадов. Схема 6.6 является основой для
построения интегрального усилителя.
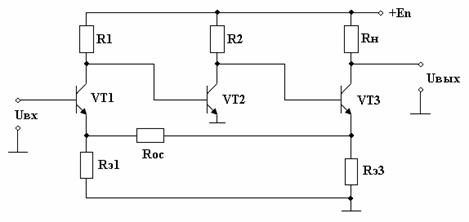
Рис. 6.6
Но кроме основного трехкаскадного усилителя с обратной
связью схема интегрального усилителя в качестве выходного каскада содержит
эмиттерный повторитель для обеспечения малого выходного сопротивления и другие
компоненты для придания усилителю дополнительной широкополосности,
устойчивости, температурной стабильности и согласования постоянной составляющей
выходного напряжения предыдущего каскада с постоянной составляющей входного
напряжения последующего каскада. Дело в том, что все каскады связаны по
постоянному току из–за отсутствия трудно реализуемых конденсаторов большой
емкости.
6.4. Выходные
каскады (усилители мощности)
аналоговых
интегральных микросхем
Задача выходных каскадов – обеспечить передачу
заданной (достаточно большой) мощности сигнала без искажений в низкоомную
нагрузку. Обычно они являются выходными каскадами многокаскадных усилителей.
Коэффициент усиления по напряжению является для выходных каскадов
второстепенным параметром. Поэтому основными показателями усилителя являются:
коэффициент полезного действия ![]() и коэффициент
нелинейных искажений КГ.
и коэффициент
нелинейных искажений КГ.
Коэффициент полезного действия равен отношению
мощности выходного сигнала к мощности, отбираемой от источника питания:
 , (6.8)
, (6.8)
где IВЫХ.m, UВЫХ.m –
амплитуды выходных величин, ЕП
– напряжение источника питания, IСР= IВЫХ.m= I0 –
средний ток.
Коэффициент нелинейных искажений характеризует отличие
формы выходного сигнала от формы входного. Это отличие появляется вследствие
нелинейности передаточной характеристики каскада. Передаточные характеристики
усилительного каскада представляют зависимость выходной величины (IВЫХ
или UВЫХ) от входной (IВХ или UВХ).
Величины ![]() и КГ во
многом определяются режимом покоя транзистора – классом усиления. Поэтому
рассмотрим классы усиления, используемые в усилителях мощности.
и КГ во
многом определяются режимом покоя транзистора – классом усиления. Поэтому
рассмотрим классы усиления, используемые в усилителях мощности.
В зависимости
от того, как расположена на передаточной характеристике исходная рабочая точка
(точка покоя) различают несколько классов усиления А, В, АВ и др.
В режиме класса А рабочая точка в режиме
покоя расположена в середине квазилинейного участка передаточной характеристики
(рис. 6.7).

Рис. 6.7.
Нелинейные искажения минимальны (КГ![]() 1 %), так как обе полуволны входного сигнала находятся в
пределах квазилинейного участка передаточной характеристики. Из рисунка
следует, что
1 %), так как обе полуволны входного сигнала находятся в
пределах квазилинейного участка передаточной характеристики. Из рисунка
следует, что  ;
;![]() ; тогда, подставляя в (6.8), получим:
; тогда, подставляя в (6.8), получим:
 , (т.е. 25 %).
, (т.е. 25 %).
В режиме класса В рабочая точка в режиме
покоя расположена на границе квазилинейного участка, которая соответствует
запертому состоянию транзистора. Транзистор находится в открытом состоянии лишь
в течение положительной полуволны сигнала (рис. 6.8).

Рис. 6.8
КГ в классе В составляет около 70 %. Подставив в формулу
(7.1) ЕП и  , получим
, получим
 (т.е. 78 %).
(т.е. 78 %).
Для уменьшения нелинейных искажений в режиме класса В
используются двухтактная схема, состоящая из двух усилителей, один из
которых усиливает положительную полуволну, а другой – отрицательную.
Класс АВ
занимает промежуточное положение между классами А и В. Он также применяется в
двухтактных устройствах. В режиме покоя здесь один транзистор закрыт, а другой
лишь приоткрыт, но это позволяет вывести основную часть рабочей полуволны на
участок ВАХ с малой нелинейностью. Коэффициент ![]() здесь выше, чем в классе А, а КГ
здесь выше, чем в классе А, а КГ ![]() 3 %.
3 %.
6.5. Эмиттерный
повторитель
Эмиттерный повторитель является простейшим выходным
каскадом. Повторителями называют усилители с коэффициентом усиления по
напряжению, близким к единице, не меняющие полярность входного сигнала и
обладающие повышенным входным и пониженным выходным дифференциальными
сопротивлениями.
Классическая схема эмиттерного повторителя показана на
рис. 6.9. При постоянном входном напряжении транзистора (режим класса А), в цепи эмиттера протекает постоянный
ток, вызывающий падение напряжения на резисторе RЭ. Выходное напряжение UВЫХ устанавливается
таким, что напряжение база–эмиттер оказывается равно  .
.
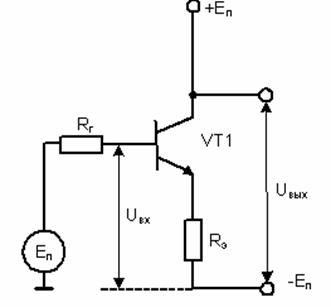
Рис. 6.9.
Входной сигнал увеличивает (уменьшает) UВХ на величину ![]() , что приводит к увеличению (уменьшению) тока эмиттера. В
результате выходное напряжение UВЫХ возрастет (уменьшится) на
, что приводит к увеличению (уменьшению) тока эмиттера. В
результате выходное напряжение UВЫХ возрастет (уменьшится) на ![]() . При этом выходное напряжение возрастет почти так же, как
входное, а коэффициент усиления по напряжению равен
. При этом выходное напряжение возрастет почти так же, как
входное, а коэффициент усиления по напряжению равен
 .
.
Входное сопротивление эмиттерного повторителя не
отличается от входного сопротивления схемы с общим эмиттером и ООС по току и
равно
![]() .
.
Выходное сопротивление rВЫХ вследствие 100 % отрицательной обратной связи (обеспечивается
RЭ)
уменьшается. Это происходит потому, что всякое увеличение выходного напряжения
увеличивает ток эмиттера, а
значит
и ток базы, которому противодействует RГ.
Но ток в цепи базы в ![]() раз меньше, чем в цепи эмиттера, поэтому выходное
сопротивление
раз меньше, чем в цепи эмиттера, поэтому выходное
сопротивление
 .
.
Если учесть и сопротивление эмиттер – база, то получим
 .
.
В микроэлектронике класс А не используется из–за низкого КПД. Наиболее популярны двухтактные
усилители классов В и АВ, к рассмотрению которых мы и
переходим.
Контрольные вопросы
1. Каковы основные характеристики и
показатели усилителей и их
отличительные
особенности ?
2.
Что называется обратной связью в усилителях ?
3. Как изменяется коэффициент усиления при
введении в схему усилителя
отрицательной обратной
связи и влияет ли она на стабильность его
работы ?
4. Какие классы усиления Вам известны ?
5. Почему при работе усилителя в классе А
самый низкий коэффициент
полезного действия ?
6. Почему при работе усилителя в классе В
появляются значительные
искажения формы
симметричного сигнала ?
7. Чем класс усиления АВ отличается от
класса В и в каких схемах он
используется ?
8. Что такое многокаскадный усилитель ?
9. Для чего служат выходные каскады в
многокаскадных усилителях ?
ГЛАВА VII. ИНТЕГРАЛЬНЫЕ МИКРОСХЕМЫ
════════════════════════════════════════════
7.1. Общие
сведения об интегральных
микросхемах
Интегральные микросхемы представляют собой качественно новый тип электронных приборов и являются основной
элементной базой электронных устройств.
Интегральная микросхема (ИМС) – это совокупность
электрически связанных между собой электрорадиоэлементов (транзисторов, диодов,
резисторов, конденсаторов и др.), изготовленных в едином технологическом цикле,
то есть
одновременно, на одной и той же несущей конструкции (подложке), и выполняющая
определенную функцию преобразования информации.
Основная особенность ИМС состоит в том, что она
выполняет сложную функцию и может быть усилителем, триггером, счетчиком,
запоминающим устройством и др., тогда как для выполнения той же функции на
дискретных элементах требуется собрать соответствующую схему.
Для ИМС присущи два основных признака: конструктивный
и технологический.
Конструктивный признак заключается в том, что элементы ИМС, расположенные
внутри или на поверхности общей подложки, электрически соединенные и
заключенные в общий корпус, представляют собой неразделимое целое. Все или
часть элементов и межэлементных соединений ИМС создают в едином технологическом
цикле. Отсюда высокая надежность и низкая стоимость интегральных микросхем.
В настоящее время по способу изготовления и получаемой
при этом структуре различают три принципиально разных типа ИМС: полупроводниковые,
пленочные и гибридные. Каждый тип ИМС отличается конструкцией, степенью
интеграции, характеризующей количество элементов и компонентов, входящих в
состав микросхемы.
Элементом
называют часть ИМС, реализующую функции какого – либо электрорадиоэлемента
(транзистор, диод, резистор, конденсатор и др.), которая выполнена конструктивно
неотделима от кристалла или подложки.
Компонентом
ИМС называется та ее часть, которая выполняет
функцию дискретного элемента, но перед монтажом является самостоятельным
изделием.
Одним из главных конструктивных признаков ИМС считают тип
подложки. По этому признаку ИМС можно разделить на два типа: ИМС на
полупроводниковых и диэлектрических подложках.
Среди полупроводниковых материалов в качестве подложек
используются кремний и арсенид галлия. Часть
или все элементы ИМС расположены внутри самой подложки, выполненной в виде
полупроводниковой монокристаллической пластины.
В ИМС с диэлектрической подложкой элементы размещаются
на ее поверхности. Основное преимущество микросхем с
полупроводниковой подложкой – очень большая степень интеграции элементов, но с
ограниченным диапазоном номинальных значений их параметров и необходимость их
изоляции друг от друга. Основные преимущества микросхем с диэлектрической
подложкой – очень хорошая изоляция элементов, стабильность их свойств, а также
возможность более широкого выбора типа элементов и их электрических параметров.
7.2. Пленочные
и гибридные
микросхемы
Пленочная ИС – это микросхема, элементы которой выполнены в виде пленок, нанесенных
на поверхность диэлектрической подложки. Пленки создают путем осаждения при
низких давлениях различных материалов в виде тонких пленок.
В зависимости от способа нанесения пленки и связанной
с этим их толщиной различают тонкопленочные ИС (толщина пленки до
1 – 2 мкм) и толстопленочные ИС (толщина пленок от 10 – 20 мкм и выше).
В настоящее
время не существует стабильных пленочных диодов и транзисторов, поэтому
пленочные ИС содержат только пассивные элементы (резисторы, конденсаторы и
т.п.).
Гибридная ИС (или ГИС) – это микросхема, которая представляет собой
комбинацию пленочных пассивных элементов и дискретных активных элементов,
расположенных на общей диэлектрической подложке. Дискретные компоненты называют
навесными. Активные элементы для гибридных ИМС являются бескорпусными, либо в миниатюрных
металлических корпусах.
Основные преимущества гибридных интегральных
микросхем: возможность создания широкого класса цифровых и аналоговых микросхем
при сравнительно коротком времени их разработки; возможность получения
пассивных элементов широкой номенклатуры; МДП – приборы диодные и транзисторные
матрицы и высокий процент выхода годных микросхем.
7.3. Полупроводниковые
ИМС
По типу используемого транзистора полупроводниковые
ИМС принято подразделять на биполярные и МДП ИМС. Кроме того, в последнее время
все большее значение приобретают ИМС, построенные на полевых транзисторах с
управляющим переходом. К этому классу относятся ИМС на арсениде галлия, полевые
транзисторы с затвором в виде диода Шоттки. В настоящее время намечается
тенденция к построению ИМС, где одновременно будут использоваться и биполярные
транзисторы, и полевые транзисторы.
Технология
полупроводниковых ИС обоих классов основана на легировании (внесении)
полупроводникового кристалла поочередно донорными и акцепторными примесями, в
результате чего под поверхностью образуются тонкие слои с разным типом
проводимости, то есть транзисторная структура n–p–n или p–n–p типа. Размеры
одного транзистора составляют всего несколько микрометров. Изоляция отдельных
элементов может быть осуществлена либо р–n- переходом, либо диэлектрической пленкой. Транзисторная
структура используется не только для создания транзистора, но и всех других
элементов (диоды, резисторы, конденсаторы).
Помимо биполярных транзисторов в микроэлектронике
применяют многоэмиттерные и многоколлекторные транзисторы.
Многоэмиттерные транзисторы (МЭТ) имеют один коллектор
и несколько (до 8 – 10 и более) эмиттеров, объединенных одним общим базовым
слоем. Они используются для создания схем транзисторно– транзисторной логики
(ТТЛ).
Структура многоколлекторного транзистора такая же, как
и структура МЭТ, но используется для создания логических схем с инжекционным
питанием, называемых схемами интегральной инжекционной логики (И2Л).
Диоды.
Диоды содержат один р–n- переход. Но в биполярных ИМС основной
структурой является транзисторная, поэтому диоды получают путем диодного
включения транзисторов. Возможны пять вариантов таких включений. Если для создания
диода используется р–n- переход эмиттер – база, то р–n-
переход коллектор – база должен быть замкнут.
Резисторы. В
биполярных ИМС для создания резисторов используют одну из областей биполярной
транзисторной структуры: эмиттерную, базовую или коллекторную. На основе
эмиттерных областей получают резисторы с малым сопротивлением. Наибольшим
сопротивлением обладают резисторы, выполненные на основе слоя базы.
Конденсаторы. В биполярных ИМС применяют конденсаторы на основе р–n-
переходов, смещенных в обратном направлении.
Формирование конденсаторов производится в едином технологическом цикле
одновременно с изготовлением транзисторов и резисторов, что не требует
дополнительных технологических операций их изготовления.
МДП–транзисторы. В ИМС в основном применяют МДП– транзисторы с изолированным затвором и
индуцированным каналом. Канал транзисторов может быть и р– и n–типа. МДП–транзисторы используют не только в качестве
транзисторов, но и как резисторы и конденсаторы, то есть все схемные
функции, реализуются на одних МДП – структурах. Если в качестве диэлектрика
используют SiO2, тогда эти транзисторы называют МОП–транзисторами.
При изготовлении МДП – структур отсутствуют операции по изоляции элементов друг
от друга, так как истоки и стоки смежных транзисторов разделены
встречновключенными р–n- переходами. Поэтому МДП – транзисторы можно
располагать близко друг к другу, что обеспечивает большую плотность компоновки.
Биполярные и МДП ИМС изготовляют по планарной
или планарно – эпитаксиальной технологии.
В планарной технологии при изготовлении n-р–n транзисторных структур в отдельные участки
полупроводниковой пластины р–типа
проводится локальное легирование примесей через специальные маски с
отверстиями. Роль маски играет пленка двуокиси кремния SiO2,
покрывающая поверхность пластины. В этой пленке специальными методами
(фотолитография) формируются отверстия, называемые окнами. Примеси вводятся
путем диффузии (перемещение атомов примеси в полупроводниковую подложку под
действием градиента их концентрации при высокой температуре), либо ионным
легированием. При ионном легировании ионы примеси, получаемые из специальных
источников, ускоряются и фокусируются в электрическом поле, попадают на
подложку и внедряются в поверхностный слой полупроводника.
Пример структуры биполярной полупроводниковой ИМС,
изготовленной по планарной технологии, и ее эквивалентная электрическая схема показаны на рис.
7.1 а, б.
На одной подложке диаметром 76 мм групповым методом
одновременно можно создать до 5000 микросхем, каждая из которых может содержать
от 10 до 20000 элементов (транзисторов, резисторов, конденсаторов). На пластине
диаметром до 120 мм размещаются десятки миллионов элементов.
Современные ИМС изготовляются по планарно–эпитаксиальной
сплавной технологии. Эта технология отличается от планарной тем, что все
элементы создаются в эпитаксиальном слое кремния n–типа, выращенном на подложке р–типа. Эпитаксией называют ориентированный рост слоя,
кристаллическая решетка которого повторяет структуру подложки.

а)
б)
Рис. 7.1
Транзисторы, изготовленные по планарно–эпитаксиальной
технологии, более экономичны, а также обладают улучшенными параметрами и
характеристиками по сравнению с планарными.
Для этого в подложку перед эпитаксией вводится n+-слой,
показанный на рис. 7.2. В этом случае ток через транзистор идет через
низкоомный n+-слой, а не через высокоомное сопротивление тела
коллектора.

Рис. 7.2.
Для
электрического соединения различных элементов микросхем применяется металлизация. В процессе
металлизации образуются тонкие металлические пленки из золота, серебра, хрома
или алюминия. В кремниевых ИМС для создания металлизации наибольшее применение
нашел алюминий.
По схемотехническим признакам микросхемы делятся на
два класса.
Основной функцией, выполняемой ИМС, является обработка
(преобразование) информации, заданной в
виде электрического сигнала: напряжения или тока. Электрические сигналы могут
представлять информацию в непрерывной (аналоговой) или дискретной (цифровой)
форме.
Поэтому микросхемы, выполняющие обработку аналоговой
информации, называются аналоговыми интегральными схемами (АИС), а цифровой информации – цифровыми
интегральными схемами (ЦИС).
В основе цифровых схем лежат простейшие транзисторные
ключи (вентили). Ключи характерны двумя устойчивыми состояниями: разомкнутым и
замкнутым. На основе простейших ключей строятся более сложные схемы:
логические, бистабильные, триггерные (спусковые), шифраторные, компараторы и
другие, применяемые главным образом в вычислительной технике. Они выполняют
функции приема, хранения, обработки и выдачи информации, представленной в цифровой
форме.
Уровень сложности интегральных микросхем характеризуется степенью
компонентной интеграции, которая для цифровых ИМС характеризуется
числом логических вентилей, содержащихся на кристалле.
ИМС с числом вентилей менее 100 относятся к ИМС малой
степени интеграции. Средние (СИС) содержат порядка 102, большие
(БИС) -102¸105, сверхбольшие (СБИС) – 105¸107 и ультрабольшие (УСБИС) – свыше 107
вентилей. Эта классификация часто распространяется и на аналоговые микросхемы.
Контрольные вопросы
1.
Что такое интегральная микросхема (ИМС) ?
2. Какова основная особенность ИМС ?
3. Что называется элементом и компонентом
ИМС ?
4. В чем отличия пленочных, гибридных и
полупроводниковых ИМС ?
5. Почему транзисторная структура служит
основой изготовления различных
элементов ИМС ?
6. Каким образом происходит изоляция
элементов интегральной микросхемы ?
7. Чем отличаются транзисторы, изготовленные
по планарной и планарно –
эпитаксиальной
технологии ?
8. Как определяется степень сложности
(степень интеграции) цифровых и
аналоговых ИМС ?
9. Какие сигналы преобразуются в аналоговых,
а какие в цифровых
интегральных
микросхемах ?
ГЛАВА VIII. СХЕМОТЕХНИКА
УСИЛИТЕЛЬНЫХ УСТРОЙСТВ
════════════════════════════════════════════
8.1. Основные параметры и характеристики
усилителей
Усилители постоянного тока, широкополосные и
избирательные усилители являются элементной базой аналоговой микроэлектронной
аппаратуры.
Усилителем называется
устройство, предназначенное для усиления мощности входного сигнала. Усиление
происходит с помощью транзисторов за счет потребления энергии от источника
питания. В любом усилителе входной сигнал лишь управляет передачей энергии от источника питания в нагрузку.
Для характеристики усилительных свойств используются
коэффициент усиления по напряжению  , по току
, по току  или по мощности
или по мощности  . Для усилителей возможны различные значения коэффициентов
усиления, но
. Для усилителей возможны различные значения коэффициентов
усиления, но ![]() всегда.
всегда.
Коэффициент усиления по напряжению в децибелах (дБ)
равен  . Если коэффициент усиления многокаскадного усилителя выражен
в дБ, то общее усиление многокаскадного усилителя равно сумме коэффициентов
усиления каскадов.
. Если коэффициент усиления многокаскадного усилителя выражен
в дБ, то общее усиление многокаскадного усилителя равно сумме коэффициентов
усиления каскадов.
|
KU, дБ |
0 |
1 |
2 |
3 |
10 |
20 |
40 |
60 |
80 |
|
KU |
1 |
1,12 |
1,26 |
1,41 |
3,16 |
10 |
102 |
103 |
104 |
Усилитель характеризуется своими входным ![]() и выходным
и выходным ![]() сопротивлениями, а источник входного сигнала – ЭДС ЕГ
и внутренним сопротивлением
сопротивлениями, а источник входного сигнала – ЭДС ЕГ
и внутренним сопротивлением ![]() .
.
Если в усилителе ![]() >>
>>![]() , то источник сигнала на входе усилителя развивает
напряжение, близкое к ЕГ. Такой режим называют потенциальным
входом, а сам усилитель является усилителем напряжения. Если
, то источник сигнала на входе усилителя развивает
напряжение, близкое к ЕГ. Такой режим называют потенциальным
входом, а сам усилитель является усилителем напряжения. Если ![]() <<
<<![]() , выходное напряжение и мощность источника сигнала
пренебрежимо мало. Такой режим называется токовым входом, а усилитель
называется усилителем тока. В усилителе мощности
, выходное напряжение и мощность источника сигнала
пренебрежимо мало. Такой режим называется токовым входом, а усилитель
называется усилителем тока. В усилителе мощности ![]()
![]()
![]() , то есть вход согласован с источником входного сигнала.
, то есть вход согласован с источником входного сигнала.
По соотношению между величинами ![]() и сопротивлением нагрузки
и сопротивлением нагрузки ![]() усилители можно
разделить на усилители напряжения (
усилители можно
разделить на усилители напряжения (![]() <<
<<![]() ), усилители тока (
), усилители тока (![]() >>
>>![]() ) и усилители мощности (
) и усилители мощности (![]()
![]()
![]() ).
).
Кроме того, параметром усилителя постоянного тока
является дрейф нуля – изменение режима работы элементов усилителя под действием
дестабилизирующих факторов (колебания напряжения источника питания, температуры
и другие), в результате чего на выходе усилителя появляется ложный сигнал.
На практике усилитель помимо усиления сигнала изменяет
его форму. Отклонение форм выходного и входного сигналов принято называть искажениями.
Они бывают двух видов: нелинейные и линейные.
Все усилители содержат транзисторы, вольтамперная
характеристика (ВАХ) которых нелинейная. Так, ВАХ биполярного транзистора имеет
форму экспоненты, а не прямой линии. Поэтому, например, при усилении сигнала
синусоидальной формы выходной сигнал не будет частично синусоидальным. В
спектре выходного сигнала появляется компоненты (гармоники) с другими
частотами, которые отсутствовали во входном сигнале. Искажения такого вида называются нелинейными.
Аналитическая оценка нелинейных искажений может быть проведена, если
передаточная характеристика усилителя задана в виде математической функции.
Передаточная характеристика (рис. 8.1) представляет собой зависимость амплитуды
выходного напряжения ![]() от амплитудного значения входного сигнала
от амплитудного значения входного сигнала ![]() неизменной частоты.
Чаще коэффициент нелинейных искажений оценивают графически по известной
передаточной характеристике.
неизменной частоты.
Чаще коэффициент нелинейных искажений оценивают графически по известной
передаточной характеристике.
При небольших напряжениях ![]() передаточная
характеристика практически линейна. Если угол наклона характеристики с ростом
напряжения
передаточная
характеристика практически линейна. Если угол наклона характеристики с ростом
напряжения ![]() изменяется, то это
указывает на появление искажения формы сигнала.
изменяется, то это
указывает на появление искажения формы сигнала.
Линейные искажения определяются
зависимостью параметров транзисторов от частоты. Частотные свойства усилителя
определяются амплитудно – частотной характеристикой (АЧХ). АЧХ представляет
собой зависимость коэффициента усиления по частоте. Идеальной АЧХ является горизонтальная
линия. Реальная же АЧХ имеет спадающие участки. На рис. 8.2 приведена
нормированная АЧХ  , где К0 – номинальный коэффициент
усиления, то есть коэффициент усиления в области частот, где он постоянен.
Обычно допустимые величины коэффициентов частотных искажений не превышает 3 дБ.
Величину
, где К0 – номинальный коэффициент
усиления, то есть коэффициент усиления в области частот, где он постоянен.
Обычно допустимые величины коэффициентов частотных искажений не превышает 3 дБ.
Величину ![]() называют полосой
пропускания усилителя.
называют полосой
пропускания усилителя.

Рис. 8.1. Рис. 8.2.
Усилителями постоянного тока называют устройства, предназначенные для усиления не
только переменных, но и постоянных составляющих напряжения и тока. Низкая
рабочая частота таких усилителей нулевая (![]() =0), а верхняя вплоть до очень высокой (
=0), а верхняя вплоть до очень высокой (![]() - несколько десятков МГц). Усилители постоянного тока имеют
много разновидностей (дифференциальные, операционные, усилители с
преобразованием сигнала и другие).
- несколько десятков МГц). Усилители постоянного тока имеют
много разновидностей (дифференциальные, операционные, усилители с
преобразованием сигнала и другие).
Интегральные широкополосные усилители усиливают сигналы в широком диапазоне частот от
заданной нижней граничной частоты ![]() до некоторой верхней
граничной частоты
до некоторой верхней
граничной частоты ![]() . Основным требованием к широкополосным усилителям является
обеспечение равномерного усиления входного сигнала в диапазоне частот от
. Основным требованием к широкополосным усилителям является
обеспечение равномерного усиления входного сигнала в диапазоне частот от ![]() до
до ![]() с заданным
коэффициентом усиления. При этом
уменьшение модуля коэффициента усиления от
с заданным
коэффициентом усиления. При этом
уменьшение модуля коэффициента усиления от ![]() до
до ![]() не должно превышать 3
дБ (
не должно превышать 3
дБ (![]() =0,7). Частота
=0,7). Частота ![]() может достигать
нескольких сотен мегагерц.
может достигать
нескольких сотен мегагерц.
Избирательными усилителями (фильтрами) называют усилители, которые из совокупности
принимаемых сигналов выбирают и
усиливают только синусоидальные сигналы с определенными спектром частот.
Избирательные усилители обладают особой формой АЧХ.
Полоса частот, в которой осуществляется усиление
сигнала, называют полосой пропускания. Полосу частот, в которой сигналы
подавляются, называют полосой заграждения. В зависимости
от взаимного расположения полос пропускания и заграждения различают следующие
виды избирательных усилителей: нижних частот, верхних частот, полосовые
пропускания, полосовые заграждения. Фильтры реализуются на базе RC – цепей и активных элементов. Поэтому такие фильтры
называют активными.
8.2. Комплементарный
эмиттерный повторитель
На рис. 8.3 показана простейшая двухтактная схема
выходного каскада класса В, выполненная на комплементарных транзисторах:
VT1 – транзистор n-p-n типа и VT2 – транзистор p-n-р типа. Нагрузка
включается в эмиттерную цепь транзисторов, следовательно, они работают в режиме
повторителей напряжения. Усиление мощности обусловлено усилением тока. Особо
обратим внимание на использование двухполярного питания (два напряжения питания
+ЕП и - ЕП).
Поэтому в


Рис. 8.3 Рис. 8.4
режиме
покоя оба транзистора заперты, поскольку напряжения на эмиттерных переходах
равны нулю. Следовательно, в режиме покоя схема не потребляет энергии.
При подаче на вход положительной полуволны ![]() открывается транзистор
VT1 и через нагрузку
открывается транзистор
VT1 и через нагрузку ![]() потечет ток в
направлении стрелки 1. Во время отрицательной полуволны открыт p-n-р транзистор и ток протекает по стрелке 2. Коэффициент
усиления мощности примерно равен отношению эмиттерного и базового токов ( то
есть
потечет ток в
направлении стрелки 1. Во время отрицательной полуволны открыт p-n-р транзистор и ток протекает по стрелке 2. Коэффициент
усиления мощности примерно равен отношению эмиттерного и базового токов ( то
есть![]() ).
).
Однако, будучи усилителем класса В, схема
обладает большим коэффициентом нелинейных искажений КГ>10 %.
Для устранения этого недостатка усилитель усложняют, вводя индивидуальные
смещения на базы транзисторов с помощью резисторов R1 и R2, а
также диодов VD1 и VD2
(рис. 8.4). В результате исходная рабочая точка располагается в области, когда
оба транзистора приоткрыты (режим АВ), но через них протекает ток
значительно меньший, чем в классе А.
8.3. Усилители
на основе балансных
схем
Улучшение характеристик широкополосных усилителей в
интегральном исполнении удается путем каскадирования одиночных каскадов,
охваченных цепью отрицательной обратной связи. В тоже время существенное
улучшение характеристик усилителей было достигнуто в усилителях, построенных на
основе балансных схем.
В качестве входного каскада такого типа усилителей
используют простейшие схемы балансного типа – дифференциальные (параллельно –
балансные или разностные) усилители. Их отличает высокая стабильность работы и
малый дрейф нуля.
Принцип работы балансной схемы можно пояснить на
примере четырехплечего моста (рис. 8.5) .
Если выполнено условие балансировки моста, то
есть  , то в нагрузочном сопротивлении RН ток
и соответственно напряжение равны нулю. Баланс не нарушится и в том случае,
если будут изменяться напряжение ЕП и сопротивление
резисторов плеч моста, но при условии, что соотношение между сопротивлениями
резисторов сохраняется.
, то в нагрузочном сопротивлении RН ток
и соответственно напряжение равны нулю. Баланс не нарушится и в том случае,
если будут изменяться напряжение ЕП и сопротивление
резисторов плеч моста, но при условии, что соотношение между сопротивлениями
резисторов сохраняется.
В усилительных каскадах на одном транзисторе в
коллекторной (эмиттерной) нагрузке выделяется напряжение, не зависящее от
сигнала. Оно изменяется при колебаниях напряжения питания, изменения токов
транзистора из–за нагрева и многих других факторов и тем самым снижает
стабильность параметров усилительного устройства.

Рис. 8.5
Улучшение динамических характеристик дифференциального
усилителя по сравнению с элементарными усилительными каскадами происходит также
за счет стабилизации режима его работы генератором стабильного тока.
8.4. Генератор
стабильного тока
Генератор или источник стабильного тока (ГСТ) является
электронным эквивалентом резистора большого номинала. При этом сопротивление
ГСТ должно быть намного больше максимально возможного сопротивления, включенной
последовательно с ним, нагрузки RН. В этом случае ГСТ
обеспечит в нагрузке протекание тока, величина которого не зависит от ее
сопротивления и дестабилизирующих факторов. Ясно, что реализация резистора с
сопротивлением в единицы МОм в интегральных схемах невозможна.
На рис. 8.6 а приведена принципиальная схема
ГСТ. Здесь элемент Н символизирует нелинейную нагрузку, Е1 –
источник стабилизированного напряжения. Резистор R0, а также транзистор VT1 в диодном включении служат для задания и стабилизации
режима покоя транзистора VT2. Рабочая
точка для VT2 располагается на пологой части его выходной ВАХ (см. рис.
выходные ВАХ в схеме ОБ). В схеме включения с ОБ транзистор обладает очень
большим выходным дифференциальным сопротивлением (до единиц мегаОм). По схеме
включения напряжение база – эмиттер UБЭ
обоих транзисторов одинаковы. Ток IБ2 в сотни раз меньше
тока эмиттера IЭ2. Пренебрегая им, получим, что IЭ1
равен IЭ2, а I2= I1.
Следовательно
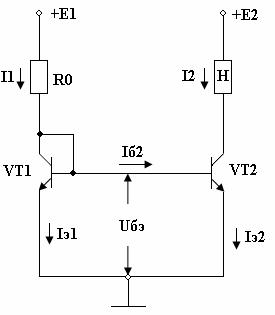

а) б)
Рис. 8.6
выходной
ток I2
повторяет или отражает ток I1. Так как ток I2
практически не зависит от напряжения на коллекторном переходе транзистора VT2, то при изменении напряжения Е2 или
сопротивления нагрузки RН величина I2 остается практически
постоянной.
Выходным током I2
можно управлять, меняя входной ток I1. Для этого в
эмиттерные цепи транзисторов включаются
резисторы R1 и R2. Такое
устройство называется активным трансформатором тока (рис.
8.6 б). Из рис. 8.6 б следует равенство:
![]()
Если сопротивления R1 и R2 отличаются своим номиналом, то ток I2 может «отражать» ток I1 как
в «увеличенном», так и в «уменьшенном» масштабе.
8.5. Схема сдвига уровня постоянного
напряжения
Интегральные усилители строятся по схемам с
непосредственными связями между каскадами. При этом от каскада к каскаду
происходит изменение постоянной составляющей сигнала, что вызывает затруднения
при разработке последних каскадов. Для устранения указанного явления
используются схемы сдвига уровня постоянного напряжения, называемые также трансформаторами
уровня. При этом схема сдвига уровня должна по возможности без изменений
передать переменную составляющую – сигнал, то есть коэффициент усиления по
напряжению ![]() 1.
1.
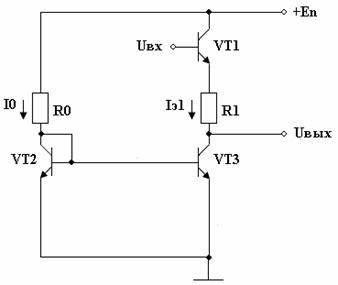
Рис. 8.7
В операционных усилителях сдвиг уровня ![]() осуществляется эмиттерным повторителем на транзисторе VT1, в эмиттерную цепь которого включены резистор R1 и генератор стабильного тока на транзисторах VT2 и VT3 (рис.
8.7). Потенциал входа
осуществляется эмиттерным повторителем на транзисторе VT1, в эмиттерную цепь которого включены резистор R1 и генератор стабильного тока на транзисторах VT2 и VT3 (рис.
8.7). Потенциал входа ![]() в отсутствии сигнала
равен постоянной составляющей выходного напряжения предшествующего каскада.
Потенциал выхода
в отсутствии сигнала
равен постоянной составляющей выходного напряжения предшествующего каскада.
Потенциал выхода ![]() схемой сдвига уменьшается на величину
схемой сдвига уменьшается на величину ![]() . Поскольку ток IЭ1 стабилизирован, то
напряжение сдвига
. Поскольку ток IЭ1 стабилизирован, то
напряжение сдвига ![]() постоянно. При любом
значении
постоянно. При любом
значении ![]() потенциал выхода
потенциал выхода ![]() может быть сделан равным нулю соответствующим подбором
отношения
может быть сделан равным нулю соответствующим подбором
отношения ![]() . Поскольку динамическое выходное сопротивление ГСТ
существенно больше R1, сигнал
схемой сдвига почти не ослабляется.
. Поскольку динамическое выходное сопротивление ГСТ
существенно больше R1, сигнал
схемой сдвига почти не ослабляется.
8.6. Дифференциальные усилители
Дифференциальным усилителем (ДУ) называется усилитель
с двумя входами, сигнал на выходе которого пропорционален разности входных
сигналов.
На рис. 8.8 приведена схема простейшего симметричного
ДУ. Усилитель содержит два симметричных плеча, первое из которых состоит из транзистора VT1 и резистора RК1, а
второе образовано транзистором VT2 и
резистором RК2. Начальный режим работы схемы обеспечивается током IЭ,
постоянство которого обеспечивается генератором стабильного тока (ГСТ).
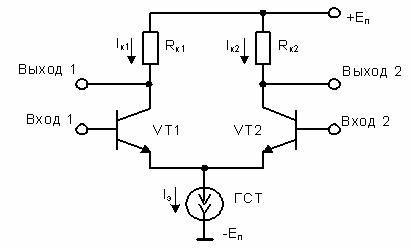
Рис. 8.8
Нетрудно убедиться, что схема ДУ аналогична схеме рис.
8.5, если резисторы R2 и R3
заменить транзисторами VT1 и VT2, и считать, R1= RК1, а R4= RК2.
Если сопротивления RК1 и RК2 равны друг другу, а
транзисторы VT1 и VT2 с идентичными параметрами, то схема симметрична.
На практике
можно использовать любую их четырех схем включения: симметричный вход и
выход, симметричный вход и несимметричный выход, несимметричный вход и
симметричный выход, несимметричный вход и выход. При симметричном входе
источник входного сигнала подключается между входами ДУ (между базами
транзисторов). При симметричном выходе сопротивление нагрузки подключается
между выходами ДУ (между коллекторами транзисторов).
Отметим, что питание ДУ осуществляется от двух
источников, напряжения которых равны (по модулю) друг другу. Питание от
двухполярного источника позволяет снизить потенциалы баз транзисторов в режиме
покоя до общей шины. Это дает возможность подавать сигналы на входы ДУ без
введения дополнительных схем сдвига
уровня.
При идеальной симметрии обоих плеч в отсутствии входных сигналов (![]() =0,
=0, ![]() =0) коллекторные токи и потенциалы коллекторов транзисторов
будут одинаковы, а выходное напряжение
=0) коллекторные токи и потенциалы коллекторов транзисторов
будут одинаковы, а выходное напряжение ![]() =0. Поскольку схема симметрична, всякое изменение
характеристик транзистора независимо от причин, вызывающих эти изменения,
вызывает одинаковое изменение токов в обоих плечах. Поэтому разбаланса схемы не
произойдет и дрейф выходного напряжения будет практически равен нулю.
=0. Поскольку схема симметрична, всякое изменение
характеристик транзистора независимо от причин, вызывающих эти изменения,
вызывает одинаковое изменение токов в обоих плечах. Поэтому разбаланса схемы не
произойдет и дрейф выходного напряжения будет практически равен нулю.
Подача на оба входа ДУ сигналов с одинаковой фазой и
амплитудами (синфазные сигналы) ![]() =
=![]() , вследствие симметрии плеч и наличия ГСТ не вызовет
изменения коллекторных токов и они останутся
неизменными и равными:
, вследствие симметрии плеч и наличия ГСТ не вызовет
изменения коллекторных токов и они останутся
неизменными и равными:
![]()
где ![]() - коэффициент передачи тока эмиттера.
- коэффициент передачи тока эмиттера.
Следовательно, потенциалы коллекторов остаются
равными, а ![]() . Это значит, что идеальный ДУ не реагирует на синфазные
входные сигналы.
. Это значит, что идеальный ДУ не реагирует на синфазные
входные сигналы.
Если входные сигналы одинаковы по амплитуде, но с
противоположными фазами, их называют дифференциальными. За счет действия
дифференциального сигнала ток одного плеча увеличивается за счет уменьшения
тока другого плеча ![]() , т.к. сумма токов всегда равна
, т.к. сумма токов всегда равна ![]() . Потенциал коллектора одного транзистора уменьшается, а
другого увеличивается на одно и то же значение. На выходе ДУ появится разность
потенциалов, а следовательно, выходное напряжение
. Потенциал коллектора одного транзистора уменьшается, а
другого увеличивается на одно и то же значение. На выходе ДУ появится разность
потенциалов, а следовательно, выходное напряжение ![]() .
.
Используя результаты анализа усилителя на транзисторе
с общим эмиттером, получим величину коэффициента усиления дифференциального
сигнала (симметричные вход и выход)
![]()
В идеальных ДУ за счет подавления синфазного сигнала
дрейф нуля не существует. Синфазными сигналами являются всякого рода
температурные изменения, помехи и наводки. В реальных ДУ абсолютная симметрия
плеч ДУ невозможна, поэтому дрейф нуля существует, но он очень незначителен.
При дифференциальном входе, то есть при симметричном входе, входное
сопротивление ДУ будет равно сумме входных сопротивлений левой и правой части
схемы ![]() , поскольку указанные сопротивления включены по отношению к
источнику сигнала последовательно. Таким образом
, поскольку указанные сопротивления включены по отношению к
источнику сигнала последовательно. Таким образом ![]() , где
, где ![]() - входное сопротивление транзистора, включенного по схеме с
ОЭ. Величина
- входное сопротивление транзистора, включенного по схеме с
ОЭ. Величина ![]() зависит от тока покоя
зависит от тока покоя ![]() IБ транзистора. Поэтому для увеличения входного
сопротивления следует использовать усилитель в режиме малых токов.
IБ транзистора. Поэтому для увеличения входного
сопротивления следует использовать усилитель в режиме малых токов.
Коэффициент усиления дифференциального усилителя
зависит от способа подключения генератора входного сигнала и снятия выходного
сигнала.
Коэффициент усиления ДУ один и тот же, как при симметричном,
так и несимметричном входе.
При несимметричном выходе сопротивление нагрузки
подключается одним концом к коллектору одного транзистора, а другим – к общей
шине. В этом случае КU
оказывается в 2 раза меньше, чем при симметричном выходе.
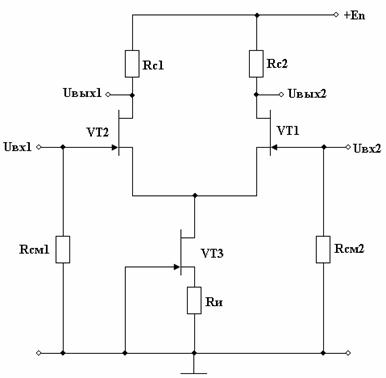
Рис. 8.9
Пусть сопротивления нагрузки включено между выходом 2
и общей шиной. Если входной сигнал подать на вход 1, то выходной сигнал по фазе
совпадает с входным сигналом. В этом случае входу 1 присваивается название
«неинвертирующий» вход. Если входной сигнал подать на вход 2, то фаза выходного
и входного сигналов противоположны и вход 2 называют «инвертирующим».
Входное сопротивление дифференциального усилителя
может быть существенно увеличено при использовании полевых транзисторов,
имеющих малые входные токи. При этом предпочтение отдается полевым транзисторам
с управляющим р–n- переходом. Схема ДУ на транзисторах с управляющим р
– n- переходом и
каналом n – типа приведена на рис. 8.9.
Генератор стабильного тока выполнен на VT3 и RИ. Резисторы RСМ1 и RСМ2
предназначены для задания начального
смещения на затворах транзисторов VT1 и
VT2.
8.7.
Операционные усилители
Общие сведения. Операционным усилителем (ОУ) является усилитель постоянного тока с
большим коэффициентом усиления по напряжению (104÷106),
высоким входным (104¸107 Ом) и низким выходным (0,1÷1
кОм) сопротивлениями. ОУ имеет два входа и один выход. В зависимости от
полярности сигналов на выходе и входе один из входов называется инвертирующим
(отмечается знаком «-»), а другой - неинвертирующим
(отмечается знаком «+»).
Условное обозначение ОУ показано на рис. 8.10 а, б.
Питание осуществляется от двух источников, напряжение которых одинаковы, но
знаки относительно заземленной точки разные. Этим обеспечивается нулевой
потенциал на выходе в отсутствии входного сигнала и возможность получить выходной
сигнал как положительной, так и отрицательной полярности. В реальных ОУ
напряжение питания лежит в диапазоне ±3 В ÷ ±18 В. Сигнал можно подавать
от симметричного источника сигнала, соединенного с общей шиной, на вход 1 и
вход 2, либо от двух отдельных источников, один из которых подключают к
инвертирующему входу и общей шине, другой – к
неинвертирующему и общей шиной.

а)
б)
Рис. 8.10
ОУ практически всегда охвачен цепями обратной связи. В
зависимости от вида цепи обратной связи ОУ может выполнять различные операции
над аналоговыми сигналами. К таким операциям относятся суммирование,
интегрирование, дифференцирование, сравнение, логарифмирование и др., отсюда
произошло название этих усилителей – операционные.
ОУ является идеальным усилительным элементом и
составляет основу всей аналоговой электроники. ОУ, имея достаточно сложную
структуру, выполняется на одном кристалле и выпускается в массовом количестве.
Поэтому ОУ можно рассматривать в качестве простейшего элемента электронных схем
подобно диоду, транзистору и т.п. В настоящее время номенклатура ОУ насчитывает
сотни наименований, выпускаются в малогабаритных корпусах и очень дешевы.
Для получения большого усиления ОУ строятся на основе
двух- или трехкаскадных усилителей постоянного тока.
На рис. 8.11
приведена структура трехкаскадного ОУ
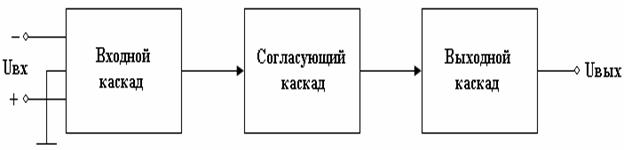
Рис. 8.11
В качестве входного каскада ОУ используется
дифференциальный усилительный каскад, что позволяет максимально уменьшить величину
дрейфа усилителя, получить достаточно высокое усиление. Им определяется высокое
входное сопротивление усилителя, чувствительность к синфазным сигналам и
напряжение сдвига. Промежуточные (согласующие) каскады обеспечивают необходимое
усиление и уменьшают напряжение сдвига на выходе дифференциального усилителя до
близкого к нулю значения. В промежуточных каскадах используются как
дифференциальные, так и однотактные каскады усиления. Выходной каскад должен
обеспечивать низкое выходное сопротивление ОУ и достаточную выходную мощность.
В качестве выходных каскадов обычно используется комплементарный эмиттерный
повторитель, работающий в режиме АВ (см. рис. 8.4).
Операционные усилители первого поколения, например
140УД1А, строились по трехкаскадной структурной схеме на транзисторах n–p-n. Первый усилительный каскад представляет классический
дифференциальный усилитель (см. рис. ДУ) с ГСТ в эмиттерной и резисторами в
коллекторной цепи. Второй каскад также построен по дифференциальной схеме, но
без использования ГСТ. Выходной каскад работает в режиме класса А, то
есть представляет собой эмиттерный повторитель. Основной недостаток данных
операционных усилителей заключается в относительно небольшом коэффициенте
усиления (КU0=300÷4000) и низком входном сопротивлении (RВХ@4 кОм).
Указанные недостатки устранены в ОУ второго поколения,
которые строятся по двухкаскадной схеме. Улучшение характеристик достигнуто за счет
применения составных транзисторов, высокоомных резисторов и замены
резисторных нагрузок дифференциальных каскадов динамическими. В ряде случаев ОУ
второго поколения выполняются на полевых транзисторах, что позволяет значительно увеличить входное
сопротивление.
Типичным двухкаскадным ОУ является усилитель типа
140УД7. Коэффициент усиления этого ОУ составляет КU0=45000,
а RВХ=
400 кОм.
В справочной литературе КU0, RВХ и RВЫХ
приводятся для ОУ без цепей ООС. Выходную цепь ОУ представляют также такие
параметры, как максимальный выходной ток (IВЫХ,max £ 20 мА у
быстродействующих широкополосных ОУ и IВЫХ,max £ 500 мА у мощных ОУ) и минимальное сопротивление нагрузки (RH.min ³ 1 кОм).
Одними из важнейших характеристик ОУ являются его
амплитудные (передаточные) характеристики. Они представлены на рис. 8.12.
Рабочим участком является наклонный (линейный)
участок характеристик, угол наклона которого определяется значением КU0. UВЫХ,max – максимальное выходное напряжение, которое обычно
ненамного меньше напряжения питания ЕП.
Частотные свойства ОУ представляются его АЧХ, при
построении которой КU0
приводится в дБ, а частота откладывается по горизонтальной оси в
логарифмическом масштабе.

Рис.
8.12
Такую АЧХ ОУ принято называть логарифмической
амплитудно – частотной характеристикой (ЛАЧХ). На рис.8.13 приведена типовая
ЛАЧХ для быстродействующего ОУ К140УД10. При частотах меньше fВ
коэффициент усиления равен 20 lg КU0, то
есть ЛАЧХ представляет собой прямую линию, параллельную оси частот. С
повышением входного сигнала КU0
начнет уменьшаться и при частоте f1 коэффициент усиления
равен единице.

Рис. 8.13
Основные схемы включения ОУ. ОУ почти всегда охвачен глубокой отрицательной
обратной связью в виде линейных и нелинейных цепей. Свойства ООС позволяют
создавать на основе ОУ различные аналоговые и импульсные электронные
устройства.
Для уяснения принципов действия таких схем и
приближенного их анализа вводится понятие идеального операционного усилителя.
Идеальный ОУ имеет следующие свойства:
а) бесконечно большой дифференциальный коэффициент
усиления по напряжению КU0;
б) нулевое напряжение смещения нуля UСМ, то есть при равенстве входных напряжений выходное
напряжение равно нулю; следовательно, потенциалы входов ОУ всегда равны;
в) нулевые входные токи;
г) нулевое выходное сопротивление;
д) коэффициент усиления синфазного сигнала равен нулю.
Дифференциальное включение ОУ. На рис. 8.14 приведена схема дифференциального
включения ОУ. По правилу Кирхгофа ![]() . Вследствие свойства в)
. Вследствие свойства в) ![]() , то
, то ![]() .
.
 ;
;  ;
;
 ;
; ![]()
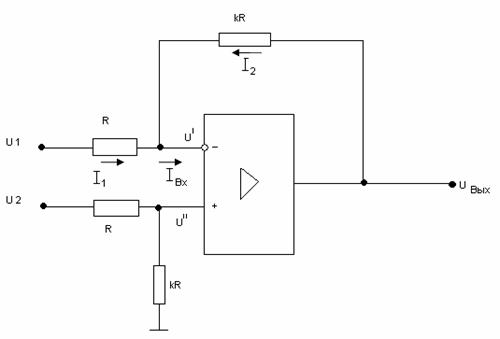
Рис. 8.14
Вследствие свойства б) ![]() . Отсюда
. Отсюда ![]() .
.
Таким образом, при дифференциальном включении ОУ это
устройство является вычитателем – усилителем.
Инвертирующее включение ОУ. При инвертирующем включении неинвертирующий вход ОУ
соединяется с общей шиной (рис. 8.15). вследствие свойства в) ![]() . Потенциал входов равен нулю, следовательно
. Потенциал входов равен нулю, следовательно
 ;
;  ;
; 
Для реального ОУ использование этой формулы приводит к
появлению погрешностей в расчете коэффициента усиления. Чем больше в ОУ КU0 и RВХ0,
тем меньшую погрешность дает использование этой формулы. Так, при КU0=103,
R1=1
кОм, R2=100
кОм и RВХ0=10 кОм погрешность в определении К составит
примерно 9 %, а при КU0=105 (остальные параметры те же) – меньше
0,1 %.
Выходное напряжение усилителя находится в противофазе
к входному. Коэффициент усиления по напряжению этой схемы в зависимости от
соотношения сопротивлений резисторов может быть как больше, так и меньше
единицы и совершенно стабилен.
Неинвертирующее включение УО. При неинвертирующем включении входной сигнал подается на неинвертирующий
вход ОУ, а на
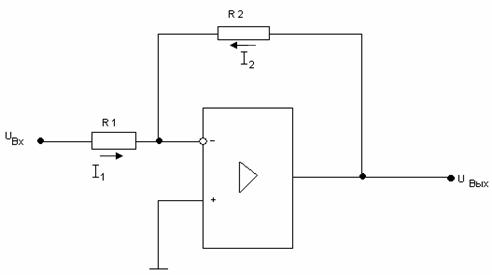
Рис. 8.15
инвертирующий
вход через делитель на резисторах R1 и R2 поступает сигнал
обратной связи с выхода усилителя (рис. 8.16).

Рис. 8.16
 ,
,  .
.
Откуда  , т.е.
, т.е.  .
.
Как видно, здесь выходной сигнал синфазен входному. В
предельном случае, если выход ОУ накоротко соединен с инвертирующим входом,
этот коэффициент равен единице. Такие схемы называют неинвертирующими
повторителями и изготавливают серийно в виде отдельных интегральных микросхем,
содержащих по несколько усилителей в одном корпусе.
В повторителе реализуется максимальное входное и
минимальное выходное сопротивления для используемого типа ОУ. Повторитель на
ОУ, как и любой другой повторитель (эмиттерный или истоковый), используется как
согласующий каскад.
Контрольные
вопросы
1. Чем
отличаются выходные каскады, построенные на простейшем и
комплементарном эмиттерных повторителях ?
2.
Приведите определения усилителей постоянного тока, широкополосных и
избирательных усилителей.
3. Какими
параметрами оцениваются частотные свойства усилителей ?
4. Что
такое дрейф усилителя, чем он вызывается
?
5. Для чего
служат схемы сдвига уровней напряжения в усилительных
каскадах ?
6. Что
такое дифференциальный усилитель ?
7. Для чего
в схему дифференциального усилителя вводится генератор
стабильного тока ?
8. Какие
напряжения являются синфазными ?
9.Каким
входом ДУ присваивают названия «инвертирующий»
и «неинвертирующий» ?
10. Для
чего в ДУ применяется двухполярный источник питания ?
11. Что
называется ОУ ?
12. Каковы
основные функциональные узлы ОУ ?
13. Дайте
определение идеального ОУ.
14.
Приведите три схемы включения ОУ.
ГЛАВА IX. СХЕМОТЕХНИКА
ПОЛУПРОВОДНИКОВЫХ
ЦИФРОВЫХ
ИНТЕГРАЛЬНЫХ
МИКРОСХЕМ
════════════════════════════════════════════
9.1. Основы
цифровой техники
В современной вычислительной технике решающую роль
играют цифровые методы обработки информации. Цифровые полупроводниковые ИМС
являются элементной базой устройств и систем вычислительной техники. Исходные
данные, результаты и другая информация, перерабатываемая вычислительными
машинами, представляется в них в виде электрических сигналов, принимающих
только два значения (двоичная система счисления).
Для перевода аналоговой информации в цифровую форму ее
квантуют,
то есть непрерывный сигнал заменяют его дискретными значениями в отдельных
точках. Затем конечному числу дискретных значений исходного сигнала ставится в соответствие
некоторое число. Процесс замены дискретных уровней сигнала последовательностью
чисел носит называется кодированием, а совокупность
полученных чисел - кодом сигнала.
В двоичном счислении любое число можно представить
двумя цифрами: 0 и 1. Для представления этих чисел в цифровых системах
достаточно иметь электронные схемы, которые могут принимать два состояния,
четко различающиеся значением какой–либо электрической величины – напряжения
или тока. Одному из значений этой величины соответствует цифра 0, другому - 1.
Относительная простота создания электрических схем с двумя электрическими
состояниями и привела к тому, что современная цифровая техника построена на
двоичном представлении чисел.
Для описания алгоритмов работы цифровых устройств
применяется булева алгебра или алгебра логики. В рамках алгебры логики входным,
выходным и внутренним узлам цифровой схемы ставятся в соответствие булевы
переменные, которые могут принимать только два значения:
Х=0 если Х ¹ 1; Х=1 если Х ¹ 0.
Основными операциями булевой алгебры являются операции
логического сложения, умножения и отрицания.
Логическое сложение. Эту операцию называют операцией ИЛИ или дизъюнкцией.
Постулаты логического сложения двух переменных приведены в таблице 9.1.
Такие таблицы называют таблицами истинности. Следует отметить, что данная операция
справедлива для произвольного числа переменных. Число переменных, над которыми
выполняется операция, обозначается цифрой, стоящей перед ее обозначением.
Следовательно, таблица 9.1 определяет операцию 2ИЛИ. Условное обозначение элемента
(электронная схема), выполняющего логическую операцию ИЛИ, приведено на рис.
9.1 а.
Таблица 9.1
|
Х1 |
Х2 |
Y=Х1+Х2 |
|
0 |
0 |
0 |
|
0 |
1 |
1 |
|
1 |
0 |
1 |
|
1 |
1 |
1 |
Логическое умножение. Эту операцию называют операцией И или конъюнкцией.
Постулаты логического умножения приведены в таблица 9.2. Условное обозначение
логического элемента, выполняющего логическую операцию И, приведено на рис. 9.2
б.
Таблица 9.2
|
Х1 |
Х2 |
Y=Х1×Х2 |
|
0 |
0 |
0 |
|
0 |
1 |
0 |
|
1 |
0 |
0 |
|
1 |
1 |
1 |
Логическое отрицание. Операцию отрицания называют инверсией или дополнением.
Постулаты инверсии приведены в таблице 9.3. Условное обозначение логического
элемента, выполняющего операцию инверсии, приведено на рис. 9.1 в.
Таблица 9.3
|
Х |
Y |
|
0 |
1 |
|
1 |
0 |

а) б) в)
Рис. 9.1
Используя набор логических элементов, выполняющих
элементарные логические операции И, ИЛИ, НЕ, можно реализовать более сложные
логические операции и соответствующие им электронные схемы.
Элементы, реализующие различные функции, выпускаются в
виде ИМС. Логические ИМС объединяют в серии. В основе каждой серии лежит
базовый элемент, представляющий собой электрическую схему, выполняющую
логические операции И-НЕ (элемент Шеффера) или ИЛИ-НЕ (элемент Пирса). Эти
элементы более предпочтительны, так как при создании ЦИС, реализующих сложные
логические функции, требуется только один базовый логический элемент И-НЕ, либо
ИЛИ-НЕ.
9.2. Параметры
логических ИМС
По способу кодирования информации различают потенциальные
и импульсные логические элементы.
Большинство базовых логических элементов являются
потенциальными, то есть двоичная информация в них представляется в виде двух
уровней электрического потенциала: логический 0 - низким потенциалом U0, логическая 1
– высоким потенциалом U1. В импульсных логических элементах логической единице
отвечает наличие импульса, а логическому нулю – его отсутствие.
Потенциальные логические элементы ИМС характеризуются
следующими параметрами:
- напряжениями
логических «0» и «1» U0 и U1;
- пороговыми напряжением UПОР – напряжение на входе, при котором состояние микросхемы изменяется на
противоположное;
- коэффициентом объединения по входу m (числом входов);
- коэффициентом разветвления по выходу n (нагрузочная способность или количество аналогичных
микросхем, которые можно подключить к выходу данной ИМС);
- входными токами I0ВХ и I1ВХ
соответственно при UВХ= U0 и UВХ= U1;
- помехоустойчивостью –максимально допустимое
напряжение помехи по высокому U1ПОМ и
низкому U0ПОМ уровню входного напряжения;
- мощностью Р, потребляемой от источника
питания;
- напряжением ЕП и током IП питания;
- временами задержки переключения из состояния «0» в состояние «1» и, наоборот;
- средним временем задержки переключения
(быстродействие), равным 0,5×(t0З + t1З).
Основной элементной базой современных статических
цифровых систем являются элементы транзисторно – транзисторной логики (ТТЛ),
включая элементы с диодами Шоттки, интегральной инжекционной логики (И2Л),
эмиттерно – связанной логики на переключателях тока (ЭСЛ), МДП – транзисторной
логики (МДПТЛ – на р– или на n –
канальных МДП – транзисторах, КМДПТЛ – на комплементарных МДП - транзисторах).
Основные требования к элементной базе цифровых
интегральных микросхем - это их высокое быстродействие, малая мощность рассеяния,
большая плотность упаковки (количество элементов на единице площади кристалла)
и технологичность процесса изготовления.
Любая из вышеперечисленных элементных баз, превосходя
остальные по одному или нескольким параметрам, проигрывает им по другим параметрам.
Основой базового логического элемента ИМС может
служить один из типов электронных ключей, используемых в качестве
переключателей. Общие требования, предъявляемые к полупроводниковым приборам,
применяемым в качестве переключателей, следующие: коэффициент усиления, больший
единицы; однонаправленность передачи информации; большие коэффициенты
разветвления по входу и выходу; высокая скорость переключения; малая
потребляемая мощность. В качестве электронных ключей применяются кремниевые
биполярные и полевые транзисторы. Ключи на полевых транзисторах меньше
рассеивает мощность, в то же время применение биполярных транзисторов в
качестве электрических ключей позволяет повысить их быстродействие.
9.3. Ключи на биполярных транзисторах
Простейшая схема ключа на БТ представлена на рис. 9.2.
Нагрузочный резистор RК
включен в коллекторную цепь транзистора с заземленным (общим) эмиттером. Ключ
должен иметь два устойчивых состояния: открытое и закрытое.
Открытому состоянию ключа соответствует режим
насыщения или активный режим транзистора, а закрытому – режим отсечки.
Если на базу транзистора подать отрицательное
напряжение (UВХ<0В), то эмиттерный и коллекторные переходы окажутся
включенными в обратном направлении, то есть окажутся закрытыми. В этом случае транзистор работает
в режиме отсечки коллекторного тока и ключ разомкнут. Токи транзистора в режиме
отсечки соответственно равны
![]() ,
, ![]() ,
, ![]() . (9.1)
. (9.1)
В результате напряжение на коллекторе транзистора
![]() , (логическая единица U1) (9.2),
, (логическая единица U1) (9.2),
что соответствует отключению нагрузки от источника
питания (ключ разомкнут).
При наличии в цепи базы резистора RБ напряжение на базе транзистора
![]() (9.3)
(9.3)
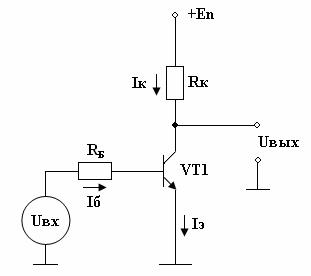
Рис. 9.2
При работе ключа в области высоких температур резко
возрастает значение IК0 и соответственно напряжение на эмиттерном переходе.
Поэтому для обеспечения нормальной работы транзистора в режиме отсечки
необходимо выполнение следующего условия
![]() (9.4),
(9.4),
где UПОР – положительное напряжение UБЭ на
эмиттерном переходе, при превышении которого транзистор переходит из режима
отсечки в активный режим, то есть откроется.
Для кремниевых транзисторов, выполненных по
интегральной технологии UПОР=0,5¸0,6 В.
Если UВХ=0, то условие (9.4) перепишется как
![]() . (9.5)
. (9.5)
Полагая UПОР=0,6 В и IК0=1мкА получим, что RБ.max=0,6
МОм.
При подаче на вход UВХ³0,7 В (логическая единица U1) транзистор работает в активном режиме или режиме
насыщения (ключ замкнут).
Активный режим работы транзистора в схеме ключа
нежелателен, так как ток нагрузки определяется не только нагрузкой RК и
напряжением источника питания ЕП,
но и падением напряжения UКЭ на транзисторе
 , (9.6)
, (9.6)
то есть зависит от свойств транзистора (разброса
параметров и их температурной зависимости). Кроме того, в активном режиме на
транзисторе рассеивается дополнительная мощность ![]() , снижающая КПД схемы.
, снижающая КПД схемы.
В режиме насыщения для кремниевых транзисторов, выполненных по интегральной
технологии UВЫХ=UКЭ@0,25 В (логический ноль U0). Отдельные ключи используются главным образом в
аналоговых схемах. В цифровых схемах используются ключевые цепочки. В таких
цепочках каждым ключом управляет предыдущий, и сам он, в свою очередь,
управляет последующим. Следовательно, если в предыдущем ключе транзистор
находится в режиме насыщения, то он не сможет переключить последующий ключ.
Таким образом, если на вход ключа подать потенциал
логического нуля, то на его выходе потенциал логической единицы, и наоборот, то
есть такой ключ является инвертирующей схемой и его называют инвертором.
Одной из важнейших динамических характеристик является
быстродействие
схемы, определяемое переходными процессами при включении и выключении.
Пороговое значение напряжения на выходе схемы достигается позднее, чем на входе
на интервал времени t1З при
изменение входного уровня от U0 до U1 и на
t0З при
изменении входного уровня от U1 до U0. Причинами задержек является инерционность перезаряда
емкостей транзисторов и нагрузки. Быстродействие схемы определяется по среднему
времени задержки
![]() .
.
Скорость переключения возрастает при увеличении токов,
потребляемой схемой, из – за большей скорости перезаряда емкостей. Но при этом
повышается потребляемая схемой мощность. Поэтому мощность и среднее время
задержки оценивают с помощью параметра, называемого работой переключения AП=РtЗ. Для современных ИМС АП=10-12-10-14 Дж.
9.4. Ключи на полевых транзисторах
В качестве ключевых элементов используются обычно МДП–
транзисторы с индуцированным каналом, которые при нулевом напряжении UЗИ
обеспечивают разомкнутое состояние ключа (транзистор закрыт).
В основе базовых логических элементов на полевых
транзисторах лежит ключ, в котором активный элемент и нагрузка представляют
собой МДП–транзисторы. Активный и нагрузочный транзисторы могут иметь каналы
одного и разного типа проводимости. При подаче на затвор активного транзистора
высокого потенциала (уровень логической единицы) остаточное напряжение на его
стоке составляет 50-100 мВ (уровень логического нуля). Тем самым реализуется
инверсия.
Ключ на однотипных МДП – транзисторах. На рис. 9.3 приведена схема ключа на МДП–транзисторах
с индуцированными каналами n– типа.
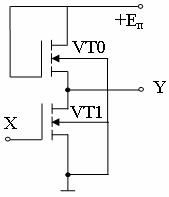
Рис. 9.3
Роль нелинейной нагрузки играет транзистор VT0. Подложка последовательно соединенных транзисторов
закарачиваются на корпус, а затвор и сток нагрузочного транзистора соединены с
источником питания. ЕП
выбирается примерно 3UПОР,
где UПОР – напряжение, при котором транзистор открыт.
Следовательно, верхний транзистор всегда открыт, находится в режиме насыщения и
служит для ограничения тока инвертора (динамическая нагрузка). Величина тока
стока VT0 определяется формулой
 (9.7)
(9.7)
Если на вход ключа Х подано напряжение U0ВХ< UПОР (логический ноль), то транзистор VT1 заперт,
через ключ протекает ток 10-9-10-10 А, а напряжение на
выходе ![]() близко к напряжению
питания: UВЫХ@Еп (логическая единица).
близко к напряжению
питания: UВЫХ@Еп (логическая единица).
Если на вход ключа подано напряжение U1ВХ³UПОР,
то транзистор VT1 открывается и переходит в режим насыщения, при
котором ток стока IС1 определяется той же формулой (9.7), если положить UСИ0=ЕП
 . (9.8)
. (9.8)
Сопротивление канала VT1 в режиме насыщения равно
 .
.
Умножая ток IС1 на сопротивление канала R, получим, что выходное напряжение
 (9.9) .
(9.9) .
Поскольку на практике U1ВХ@ЕП. Из (9.9) видно, что для обеспечения малого значения UВЫХ в
ключе должно выполняться соотношение В0<<В1. величина В
определяется отношением ширины к длине канала Z/L.
Ключ имеет низкое быстродействие, так как фронт
выходного импульса определяется не параметрами транзистора, а зарядом выходной емкости
через нелинейное сопротивление нагрузочного транзистора, которое достигает
сотен кОм.
Ключ на комплементарных МДП–транзисторах. Недостатком ключа на однотипных МДП–транзисторах
является тот факт, что во включенном состоянии управляющего транзистора через
ключ протекает ток, который не является принципиально необходимым, так как
установившийся входной ток полевого транзистора практически равен нулю. От
указанного недостатка свободен ключ, выполненный на комплементарных
МДП–транзисторах, то есть на транзисторах с каналами противоположного типа
проводимости (рис. 9.4).
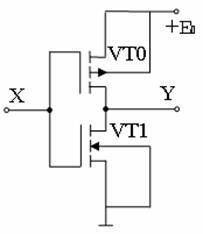
Рис. 9.4
В этом ключе затворы обоих транзисторов соединены
между собой и образуют входной вывод. Стоки, объединенные вместе образуют
выходной вывод, а истоки совместно с подложкой подключены соответственно к
источнику +ЕП и общей
шине.
Оба транзистора управляются одним и тем же входным
сигналом. Однако, поскольку пороговые напряжения UПОР этих транзисторов имеют различные знаки, состояния
этих транзисторов при любом из уровней входного сигнала будут противоположными.
Когда открыт один транзистор, закрыт другой. Действительно, если на входе Х=U0ВХ, то затвор транзистора VT0 будет иметь отрицательный потенциал относительно его
подложки, равный U0ВХ-ЕП=-ЕП. Следовательно, транзистор VT0 будет
открыт. В то же время потенциал затвора транзистора VT1 относительно его подложки будет меньше порогового
напряжения и этот транзистор будет закрыт. Если Х=U1ВХ, то транзистор VT1 откроется, а транзистор VT0 закроется, поскольку теперь напряжение на его
затворе относительно подложки будет равно
![]() .
.
Таким образом, в любом стационарном состоянии схемы
один из транзисторов закрыт, поэтому схема практически не потребляет мощности
от источника питания. Однако в процессе переключения схемы в течение какого–то
времени оба транзистора открыты, т.к. второй еще не успевает закрыться.
Потребляемая мощность ключа на комплементарных транзисторах в десять раз меньше
мощности, потребляемой ключом на
однородных МДП–транзисторах. Однако быстродействие схем одинаково и
определяется временем перезаряда выходной емкости ключа, одинаковой для обоих
типов ключей.
9.5. Базовые элементы логических интегральных схем
По принципу построения базовые элементы в виде
логических ИМС подразделяются на следующие группы: диодно – транзисторные
логические элементы (ДТЛ); (ТТЛ); (ЭСЛ); элементы на МДП– транзисторах; (И2Л).
Тип электронных ключей определяет тип логики.
Если ключ содержит помимо транзисторов другие
электрорадиоэлементы (резистор, диод), то это снижает уровень интеграции и
поэтому эти типы логики не используются в качестве базовых элементов в ЦИС
средней и большой интеграции. Ниже рассматриваются базовые элементы,
используемые в современных цифровых интегральных устройствах.
Элементы транзисторно – транзисторной логики (ТТЛ). В этом типе логики используется инвертор на
многоэмиттерном транзисторе (МЭТ), управляемого электронными ключами. Схема ТТЛ
с простым инвертором на выходе показана на рис. 9.5 а.
Положим, что на входе Х1 и Х2 имеется потенциал
логической единицы (2,4 В). Тогда эмиттерные переходы МЭТ закрыты и ток по
цепи: источник ЕП –
резистор R1- открытый коллекторный переход МЭТ направляется в
базу транзистора VT1, из – за чего VT1 переходит в режим насыщения и на его коллекторе
устанавливается низкий потенциал логического нуля (0,4 В).

Рис. 9.5
Теперь предположим, что на оба входа поданы низкие
уровни напряжения (потенциал логического нуля). В этом случае эмиттерные
переходы МЭТ будут смещены в прямом направлении, как и коллекторный переход.
МЭТ перейдет в режим насыщения. Ток базы транзистора МЭТ возрастет, а ток
коллектора этого транзистора, а значит, ток базы VT1 существенно уменьшится. Ток в транзисторе МЭТ
протекает теперь в основном по следующему пути:
источник питания ЕП-
резистор R1- база – эмиттеры МЭТ – источник сигналов на входах – общая шина. Так как ток базы
транзистора VT1 практически равен нулю, то этот транзистор
закрывается и на выходе схемы появляется высокий уровень напряжения (2,4 В)
(логическая единица).
Очевидно, что картина существенно не изменяется, если
логический 0 будет подан только на один вход. Следовательно, логическая 1 на
выходе будет иметь место, если имеется логический 0 хотя бы на одном из входов.
Логический 0 на выходе имеет место тогда и только тогда, когда на всех входах
имеет место логическая 1. Составив таблицу истинности, увидим, что элемент
выполняет операцию 2И-НЕ. Описанный элемент не нашел широкого применения из–за
низкой помехоустойчивости, малой нагрузочной способности и малого
быстродействия при работе на емкостную нагрузку СН (через большое сопротивление R2).
Улучшенными параметрами по сравнению с рассмотренной
схемой обладает базовый элемент ТТЛ со сложным инвертором (рис. 9. 5 б). Этот элемент состоит их трех
каскадов:
- входного многоэмиттерного транзистора МЭТ с
резистором R0, реализующих логическую операцию И;
- фазорасширителя на транзисторе VT1, с
резисторами R1 и R2;
- двухтактного выходного усилителя на транзисторах VT2 и VT3, резисторе
R3 и диоде VD.
Такая схема имеет значительно меньшее выходное
сопротивление, чем ускоряется перезаряд емкости нагрузки.
Как и в простейшей схеме для того, чтобы на выходе
схемы установился уровень U1, необходимо хотя бы на одном из эмиттеров МЭТ иметь
уровень логического нуля. При этом транзисторы VT1 и VT3 запираются, а VT2 открывается, так как на коллекторе VT1
напряжение будет высоким.
Емкость нагрузки СН
заряжается через транзистор VT2 и диод VD. Резистор R3 ограничивает ток через транзистор VT2, защищая
его от перегрузок.
При подаче на все эмиттеры МЭТ уровней U1
транзисторы VT1 и VT3 насыщены, транзистор VT2 практически закрыт. Емкость нагрузки СН быстро разряжается через
насыщенный транзистор VT3. Дальнейшее повышение быстродействия схемы ТТЛ связано
с использованием в ней диода и транзисторов Шоттки. Эта модификация
обозначается ТТЛШ.
Элемент эмиттерно–связанной логики (ЭСЛ). Элемент ЭСЛ (рис. 9.6) выполняется на основе
переключателя тока, напоминающего ДК. При двух логических входах одно плечо состоит
из двух транзисторов (VT1 и VT2), другое – из транзистора VT3.
Для повышения нагрузочной способности и уменьшения
задержки распространения сигнала переключатель дополнен эмиттерным повторителем
на транзисторе VT4. На базе VT3 опорное напряжение – Е0,
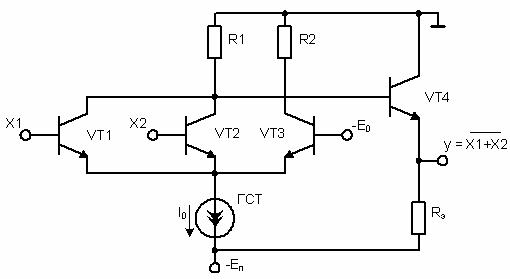
Рис. 9.6
обеспечивающее его открытое состояние. При подаче на
любой вход (или на оба входа одновременно) сигнала логической единицы
соответствующий транзистор отпирается, что приводит к переключению тока I0 из
правого плеча схемы в левое плечо. Ток базы VT4 уменьшится, транзистор VT4 закроется и на выходе установится потенциал
логического нуля. Если на оба входа поступают уровни логического нуля, то
транзисторы VT1 и VT2 закроются, а VT3 открывается. Ток протекающий через резистор R1 открывает транзистор
VT4 и
на выходе схемы появляется напряжение логической единицы. Схема выполняет
операцию 2ИЛИ-НЕ. Потребляемая мощность 20¸50 мВт, а быстродействие составляет 0,7¸3 нс.
Элемент на однотипных МДП транзисторах (n–МДП).
На рис. 9.7 показана схема с МДП–транзисторами с индуцированным n – каналом.
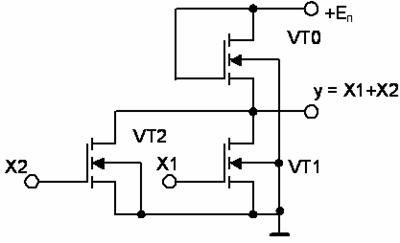
Рис. 9.7
Нагрузочный транзистор VT0 всегда открыт. Для обеспечения малого значения
низкого уровня напряжения U0ВЫХ сопротивления каналов открытых VT1 и VT2 должны
быть меньше сопротивления канала VT0. Поэтому VT1 и VT2 изготавливаются с коротким и широким каналом,
нагрузочный – с длинным и узким. При подаче на один или оба входа
положительного потенциала, соответствующего уровню логической единицы, (U1ВЫХ>UПОР), один или оба транзистора открываются и на выходе
устанавливается логический ноль (U0ВЫХ<UПОР).
Если на обоих входах логический ноль, то транзисторы VT1 и VT2 закрыты.
Потенциал на выходе соответствует уровню логической единицы. Элемент выполняет
операцию 2ИЛИ-НЕ. Потребляемая мощность 0,1¸1,5 мВт, а быстродействие 10¸100 нс.
В СБИС и БИС используются КМДП и И2Л
логические элементы. Они не содержат резисторов и работают в режимах
микротоков. Поэтому занимают на кристалле небольшую площадь и потребляют малую
мощность. В БИС при количестве элементов 105 мощность, потребляемая
одним элементом, не должна превышать 0,025 мВТ.
Элемент на комплементарных МДП–транзисторах (КМДПЛ). Двухвходовая схема элемента приведена на рис. 9.8.
При подаче на оба входа потенциала, соответствующего уровню логического нуля n– канальные
транзисторы VT1 и VT2 заперты, а р–канальные
транзисторы VT3 и VT4 открыты.
Ток через каналы закрытых транзисторов очень мал (<10-10А). Следовательно, ток от источника
питания практически не потребляется и на выходе схемы устанавливается
потенциал, близкий к ЕП
(уровень логической единицы). Если на один или оба входа подают уровень
логической единицы, то транзисторы или VT1 и VT2 откроются и на выходе элемента потенциал будет
близок к нулю. Элемент выполняет операцию 2ИЛИ-НЕ. Потребляемая мощность составляет
0,01¸0,05 мВт, а
быстродействие в пределах 10¸20 нс.
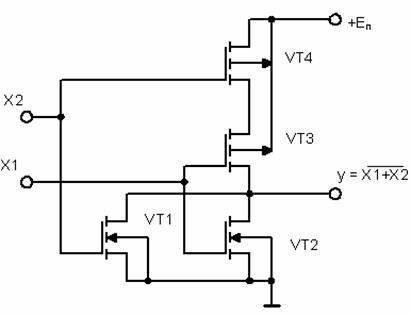
Рис. 9.8
Элемент интегрально–инжекционной логики (И2Л). Ключ состоит из комплементарной пары биполярных транзисторов–многоколлекторного
транзистора VT1 n-p-n типа, в базовую цепь которого включен
многоколлекторный транзистор (под названием инжектор) VT2 p-n-p
типа, играющего роль генератора
стабильного тока IП
(рис. 9.10 а).
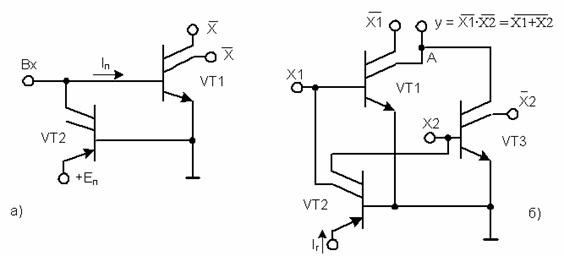
Рис. 9.10
Роль ключа играет промежуток эмиттер – коллектор
транзистора VT1. Источником сигнала и нагрузкой
элемента являются аналогичные схемы. Если на входе высокий потенциал,
соответствующий уровню логической единицы, то транзистор VT1 открыт и
находится в режиме насыщения. Потенциал на его выходе соответствует потенциалу
нуля. При подаче на вход потенциала логического нуля эмиттерный переход VT1 будет закрыт. Ток дырок IП (ток переключения) включит коллекторный переход VT1 в
обратном направлении. Вследствие этого выходное сопротивление VT1 резко
возрастет и на его выходе появляется потенциал логической единицы. То есть
данная схема, как и все предыдущие, являются инвертором. Логические операции
реализуются путем соединения выходов инверторов металлическими проводниками. На
рис. 9.10 б показана реализация
операции И.
Действительно, если высокий потенциал U1ВХ подан
хотя бы на один их входов Х1 или Х2, то в результате на соединенных
выводах (точка А) появится низкий потенциал U0. В результате выполняется конъюнкция инверсных
переменных ![]() и
и ![]() , которые образуются на выходах инверторов VT1 и VT3:
, которые образуются на выходах инверторов VT1 и VT3: ![]() . И2Л – элементы имеют быстродействие 10¸100 нс и потребляемую мощность 0,01¸0,1 мВт. Площадь, занимаемая одним И2Л –
элементом на кристалле в 3¸4 раза меньше чем КМДП – элементом и в 5¸10 раз меньше чем ТТЛ – элементом.
. И2Л – элементы имеют быстродействие 10¸100 нс и потребляемую мощность 0,01¸0,1 мВт. Площадь, занимаемая одним И2Л –
элементом на кристалле в 3¸4 раза меньше чем КМДП – элементом и в 5¸10 раз меньше чем ТТЛ – элементом.
Таблица основных параметров рассмотренных
базовых элементов логических ИМС
|
Параметр |
Тип базового элемента |
||
|
ТТЛ |
ТТЛШ |
n - МДП |
|
|
Напряжение питания, В |
5 |
5 |
5 |
|
Логический перепад сигнала (U1ВЫХ- U0ВЫХ), В |
4,5-0,4 |
4,5-0,4 |
Совместимы с ТТЛ |
|
Уровень допустимых помех, В |
0,8 |
0,5 |
0,5 |
|
Быстродействие, tЗ.СР, нс |
5-20 |
2-10 |
10-100 |
|
Потребляемая мощность, мВт |
2,5-3,5 |
2,5-3,5 |
0,1-1,5 |
|
Нагрузочная способность |
10 |
10 |
20 |
|
Параметр |
Тип базового элемента |
||
|
КМДП |
ЭСЛ |
И2Л |
|
|
Напряжение питания, В |
3-15 |
-5,2 |
1 |
|
Логический перепад сигнала (U1ВЫХ- U0ВЫХ), В |
ЕП-0 |
(-1,6)-(-0,7) |
0,5 |
|
Уровень допустимых помех, В |
0,4ЕП |
0,15 |
0,1 |
|
Быстродействие, tЗ.СР, нс |
1-100 |
0,7-3 |
10-20 |
|
Потребляемая мощность, мВт |
0,01-0,1 |
20-50 |
0,05 |
|
Нагрузочная способность |
50 |
20 |
5-10 |
Тип логики основных серий ЦИС
|
Тип логики |
Номер серии ЦИС |
|
ТТЛ |
155, 133, 134, 158 |
|
ТТЛШ |
130, 131, 389, 599, 533, 555, 734, К530, 531, 1531,
1533, КР1802, КР1804 |
|
ЭСЛ |
100, К500, 700, 1500, К1800, К1520 |
|
И2Л |
КР582, 583, 584 |
|
р - МДПТЛ |
К536, К1814 |
|
n - МДПТЛ |
К580, 581, 586, 1801, 587, 588, 1820, 1813 |
|
КМДПТЛ |
164, 764, 564, 765, 176, 561 |
Контрольные
вопросы
1. Назовите операции булевой алгебры. Как
они описываются с помощью
таблиц
истинности ?
2. Приведите условные графические
обозначения логических элементов
(ЛЭ)
И, ИЛИ, НЕ.
3. Что такое функционально полная система ?
4. Приведите классификацию логических
устройств по способу ввода –
вывода
переменных.
5. Какими параметрами характеризуются
базовые логические элементы?
6. Что характеризуют коэффициенты
объединения по входу и разветвления
по
выходу и каковы их типичные значения ?
7. Чем определяется зона помехоустойчивости
ЛЭ ?
8. Приведите схему базового элемента 3И-НЕ
ТТЛ и опишите
ее
функционирование.
9. Для чего в схемах ТТЛ используется
сложный выходной инвертор ?
10. Каково назначения диодов и транзисторов
Шоттки в схемах ТТЛШ?
11. Опишите функционирование схемы ЛЭ ЭСЛ.
12. Какие особенности характеризуют схемы на
базе МДП – транзисторов ?
13. Приведите схему ключа на однородных МДП
– транзисторах и опишите
ее
функционирование.
14. Приведите схемы логических элементов на
однородных МДП–
транзисторах,
реализующих операции 3И-НЕ и 3ИЛИ-НЕ и опишите
их
функционирование.
15. Приведите схему ключа на комплементарных
МДП – транзисторах.
16. Приведите схемы ЛЭ КМДП логики,
выполняющие операции 3И-НЕ и
3ИЛИ-НЕ.
17. В чем заключаются особенности ЛЭ И2Л
?
18. Приведите схему базового логического
элемента И2Л и ее технологию.
\\\\\ГЛАВА Х. ЛАБОРАТОРНЫЕ РАБОТЫ
════════════════════════════════════════════
Лабораторная работа № 1
Исследование характеристик и параметров
полупроводниковых диодов
Цель работы: исследовать основные характеристики и параметры
полупроводниковых диодов (ПД), влияние на них температуры окружающей среды.
1. Подготовка к лабораторной работе
1.1.
ПД - это
электронный прибор, представляющий собой контакт двух полупроводников с разным
типом проводимости - n и р, и обладающий односторонней проводимостью.
ВАХ ПД представлены на рис. 1.1. Здесь 1-теоретическая характеристика, 2-
характеристика реального прибора (она учитывает сопротивления объемов полупроводниковой
структуры ПД и сопротивления внешних контактов, влияние дополнительного
разогрева ПД мощностью, выделяемой в ПД при протекании через него тока, и
т.п.).
1.2.
Связь тока диода
с напряжением описывается уравнением:
 (1.1) UТ=26
мВ, при Т= 300 К.
(1.1) UТ=26
мВ, при Т= 300 К.

Рис. 1.1
Характеристики отражают основное свойство ПД. В открытом
состоянии через ПД протекает значительный прямой ток (iпр >мА);
это состояние обеспечивается подачей на ПД прямого напряжения uпр:

В закрытом состоянии через ПД протекает весьма незначительный
обратный ток iобр, величина которого у германиевых ПД имеет порядок 10-5
– 10-6А, а у кремниевых 10-9 – 10-12А.
Закрытое состояние ПД обеспечивается подачей на него обратного напряжении uобр:

Из рисунка 1.1 видно, что прямая ветвь ВАХ реального
ПД сдвинута относительно теоретической характеристики в область более высоких
прямых напряжений с резко выраженной величиной порогового напряжения, то есть
напряжения, при котором возникает заметный прямой ток. У германиевых ПД
величина ![]() 0,25 - 0,4 В, у
кремниевых ПД -
0,25 - 0,4 В, у
кремниевых ПД - ![]() 0,65 - 0,8 В.
0,65 - 0,8 В.
Влияние температуры окружающей среды на ВАХ ПД
иллюстрирует рисунок 1.2. При возрастании температуры увеличиваются прямой и
обратный токи.

Рис. 1.2.
Основным параметром ПД, учитывающим влияние
температуры, является:
Температурный коэффициент напряжения αt
 (1.2)
(1.2)
2.
Задание на выполнение лабораторной работы
2.1.
Перед выполнением лабораторной работы нужно ознакомиться со схемой (рис. 1.3),
методами измерений, используемыми измерительными приборами.

2.2
Снять прямую ветвь ВАХ ![]() ПД (рис. 1.1). Эксперимент
выполнить для двух ПД - германиевого и кремниевого.
ПД (рис. 1.1). Эксперимент
выполнить для двух ПД - германиевого и кремниевого.
Рекомендации для выполнения эксперимента
Прямой ток ![]() ПД очень сильно
зависит от напряжения (рис. 1.1), поэтому для ограничения тока
ПД очень сильно
зависит от напряжения (рис. 1.1), поэтому для ограничения тока ![]() последовательно с ПД
необходимо включить ограничительный резистор R=560 Ом. (рис. 1.3).
Практически ВАХ ПД
удобно снимать, устанавливая необходимую величину тока
последовательно с ПД
необходимо включить ограничительный резистор R=560 Ом. (рис. 1.3).
Практически ВАХ ПД
удобно снимать, устанавливая необходимую величину тока ![]() ПД и фиксируя
соответствующее этому току напряжение
ПД и фиксируя
соответствующее этому току напряжение ![]() .
.
При эксперименте зафиксировать величину порогового
напряжения ![]() (при
(при ![]() ).
).
Результаты измерений занести в таблицу протокола и
построить график полученной зависимости ![]() .
.
2.3 Снять обратную ветвь ВАХ ПД ![]() для германиевого ПД
(рис.1.1).
для германиевого ПД
(рис.1.1).
Рекомендации для выполнения эксперимента
Обратный ток ПД слабо зависит от ![]() (рис. 1.1), поэтому
целесообразно снимать обратную ветвь ВАХ, устанавливая напряжения
(рис. 1.1), поэтому
целесообразно снимать обратную ветвь ВАХ, устанавливая напряжения ![]() в интервале от 0 до
в интервале от 0 до ![]() и измеряя
соответствующие этим напряжениям значения тока. При этом следует иметь в виду,
что наиболее сильно ток изменяется в интервале от U=0 до
и измеряя
соответствующие этим напряжениям значения тока. При этом следует иметь в виду,
что наиболее сильно ток изменяется в интервале от U=0 до ![]() = -1В.
= -1В.
Результаты измерений занести в таблицу протокола и
построить график полученной зависимости ![]() .
.
3.
Обработка результатов измерений
3.1.
Обработка результатов измерений, выполненных в п. 2.2.
На графиках экспериментальных ВАХ германиевого и
кремниевого ПД построить соответствующие теоретические характеристики,
рассчитанные по формуле 1.1.
Величины теплового тока ![]() определите с помощью
формулы 1.1 в точке
определите с помощью
формулы 1.1 в точке ![]() ,
, ![]() , считая, что в данной
точке теорети-ческие и экспериментальные зависимости совпадают.
, считая, что в данной
точке теорети-ческие и экспериментальные зависимости совпадают.
Определить по экспериментальным ВАХ при ![]() =10 мА значения дифференциального сопротивления
=10 мА значения дифференциального сопротивления
![]() и сопротивления постоянному току
и сопротивления постоянному току ![]() для германиевого и кремниевого ПД.
для германиевого и кремниевого ПД.
3.2.
Обработка результатов измерений выполненных в п.2.3.
Пользуясь
экспериментальной ВАХ германиевого ПД
(п.2.3), определить при ![]() = 10 В дифференциальное сопротивление
= 10 В дифференциальное сопротивление  и сопротивление постоянному току
и сопротивление постоянному току  .
.
4.
Содержание отчета:
Отчет должен содержать:
- схемы измерений;
- таблицы и графики снятых зависимостей;
- результаты расчетов и построения;
- анализ результатов измерений и расчетов.
Лабораторная работа № 2
Исследование статических характеристик и
параметров
биполярных транзисторов
Цель работы:
исследовать основные статические характеристики и параметры биполярных
транзисторов, познакомиться с методикой измерения характеристик и обработкой
экспериментальных данных.
1.
Подготовка к лабораторной работе
Статическими характеристиками транзистора называются зависимость
установившихся значений тока (напряжения) на выходе транзистора от задаваемых
значений тока (напряжения) на входе. В схеме с общим эмиттером в качестве
независимых переменных выбирают ток базы
![]() и напряжение
коллектор-эмиттер
и напряжение
коллектор-эмиттер ![]() , тогда:
, тогда:
 (2.1)
(2.1)
В графической форме функции двух переменных изображают
в виде семейств характеристик.
Семейство входных характеристик БТ показано на рис. 2.1.
Каждая из характеристик представляет зависимость
![]() , при
, при ![]() (2.2)
(2.2)
(принято
по оси абсцисс откладывать ![]() , а по оси ординат iБ). Каждая из характеристик семейства
снимается при постоянном напряжении коллектор-эмиттер (на рис. 2.1
, а по оси ординат iБ). Каждая из характеристик семейства
снимается при постоянном напряжении коллектор-эмиттер (на рис. 2.1 ![]() ).
).
Семейство выходных характеристик
![]() , при
, при ![]() (2.3)
(2.3)
представлено
на рис. 2.2 ![]() .
.
Область левее пунктирной линии соответствует режиму
насыщения БТ, а правее - активному режиму.
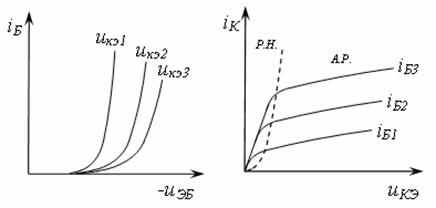
Рис. 2.1 Рис.
2.2
При работе с сигналами малой амплитуды
![]() нелинейные
зависимости (2.1–2.3) могут быть
представлены следующими уравнениями:
нелинейные
зависимости (2.1–2.3) могут быть
представлены следующими уравнениями:
 , (2.4)
, (2.4)
где  , при
, при ![]() - входное
сопротивление
- входное
сопротивление
транзистора;
 , при
, при ![]() - дифференциальный
- дифференциальный
коэффициент передачи тока;
(2.5)
 , при
, при ![]() - коэффициент обратной
- коэффициент обратной
связи по напряжению;
![]() , при
, при ![]() - выходная проводимость
- выходная проводимость
транзистора;
h- параметры
в соответствии с формулами (2.5) можно определить с помощью семейств
характеристик (h11 и h12 - по семейству входных, а
h21 и h22 - по семейству выходных характеристик).
2.
Задание на выполнение лабораторной работы
2.1.
Провести подготовку к эксперименту:
ознакомиться
со структурой и предельными параметрами транзистора, данные транзистора занести
в протокол; заготовить таблицы для измерений.
Таблица 2.1
Входные и управляющие
характеристики
|
ЕБ |
В |
|
|
UБЭ |
В |
|
|
iБ |
мкА |
|
|
iK |
мА |
|
Таблица 2.2
Выходные характеристики транзистора
|
iБ, мкА |
|
||
|
|
UКЭ |
В |
|
|
|
iK |
мА |
|
|
|
UКЭ |
В |
|
|
|
iK |
мА |
|
|
|
UКЭ |
В |
|
|
|
iK |
мА |
|
|
и
т.д. |
|
|
|
Собрать схему для измерений (рис. 2.3), схема цоколевки
транзистора представлена на рис. 2.4. Сопротивление резистора R1= (5–10) кOм.

Рис. 2.3.

Рис. 2.4.
2.2.
Снять входную и управляющие характеристики транзистора при постоянном напряжении ![]() . Результаты измерений и расчетов занести в табл. 2.1.
. Результаты измерений и расчетов занести в табл. 2.1.
2.3.
Снять семейство выходных характеристик:
- семейство
выходных характеристик снимать начиная от тока базы iБ =50мкА и далее с шагом 50 мкА. Ток коллектора при
этом не должен превышать допустимого значения;
- шаг
изменения напряжения Uкэ должен быть выбран так, чтобы в активном режиме снять
3-5 точек и в режиме насыщения - 2-3 точки.
3. Обработка результатов эксперимента:
3.1.
Построить на графиках входную и управляющую характеристики, а также семейство
выходных характеристик.
В точке Uкэ =5 В, iБ
=100мкА определить параметры транзистора
 ,
,  ,
, 
3.2. Построить выходную характеристику при токе
базы, равном 100 мкА.
4.
Содержание отчета:
Отчет должен содержать:
- схемы измерений;
- таблицы и графики снятых зависимостей;
- результаты расчетов.
Лабораторная работа № 3
Исследование полевого транзистора
с управляющим переходом
Цель работы:
изучить статические характеристики и дифференциальные параметры полевого
транзистора, исследовать влияние температуры на работу транзистора.
1.
Подготовка к лабораторной работе
В лабораторной работе исследуется полевой транзистор с
каналом р-типа, устройство которого и условное обозначение показаны на
рис. 3.1.

Рис. 3.1.
Управление током стока осуществляется путем подачи на
затвор, то есть на управляющий р-n-переход,
обратного напряжения UЗИ>0.
При увеличении запирающего напряжения UЗИ
увеличивается ширина области объемного заряда. Соответственно уменьшается
ширина канала, увеличивается его сопротивление RK, а следовательно, уменьшается ток стока IС при заданном напряжении
между стоком и истоком UСИ.
В качестве иллюстрации управляющая характеристика IC(UЗИ)
приведена на рис 3.2.
Напряжение на затворе, при котором области объемного
заряда управляющего р-n-перехода и р-n-перехода подложка-канал смыкаются, и ток стока IC
становится равным нулю, называется пороговым напряжением UПОР.

Рис. 3.2.
Управляющую характеристику полевого транзистора в
режиме насыщения удобно аппроксимировать зависимостью
 , (3.1)
, (3.1)
где
IC max - начальный ток стока, соответствующий UЗИ = 0.
По управляющей характеристике (рис. 3.2) может быть
рассчитана крутизна транзистора
 .
.
При использовании аппроксимации (3.1) выражение для
крутизны имеет вид
 , (3.2)
, (3.2)
Семейство выходных характеристик полевого транзистора
показано на рис. 3.3. Начальный
участок характеристики (UСИ<UСИ.НАС) соответствует
линейному режиму. В этом режиме канал существует на всем промежутке исток-сток,
поэтому ток стока  возрастает с ростом UСИ по закону, близкому к
линейному.
возрастает с ростом UСИ по закону, близкому к
линейному.
При |UСИ|>|UСИ.НАС| транзистор
переходит в режим насыщения, в котором ток стока IС слабо зависит
от напряжения на стоке UСИ.
Напряжение насыщения UСИ.НАС,
являющееся границей двух режимов, зависит от напряжения на затворе UЗИ и рассчитывается по
формуле: UСИ НАС =UЗИ–UПОР. По выходным характеристикам (рис.3.3) может быть
рассчитано выходное сопротивление
 (3.3)
(3.3)
Оно велико в режиме насыщения, поэтому при использовании
транзистора для целей усиления точка покоя схемы выбирается в этом режиме.
Выходное сопротивление транзистора в линейном режиме зависит от напряжения на
затворе UЗИ и приближенно
может быть рассчитано как отношение напряжения UСИ к току IС
в выбранной рабочей точке, или по формуле 3.3.

Рис. 3.3.
 , (3.3)
, (3.3)
где
 .
.
2.
Задание на выполнение работы
2.1.
Ознакомиться со схемой исследования (рис.3.4), измерительными приборами и паспортными данными
полевого транзистора КП103, исследуемого в работе (см.прил. П5).
Зарисовать цоколевку и записать в протокол предельно
допустимые параметры UСИ ДОП,
IС ДОП, PДОП исследуемого транзистора.
Собрать схему по рис. 3.4.
2.2.
Снять две управляющие характеристики транзистора при напряжениях на стоке UСИ=1/3UСИ
ДОП и 2/3UСИ ДОП (UСИ ДОП -допустимое
напряжение на стоке берется из паспортных данных). Результаты измерений
занести в табл.3.1 и по ним построить семейство
управляющих характеристик. В ходе эксперимента напряжение UЗИ следует изменять от 0 до порогового напряжения UПОР.

Рис. 3.4.
Таблица 3.1
|
UЗИ, В |
IС, мА |
|
|
UСИ=1/3UСИ ДОП |
UСИ=2/3UСИ ДОП |
|
|
|
|
|
2.3.
Снять семейство выходных характеристик IС=f(UСИ)
при трех значениях напряжения на затворе UЗИ=0;
0,25UПОР; 0,5UПОР.
До проведения эксперимента следует построить в системе
координат IС – UСИ область дозволенных режимов
работы транзистора (рис.3.5).
Пояснение:
Для построения линии РС ДОП произвольно выбирается несколько значений UСИ в пределах от 0 до UСИ ДОП и в этих точках
рассчитывается ток стока IС=PС ДОП/UСИ.
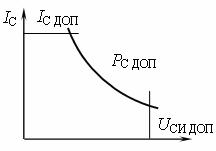
Рис. 3.5.
Экспериментальные точки заносить в табл.3.2 и сразу же
отмечать на заготовленном графике (рис.3.5). При этом необходимо следить,
чтобы не выйти за область дозволенных режимов работы транзистора.
Таблица 3.2
|
UСИ, В |
IС, мА |
||
|
UЗИ=0 |
UЗИ=0,25UПОР |
UЗИ=0,5UПОР |
|
|
|
|
|
|
2.4.
Исследовать влияние температуры на статические характеристики транзистора.
Поместив исследуемый транзистор в термостат и установив нужное значение
температуры, снять две управляющие характеристики IС=f(UЗИ) при напряжении на стоке UСИ=1/3UСИ ДОП и температуре Т=40° и 80°С.
Результаты измерений занести в табл.3.3 и по ним
построить две управлявшие характеристики IС=f(UЗИ)
при T=40° и 80 С.
Таблица 3.3
|
UЗИ, В |
IС, мА |
|
|
T=40° |
T=80° |
|
|
|
|
|
3.
Обработка результатов эксперимента.
3.1.
Управляющие характеристики, снятые в п.2.2, аппроксимировать выражением (3.1).
Результаты аппроксимации отразить на том же графике IС=f(UЗИ).
3.2.
Пользуясь управляющими характеристиками, определить крутизну транзистора  в следующей рабочей точке: UСИ=1/3UСИ
ДОП, UЗИ=0,5UПОР. Рассчитать S в этой же
точке по формуле (3.2).
в следующей рабочей точке: UСИ=1/3UСИ
ДОП, UЗИ=0,5UПОР. Рассчитать S в этой же
точке по формуле (3.2).
3.3.
На семействе выходных характеристик, снятых в п.2.3, укажите границу между
режимами линейным и насыщения, которая соответствует уравнению UСИ
НАС=UЗИ – UПОР.
3.4.
Пользуясь выходными характеристиками, определить выходное сопротивление
транзистора в следующих рабочих точках:
-
в режиме насыщения (UСИ=1/3UСИ ДОП, UЗИ=0,25 UПОР);
-
в линейном режиме при UСИ=0
и трех значениях UЗИ=0;
0,25UПОР; 0,5UПОР.
Результаты расчета занести в табл.3.4 и построить по
ним для линейного режима зависимость rВЫХ
от UЗИ.
Таблица 3.4
|
UЗИ,В |
rВЫХ, кОм |
|
|
UСИ=1/3UСИ ДОП |
UСИ=0 |
|
|
UЗИ=0 |
|
|
|
UЗИ=0,25UПОР |
|
|
|
UЗИ=0,5UПОР |
|
|
3.5.
На управляющих характеристиках, снятых в п.2.4, найти координаты IСТ и UЗИТ термостабильной точки, в которой пересекаются
управляющие характеристики, снятые при разных температурах.
4.
Содержание отчета.
Отчет должен содержать:
- справочные данные исследуемых транзисторов;
- схему исследования;
- таблицы и графики снятых зависимостей;
- результаты аппроксимации управляющих характеристик,
расчетов
крутизны S и выходного сопротивления
транзистора rВЫХ.
Лабораторная работа № 4
Исследование параметров операционных
усилителей
Цель работы: изучить методики измерения основных параметров операционных
усилителей.
1.
Подготовка к лабораторной работе
Операционный усилитель (ОУ) в интегральном исполнении
- это универсальная аналоговая микросхема, представляющая собой двухвходовый
дифференциальный широкополосный усилитель постоянного тока, на выходе которого
формируется сигнал, равный по величине усиленной разности входных сигналов.
Операционным он назван потому, что предназначен для
выполнения математических операций над входными сигналами при использовании его
в электрической схеме с цепью внешней обратной связи. При соответствующем
выборе элементов этой цепи ОУ может использоваться для сложения, вычитания,
перемножения, усреднения, интегрирования, дифференцирования, логарифмирования
и т.п. При этом точность выполнения указанных операций тем выше, чем больше
коэффициент усиления и входное сопротивление ОУ и чем меньше выходное
сопротивление.
Количество параметров, характеризующих ОУ, достигает
нескольких десятков.
К основным относятся:
- коэффициент
усиления ОУ без обратной связи КU, Обычное значение KU - несколько десятков-сотен тысяч;
- коэффициент
ослабления синфазных входных сигналов
- Кос.сф характеризует
способность ОУ ослаблять (т.е. не усиливать) сигналы, приложенные одновременно
к обоим входам. Как правило, Кос.сф
выражают в децибелах:

- входное
напряжение сдвига (смещения) - Uсм. Это величина напряжения,
которое необходимо подать на вход ОУ для того, чтобы напряжение на его выходе
стало бы равно нулю. Этот параметр характеризует неидеальность ОУ и обусловлен
неидентичностью транзисторов входного каскада. Типичное значение Uсм составляет доли
милливольт-десятки милливольт;
- входные токи
– Iвх. Это токи,
протекающие через входные выводы ОУ при нулевых входных напряжениях,
обусловленные базовыми токами входных биполярных транзисторов, либо токами
утечки затворов в случае использования полевых транзисторов во входном каскаде
ОУ. Типичные значения Iвх
- доли наноампер-десятки микроампер (10-10...10-15А);
- разность входных токов - Iвх может достигать 10...20%.
Она характеризует степень неидентичности транзисторов входного каскада ОУ;
- скорость нарастания выходного напряжения Uu.вых - отношение изменения Uвых от 10% до 90% от своего номинального значения ко
времени, за которое произошло это изменение. Параметр характеризует скорость
отклика ОУ на ступенчатое изменение входного сигнала;
- частота
единичного усиления - f1 - значение частоты входного сигнала,
при котором значение коэффициента усиления ОУ по напряжению падает до единицы.
Данный параметр определяет максимально реализуемую полосу усиления ОУ.
Условные графические обозначения ОУ и назначения
выводов приведены на рис.4.1 а, б.
Обратите внимание, что для питания ОУ используются два источника -Uп
и +Uп. Кроме того, следует иметь
в виду, что ОУ, не имеющие внутренней коррекции частотной характеристики, без
элементов внешней коррекции возбуждаются.

а) б)
Рис. 4.1.
1
- неинвертирующий вход ОУ;
2
- инвертирующий вход ОУ;
3,4
- выводы для подключения внешних элементов коррекции амплитудно-частотной
характеристики
5,6
- выводы для подключения внешних элементов балансировки;
7
- выход ОУ;
8 - вывод для подключения источника питания положительной
полярности;
9
- вывод для подключения источника питания отрицательной полярности;
10
- вывод для соединения с общей шиной (нулевой потенциал) схемы.
Расположение выводов, параметры и типовые схемы
коррекции ОУ, исследуемых в лабораторной работе, приведены в приложении. Следует
помнить, что на принципиальных схемах устройств на основе ОУ допускается не
указывать имеющиеся цепи питания и стандартные схемы коррекции.
2.
Задание на выполнение лабораторной работы
Пользуясь приложением, зарисовать условное обозначение
исследуемого ОУ (с указанием номеров выводов и элементов коррекции), выписать
значения предельных параметров.
2.1.
Определить предельное значение коэффициента усиления ОУ (KU).
Вследствие
значительной величины KU=104...106
его непосредственное измерение затруднительно. Поэтому это значение KU получают в результате расчета.
2.1.1.
Собрать схему согласно рис.4.2 (цоколевка ОУ приведена в приложении).
(Напомним, что схема частотной коррекции не показана, хотя и должна быть
собрана. В дальнейшем будут опущены и элементы питания Е3).

Рис. 4.2.
2.1.2.
Установить на выходе генератора (1) синусоидальный сигнал с амплитудой UГ=l В и частотой fГ=l0..20 Гц. При этом на
экране осциллографа 2 должен наблюдаться неискаженный сигнал (если наблюдаются
искажения, то необходимо уменьшить UГ).
2.1.З.
С помощью вольтметра (3) измерить переменные напряжения U1 (между точкой "A" и общим проводом) и UВЫХ, затем рассчитать KU по формуле:

2.2.
Определить напряжение смещения (Uсм)
и входной ток (Iвх)
операционного усилителя.
По причине малости этих величин непосредственное
измерение Uсм и Iвх затруднительно и поэтому
их значения определяют расчетным путем.
2.2.1.
Собрать схему согласно рис. 4.3 (на схеме источники питания и цепи коррекции
не показаны)
2.2.2.
Установить перемычку П1 (вместо резистора R1), соединяющую неинвертирующий вход
ОУ (на схеме со знаком "+") с общим проводом. Записать величину
постоянного напряжения UВЫХ1,
которое показывает вольтметр.

Рис. 4.3.
2.2.3.
Удалить перемычку П1 и установить между неинвертирующим входом ОУ и общим
проводом резистор R1. При этом показания вольтметра изменяются. Записать их,
обозначив UВЫХ2.
2.2.4.
Рассчитать (с учетом знаков UВЫХ1
и UВЫХ2) величины напряжения
смещения

и
входного тока Iвх ОУ

2. Содержание отчета.
3.
Отчет должен содержать:
- паспортные данные и схемы коррекции
исследуемого ОУ;
- схемы
измерений и значения измеренных параметров ОУ.
Лабораторная работа № 5
Исследование ключевых схем на полевых транзисторах
Цель работы: изучить особенности работы полевых транзисторов (ПТ)
в ключевых схемах. Изучить варианты использования ПТ в качестве нагрузочного
резистора.
1.
Подготовка к лабораторной работе
Для определения уровней логических сигналов используется
передаточная характеристика ключа Uвых=f(Uвх) рис.5.1.

Рис. 5.1.
Уровни логического нуля U0 и логической единицы U1 определяются пересечением передаточной характеристики
и ее зеркального отражения (пунктир).
Разность уровней UΛ = U1 – U0 называется размахом логических сигналов.
2.
Задание на выполнение лабораторной работы
2.1.
Исследовать влияние сопротивления нагрузки на передаточную Uвых=f(Uвх) характеристику ключа на ПТ.
Схема исследования ключа на МДП транзисторе с индуцированным
каналом n-типа приведена на рис.5.2.
Питание схемы осуществляется от источника Е2 и равно 9 В. Входное напряжение Uвх подается от регулируемого
источника питания Е1. Для измерения выходного напряжения Uвых и потребляемого тока используйте цифровые
вольтметры. В качестве VТ1 возьмите один из транзисторов с каналом n-типа микросхемы К176ЛП1. Для удобства
работы перенесите в протокол принципиальную схему микросхемы приведенную в
приложении и отметьте номера выводов.

Рис. 5.2 Рис. 5.3 Рис. 5.4
Рекомендуется следующий порядок эксперимента:
- подключить в цепь стока МДП транзистора линейный
резистор R1=51 кОм;
- установить напряжение источника питания Е2=9 В;
- изменяя входное напряжение от 0 до 9 В,снять
зависимости Uвых=f(Uвх) и Iпотр=f(Uвх);
- повторить измерения при двух значениях сопротивления
резистора R=10 кОм и 3,5 кОм;
по результатам эксперимента построить графики
зависимостей Uвых=f(Uвх)
2.2.
Исследовать передаточную характеристику ключа на n-МДП– транзисторах.
Схема исследования ключа на n–МДП-транзисторах
приведена на рис.5.2. В качестве транзисторов VТ1 и VТ2 взять любую
пару комплементарных транзисторов микросхемы К176ЛП1 или отдельную схему ключа.
Эксперимент провести аналогично п.2.1.
2.3.
Исследовать передаточную характеристику ключа на КМДП- транзисторах.
Схема исследования ключа на КМДП-транзисторах
приведена на рис.5.3. В качестве транзисторов VТ1 и VТ2 взять любую
пару комплементарных транзисторов микросхемы К176ЛП1 или отдельную схему ключа.
Эксперимент провести аналогично п.2.1.
3.
Обработка результатов эксперимента
3.1.
Построить передаточные характеристики полученные в п.2.
3.2.
Для каждого ключа определить уровни логических сигналов U0 и U1
и размах UΛ .
Полученные результаты свести в табл.5.1.
Таблица 5.1
|
Параметр Тип
нагрузки |
U0, В |
U1, В |
UΛ, В |
Pср, мВ |
|
С
резистивной нагрузкой |
|
|
|
|
|
Rн=51кОм |
|
|
|
|
|
Rн=10кОм |
|
|
|
|
|
Rн=3,5кОм |
|
|
|
|
3.3.
Рассчитать среднюю потребляемую от источника питания в состояниях логического
нуля и логической единицы мощность
 ;
; ![]() .
.
4. Содержание отчета.
Отчет должен содержать:
- схемы исследований;
- таблицы и графики снятых зависимостей.
Лабораторная работа № 6
Исследование интегральных схем
транзисторно-транзисторной логики
Цель работы: изучить электрические параметры интегральных схем
транзисторно – транзисторной логики.
1.
Подготовка к лабораторной работе.
Основное внимание следует уделить физическому смыслу и
методам измерений основных электрических параметров логических микросхем, а
также схемотехническим особенностям ТТЛ-схем. Статические параметры могут быть
определены с помощью графиков передаточной Uвых=f(Uвх)
(рис. 6.1.) и входной Iвх=f(Uвх)
(рис. 6.2) характеристик.
Сначала по графику передаточной характеристики (рис.6.1)
определяют уровень логического нуля U0
и уровень логической единицы U1
(точки А и В определяются пересечением характеристики с ее зеркальным
отражением), а затем с помощью графика (рис.6.2) входные токи I0вх и I1вх.
С помощью графика (рис.6.1.) определяют статическую
помехоустойчивость ИМС. Un=min{U+n,U–n
}, (напомним, что в точках С и D
касательная проходит под углом 45°).

Рис. 6.1. Рис. 6.2.
Экономичность микросхемы характеризует средняя
потребляемая мощность (в состояниях ноль и единица)
 .
.
Интегральное качество микросхемы определяет
синтетический параметр работа переключения
![]() .
.
В лабораторной работе используется микросхема К155ЛАЗ
или К555ЛАЗ, в состав которой входят 4 схемы 2И-НЕ. Принципиальные схемы,
расположение выводов и основные электрические параметры используемых микросхем
приведены в приложении.
В процессе подготовки к работе приведенные в
приложении схемы и параметры ИМС должны быть внесены в протокол измерений.
2.
Задание на выполнение лабораторной работы.
2.1.
Снять передаточную и входную характеристики микросхемы.
2.1.1.
Собрать схему рис.6.3, используя любую из четырех схем 2И-НЕ микросхемы К155ЛА3
(в качестве примера приведены номера выводов одной из схем).
На один из входов ИМС подать входное напряжение, а
второй (не используемый) подключить к “плюсу" источника питания. Изменяя
входное напряжение Е1 в интервале 0...5 В снять входную Iвх=f(Uвх) и передаточную Uвых=f(Uвх)
характеристики. Результаты измерений внесите в таблицу
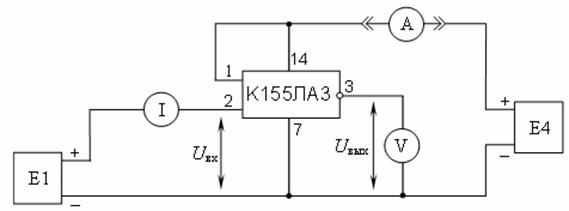
Рис. 6.3
2.1.2.
Измерьте ток, потребляемый от источника питания I0потр при Uвх=U0 ≈ 0,4 В и I1потр при Uвх=U1» 2,4 В. (Для уровней U0 и U1 использованы паспортные данные).
2.2.
Измерить нагрузочную способность микросхемы.
Использовать схему исследования из предыдущего пункта.
Подать на вход ИМС паспортное значение напряжения логического нуля Uвх=0,4 В. Подключая к выходу
ИМС сопротивления нагрузки Rн=10кОм,
1кОм, 470Ом, 100Ом, снимите нагрузочную выходную характеристику Uвых=f(Rн).
3.
Обработка результатов эксперимента.
3.1.
По результатам измерений в п.2.1 построить графики зависимостей Uвых=f(Uвх) и Iвх=f(Uвх) и
определить параметры: U0, U1,
I0вх, I1вх, Uп+,
Uп-, Uп. Рассчитать среднюю потребляемую
мощность Рср.
3.2.
По результатам измерений в п.2.2 построить зависимость выходного напряжения Uвых от сопротивления
нагрузки U1вых=f(Rн).
На графике отметить Rн.min
соответствующее уменьшению выходного напряжения до паспортной величины U1вых=2,4 В.
5. Содержание отчета.
6.
Отчет должен содержать:
- паспортные данные микросхемы К155ЛА3, приведенные в
приложении;
- таблицы с результатами измерений и графики полученных
зависимостей;
- полученные значения параметров ИМС.
Лабораторная работа № 7
Исследование интегральных оптронов
Цель работы: изучить особенности работы и методики измерения
параметров оптронов
1.
Подготовка к лабораторной работе.
Оптроны являются основными структурными элементами
оптоэлектроники - одного из современных направлений функциональной
микроэлектроники.
Простейший диодный оптрон состоит из трех элементов
(рис. 7.1): - 1 - фотоизлучателя, 2 - световода и 3 - фотоприемника, заключенных
в светонепроницаемый герметичный корпус. При подаче на вход электрического
сигнала возбуждается фотоизлучатель. Световой поток по световоду попадает в
фотоприемник, в котором вырабатывается выходной электрический сигнал.
Существенной особенностью оптрона является то, что его элементы связаны
оптически, а электрически вход и выход изолированы друг от друга. Благодаря
этому легко обеспечивается согласование высоковольтных и низковольтных, а также
высокочастотных и низкочастотных цепей. Условное обозначение диодного оптрона
приведено на рис.7.2, а его конструкция - на рис.7.3. 1,2 – р- и n-
области фотодиода; 3,4 - n- и р- области светодиода; 5 - световод на
основе селенового стекла; 6,7 - контакты светодиода; 8,9 - контакты фотодиода.
В качестве фотоизлучателей оптронов получили
распространение инжекционные светодиоды, в которых испускание света
определяется механизмом рекомбинации электронов и дырок.

Рис. 7.1.
Рис. 7.2.

Рис. 7.3.
Известно, что физическое явление, лежащее в основе принципа
действия светодиода, называется электролюминесценцией. Его сущность
заключается в том, что в некоторых полупроводниковых материалах процесс
рекомбинации электронов и дырок сопровождается излучением кванта света.
Напомним, что в кремнии и германии энергия рекомбинирущих частиц рассеивается
на колебаниях решетки (акустических фононах).
Для преобразования световых сигналов в электрические в
основном используются фотодиоды (а также фоторезисторы, фототранзисторы и
фототиристоры).
Фотодиод представляет собой обычный n-р- переход, чаще всего на основе
кремния или германия, обратный ток которого определяется скоростью генерации
носителей заряда порождаемых действием падающего света. Данное явление
называется внутренним фотоэффектом.
Обратите внимание, что существуют два режима
использования фотодиода: без внешнего питания - вентильный или
фотовольтаический режим и с внешним питанием -
фотодиодный режим. Фотодиоды, предназначенные для преобразования
световой энергии в электрическую без внешнего питания, называют вентильными
фотоэлементами. Возникновение фото-ЭДС Uф
связано с разделением генерированных светом электронно-дырочных пар полем n-р- перехода. При этом происходит
накопление дырок в р-области и
электронов в n-области, за счет чего,
на n-р- переходе создается добавочная
разность потенциалов. Величина фото-ЭДС Uф зависит от уровня
оптического сигнала Рф и
величины сопротивления нагрузки. Типичные выходные характеристики вентильного
фотоэлемента приведены на рис.7.4.
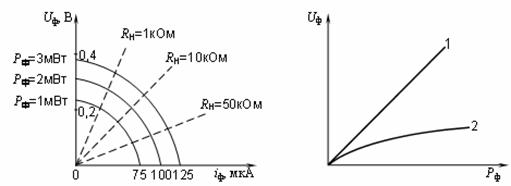
Рис. 7.4.
Рис. 7.5.
Необходимо иметь в виду, что в фотодиодном режиме за
счет источника внешнего напряжение фототок iф
примерно равен току короткого замыкания вентильного элемента, а падение
напряжения от фототока на нагрузке Uф
при любом сопротивлении нагрузки больше по величине. Зависимости напряжения
сигнала Uф от мощности
оптического излучения Рф
для фотодиода (1) и вентильного элемента (2) при одинаковом сопротивлении
нагрузки приведены на рис.7.5. Эффективность фотоэлектрического преобразования
принято характеризовать вольт-ваттной SU=Uф/Рф и ампер-ваттной Si=Iф/Рф
чувствительностью. Следует отметить, что дополнительным преимуществом
фотодиодов является высокая линейность световых характеристик Iф, Uф=f(Рф),
позволяющая применять их в оптических линиях связи. Вентильные элементы в
основном используются в качестве преобразователей энергии (солнечные батареи).
Обратите внимание, что управление током с помощью
света может быть получено и в биполярном транзисторе, причем с существенно
большей чувствительностью, чем в фотодиодах, за счет усиления тока базы.
Следует отметить, что оптическая генерация носителей в базе фототранзистора
эквивалентна введению в базу носителей заряда от внешнего источника. В
результате фототок транзистора усиливается в b раз по сравнений с фотодиодом,
где b - статический
коэффициент усиления тока базы фототранзистора.

Рис. 7.6.
Инерционность оптрона связана с процессами в
светодиоде и приемнике излучения и описывается с помощью времен нарастания tнp и спада tсп выходного сигнала рис.9.6.
(При подаче на вход прямоугольного импульса).
Можно выделить следующие основные параметры диодных
оптронов:
- максимальный входной ток Iвх mах;
- максимальное входное напряжение Uвх mах;
- максимальное выходное обратное напряжение Uвых обр. mах:
- входное напряжение Uвх - постоянное входное напряжение, соответствующее
заданному входному току;
- выходной обратный темновой ток Iвых обр. т:
- времена нарастания tнp и спада tсп
выходного сигнала - интервалы времени, в течение которых выходной сигнал диодного
оптрона изменяется в интервалах
0.1-0.9 и 0.9-0.1 от своего максимального значения (рис.9.6);
- коэффициент передачи по току КI - отношение приращения выходного тока к входному КI = (Iвых-Iвых обр т)/Iвх.
Предельные параметры и расположение выводов диодных
оптронов, используемых в работе, приведены в приложении.
2.
Задание на выполнение лабораторной работы.
Зарисовать принципиальную схему исследуемого оптрона и
выписать предельные параметры.
2.1.
Исследовать характеристики диодного оптрона.
2.1.1.
Собрать схемы исследования рис.7.7. Установить ограничители тока в источниках
питания в соответствии с предельными параметрами оптрона.
2.1.2.
Изменяя Е1, снять входную характеристику оптрона: Iвх=f(Uвх).
Принять
Iвх= E1/R1, так
как входное сопротивление светодиода много меньше R1.

Рис. 7.7.
Результаты измерений занести в табл. 7.1.
Таблица 7.1
|
Е1,
В |
|
|
Uвх, В |
|
|
Iвх=E1/R1, мА |
|
2.1.3.
Установить Е2=0. Изменяя Е1, снять передаточную
характеристику оптрона при использовании фотовольтаического режима Iвых=f(Iвх).
Результаты
измерений занести в табл.7.2.
Таблица 7.2
|
Е1,
В |
|
|
Iвых, В |
|
|
Iвх=E1/R1, мА |
|
2.1.4.
Установить Е2=5 В. Повторить измерения по п.2.1.3 для оптрона при
использовании фотодиодного режима. Результаты измерений занести в табл.7.3,
аналогичную 7.2.
2.1.5.
Измерить времена нарастания tнр
и спада tcn выходного
тока оптрона.
Собрать схему исследования, изображенную на рис.7.8,
включив в цепь светодиода генератор импульсов. Установить на выходе генератора
амплитуду импульсов 5В с частотой следования примерно 1кГц. К измерительному
резистору R2 через делитель напряжения 1:10 подключить осциллограф. (Другой
канал осциллографа используйте для измерения амплитуды импульсов на выходе
генератора). Установить Е2=5В и по осциллограмме выходного тока
(пропорционального падению напряжения на R2) измерить времена нарастания tнр и спада tcп.
Установить Е2=0 и повторить измерение
времен для фотовольтаического режима.

Рис. 7.8.
2.2.
Исследовать характеристики транзисторного оптрона. Собрать схему рис.7.9,
установить Е2=5 В.
(В
этой схеме фотодиод оптрона и внешний транзистор имитируют фототранзистор).
Изменяя Е1, снять передаточную
характеристику транзисторного оптрона Iвых=f(Iвх);
принять Iвх=Е1/Р1
и Iвых=Iк.
Результаты измерений занести в табл. 7.4, аналогичную 7.2 и 7.3.
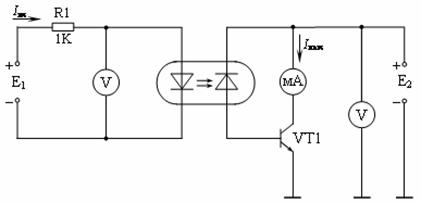
Рис. 7.9.
3.
Обработка результатов эксперимента.
3.1.
Построить входную характеристику оптрона и определить величину входного
напряжения Uвx,
соответствующего Iвх=10
мА.
3.2.
Построить передаточные характеристики оптрона в диодном и фотовольтаическом
режимах и определить коэффициенты передачи тока KI при Iвх=10
мА.
3.3.
Рассчитать среднее время задержки распространения сигнала в диодном оптроне
 .
.
3.4.
Построить передаточную характеристику транзисторного оптрона и рассчитать
коэффициент передачи тока КI при Iвх=10мА.
4.
Содержание отчета
Отчет должен содержать:
- предельные параметры и принципиальную схему
исследуемого оптрона;
- схемы измерений;
- таблицы и графики снятых зависимостей;
- рассчитанные значения параметров;
- осциллограммы токов и напряжений.
ПРИЛОЖЕНИЕ
Справочные данные исследуемых в лаборатории
электронных приборов и интегральных микросхем
П1. Выпрямительные, импульсные и
высокочастотные диоды
|
Тип
диода |
Структура |
Iпр доп,
мА |
Uобр доп,
В |
fmax, кГц |
t восст, мкс |
|
D2 Е |
Ge, точечный |
16 |
50 |
|
3 |
|
D2 Ж |
Ge, точечный |
8 |
150 |
|
3 |
|
D7 Г |
Ge, сплавной |
300 |
200 |
2,4 |
|
|
D7 Ж |
Ge, сплавной |
300 |
400 |
2,4 |
|
|
D9 Е |
Ge, точечный |
20 |
30 |
|
3 |
|
D104 |
Si, микросплавной |
30 |
100 |
150 |
0,5 |
|
D226 |
Si, сплавной |
300 |
200 |
1,0 |
|
|
KD503 A |
Si, эпитаксиально-планарный |
20 |
30 |
|
0,01 |
|
D312 |
Ge, диффузионный |
50 |
75 |
|
0,7 |
П2. Стабилитроны и стабисторы
|
Тип диода |
Структура |
Uст,
В |
Icм min, мА |
Icм max, мА |
rD,
Ом |
|
D814 Б |
Si, сплавной |
8...9,5 |
3 |
36 |
10 |
|
D814 D |
Si, сплавной |
11,5...14,0 |
3 |
24 |
18 |
|
КС156
Т |
Si, диффузионно-сплавной |
5,6 |
1 |
22,4 |
100 |
|
D219 C |
Si, микросплавной стабистор |
0,57 |
1 |
50 |
|
|
KC113 A |
Si, диффузионно-сплавной
стабистор |
1,17...1,8 |
1 |
100 |
80 |
П3. Биполярные транзисторы
|
Тип тран-ра |
Структура |
h21Э |
fh21Э(fT), МГц |
Iк доп,
мА |
Uкэ доп,
В |
Рк доп, мВт |
tк, мкс |
Ск (1В), пФ |
|
МП37Б |
n-р-n, Ge, сплавной |
20-50 |
1,0 |
20 |
15 |
150 |
|
40 |
|
МП39Б |
р-n-р, Ge, сплавной |
20-50 |
0,5 1,5 |
20 |
20 |
150 |
|
40 |
|
КТ315Б |
n-р-n, Si,
эпитаксиально-планарный |
50-350 |
(250) |
100 |
20 |
150 |
0,5 |
7 |
|
КТ361Б |
р-n-р, Si, эпитаксиально-планарный |
50-350 |
(250) |
50 |
20 |
150 |
0,5 |
9 |
(ТР 2) МП
37 (ТР 27) КТ 315
МП 39 КТ 361

П4.
Полевые транзисторы
|
Тип транзистора |
Структура |
Ic доп (Ic нач) |
Uси доп, В |
Рс доп, мВт |
Сзи, пФ |
Сзс, пФ |
Сси, пФ |
rк, Ом |
Uотс, В |
|
КП103И |
n-р-переходный р-канальный |
(0,8-1,8) |
12 |
21 |
20 |
8 |
- |
30 |
0,8-3 |
|
КП103Е |
------------------------- |
(0,4-1,5) |
10 |
7 |
20 |
8 |
- |
50 |
0,4-1,5 |
|
КП103М |
------------------------- |
(5-7,5) |
10 |
120 |
20 |
8 |
- |
60 |
3-5 |
|
КП301Б |
р-МОП,
индуцированный канал |
15 |
20 |
200 |
3,5 |
1 |
3,5 |
100 |
-4 |
|
КП305Д |
n-МОП, встроенный канал |
15 |
15 |
150 |
5 |
0,8 |
5 |
80 |
-6 |
(ТР 67) КП 103 (ТР 69)
КП 305 (ТР 71)
КП 301

П5. Интегральные микросхемы
Все
используемые в лаборатории микросхемы имеют прямоу-гольные пластмассовые или керамические
корпуса типов 201.14.1-201.14.9 с расположением 14 выводов в 2 ряда (метка
может быть выполнена в виде точки около первого вывода).

К140УД20.
Сдвоенный операционный усилитель.

К553УД2;
КР1408УД1 Операционные усилители

Основные параметры ОУ, исследуемых в
лаборатории
|
Тип ОУ |
Kyv 103 |
Uсм, мВ |
Iвх, мкА |
Iвх, мкА |
f1, МГц |
Uv.вых, в/мкс |
Кос
сф дБ |
Uвх, В |
Uвх сф,
В |
Uп, В |
|
К553УД2 |
20 |
7,5 |
1,5 |
0,5 |
1 |
0,5 |
70 |
10 |
10 |
+(6-15) |
|
К140УД20 |
50 |
5 |
0,2 |
0,05 |
0,55 |
0,3 |
70 |
12 |
11 |
+(6-15) |
К176ЛП1
Универсальный логический элемент КМОП-структуры (при соответствующей
коммутации может быть использован в качестве трех элементов НЕ, элемента НЕ с
большим коэффициентом разветвления, элемента 3И-НЕ, элемента 3ИЛИ-НЕ и
триггерной ячейки).
Основные электрические параметры:
- напряжение питания Uп=9В+5%,
- уровни логических сигналов U0вых £ 0,3В; U1вых ³ 8,2В; потребляемый ток, мА, не более 0,3;
- среднее время задержки распространения £ 200 нс.
Работоспособность сохраняется при уменьшении
напряжения питания до 5В. Допустимый диапазон входных сигналов (0 - Uп).

К176ЛА7,
К176ЛА8.
4 элемента 2И-НЕ КМОП-структуры:

Принципиальная схема каждого из
элементов 2И-НЕ.
Предельные
и основные электрические параметры как для К175ЛП1.
ИСПОЛЬЗОВАННАЯ ЛИТЕРАТУРА
1. А.Г. Морозов. Электротехника, электроника и
импульсная техника. – М.: Высшая школа, 1987.
2. А.Г, Алексенко, И.И. Шагурин. Микросхемотехника. –
М.: Радио и связь, 1990.
3. Д.В. Игумнов, Г.В. Королев, И.С. Громов. Основы
микроэлектроники. – М.: Высшая школа, 1991.
4. Ю.Ф. Опадчий, О.П. Глудкин, А.И. Гуров. Аналоговая
и цифровая электроника. – М.: Горячая линия – Телеком, 2003.
5. Степаненко И.П. Основы микроэлектроники: Учебное
пособие для вузов. – 2-е изд., перераб. и доп.- М.: Лаборатория Базовых Знаний,
2001.
6. Ю.Л. Бобровский, С.А. Корнилов, И.А. Кратиров и
др.; Под ред. проф. Н.Ф. Федорова. Электронные, квантовые приборы и
микроэлектроника: Учебное пособие для вузов.- М.: Радио и связь, 2002.
ОГЛАВЛЕНИЕ
|
Введение…............................................................................................... |
3 |
|
|
|
|
ГЛАВА I. Полупроводниковые приборы |
|
|
1.1. Энергетические зоны………………………………..................... |
5 |
|
1.2. Собственная электропроводность…………….. ......................... |
6 |
|
1.3. Примесная
электропроводность.................................................. |
8 |
|
|
|
|
ГЛАВА II. Электронно – дырочный переход |
|
|
2.1. Образование р-n- перехода........................................................... |
14 |
|
2.2. Прямое включение р-n- перехода ……………………….……… |
16 |
|
2.3.
Обратное включение р-n-
перехода………………………......... |
17 |
|
2.4.
Вольт – амперная характеристика (ВАХ) р–n- перехода
…….. |
18 |
|
2.5.
Разновидности пробоя р–n перехода…………………………. |
21 |
|
|
|
|
ГЛАВА III. Полупроводниковые диоды. |
|
|
3.1. Выпрямительные диоды…………..……..................................... |
22 |
|
3.2. Стабилитроны………………………............................................. |
23 |
|
3.3. Варикапы.
….……………………………………………………. |
24 |
|
3.4. Туннельный диод………………………………………………… |
24 |
|
3.5. Генераторные диоды……..……………....................................... |
25 |
|
3.6. Диоды оптоэлектроники…........……............................................. |
26 |
|
3.7.
Оптроны………………………………………………………….. |
28 |
|
|
|
|
ГЛАВА IV. Биполярные транзисторы. |
|
|
4.1.Общие сведения………………………………............................... |
29 |
|
4.2. Схемы включения БТ……….………............................................. |
30 |
|
4.3.
Статические характеристики БТ…….………………………….. |
33 |
|
4.4.
Физические параметры БТ ……………………………………… |
35 |
|
|
|
|
ГЛАВА V. Полевые транзисторы |
|
|
5.1.
Общие сведения………………….……………………………… |
38 |
|
5.2.
Статические характеристики ПТ………………………………. |
40 |
|
5.3.
Основные характеристики ПТ…………………………………. |
41 |
|
5.4.
МДП – транзистор с индуцированным каналом….…………… |
42 |
|
5.5.
МДП- транзистор с встроенным каналом……………………… |
44 |
|
|
|
|
ГЛАВА VI. Широкополосные усилители |
|
|
6.1.
Усилительный каскад на БТ……………………………………. |
47 |
|
6.2.
Усилительный каскад на ПТ……………………………………. |
52 |
|
6.3.
Многокаскадные усилители……………………………………. |
53 |
|
6.4.
Выходные каскады (усилители мощности) аналоговых интегральных микросхем……………………………………………. |
54 |
|
6.5.
Эмиттерный повторитель……………………………………….. |
56 |
|
|
|
|
ГЛАВА VII. Интегральные микросхемы |
|
|
7.1.Общие сведения об ИМС………………………………................ |
59 |
|
7.2.Пленочные и гибридные ИМС………………………………….. |
60 |
|
7.3. Полупроводниковые ИМС ……………………………………… |
61 |
|
|
|
|
ГЛАВА VIII. Схемотехника усилительных устройств |
|
|
8.1.
Основные параметры и характеристики усилителей………….. |
65 |
|
8.2.
Комплементарный эмиттерный повторитель…………………. |
68 |
|
8.3.
Усилители на основе балансных схем………………………… |
69 |
|
8.4.
Генератор стабильного тока…………………………….………. |
70 |
|
8.5.
Схема сдвига уровня постоянного напряжения………………. |
71 |
|
8.6.
Дифференциальные усилители…………………………………. |
72 |
|
8.7.
Операционные усилители……………………………………….. |
76 |
|
|
|
|
ГЛАВА IХ. Схемотехника полупроводниковых статических цифровых
ИМС |
|
|
9.1.
Основы цифровой техники…………………………………….. |
83 |
|
9.2.
Параметры логических ИМС…………………………………… |
85 |
|
9.3.
Ключи на БТ……………………………………………………… |
86 |
|
9.4.
Ключи на ПТ…………………………………………………….. |
89 |
|
9.5. Базовые элементы логических интегральных схем………….. |
91 |
|
|
|
|
ГЛАВА Х. Лабораторные
работы |
|
|
Лабораторная работа № 1. Исследование характеристик
и параметров полупроводниковых диодов……………………………. |
99 |
|
Лабораторная работа № 2.
Исследование статических характеристик и параметров биполярных
транзисторов…………... |
102 |
|
Лабораторная работа № 3. Исследование полевого транзистора с управляющим переходом……………………………………………. |
106 |
|
Лабораторная работа № 4. Исследование параметров операционных усилителей…………………………………………… |
111 |
|
Лабораторная работа № 5. Исследование ключевых схем на полевых транзисторах………………………………………………. |
115 |
|
Лабораторная работа № 6. Исследование интегральных схем транзисторно – транзисторной логики…………………………….. |
118 |
|
Лабораторная работа № 7. Исследование интегральных оптронов |
120 |
|
Приложение…………………………………………………………… |
127 |
|
Использованная
литература ……… .................................................... |
132 |
Учебное издание
план 2008-2009 уч. г.
Арипов
Хайрулла Кабилович,
Абдуллаев
Ахмед Маллаевич,
Алимова
Нодира Батырджановна
ЭЛЕКТРОНИКА
Учебное пособие для бакалавров
по направлениям
5522200 «Телекоммуникации»
5522100 «Телевидение, радиосвязь и
радиовещание»
5522200 «Радиотехника»
|
|
Подписано в печать 12.09.2008 г. Бумага офсетная. Заказ № 124 Печать. Тираж 100 экз. |
Утверждено к печати
Ташкентским университетом информационных технологий
(протокол заседания Учебно-методического совета ТИТ № 9
от
22 мая
Ответственный редактор: Х.К. Арипов
Корректор: Е.В. Объедков